Journal of Advances in Physical Chemistry
Vol.
07
No.
04
(
2018
), Article ID:
27748
,
6
pages
10.12677/JAPC.2018.74022
Discussion on Storage Method of Silicon Wafer after Chemical Mechanical Polishing
Xunda Shi, Yunxia Liu, Lin Lin, Shaokun Yang, Liyan Cai, Erjing Zhao, Zhuo Liu
GRINM Semiconductor Materials Co., Ltd., Beijing

Received: Nov. 2nd, 2018; accepted: Nov. 20th, 2018; published: Nov. 27th, 2018

ABSTRACT
The chemical mechanical polishing silicon wafers will be soaked in deionized water for a period of time before the final cleaning. However, the soaking duration and the soaking condition could affect the final cleaning effect. In this article, the change of surface particles of silicon wafers which after the final cleaning in different soaking conditions is researched.
Keywords:Surfactant, Metal Contamination, Particles, Chemical Mechanical Polishing
硅片化学机械抛光后存放方法探讨
史训达,刘云霞,林霖,杨少坤,蔡丽艳,赵而敬,刘卓
有研半导体材料有限公司,北京

收稿日期:2018年11月2日;录用日期:2018年11月20日;发布日期:2018年11月27日

摘 要
化学机械抛光后的硅片,都会在去离子水中浸泡一段时间才会做后面的最终清洗。但浸泡时间和浸泡条件会影响到最终的清洗效果。本文研究了不同浸泡条件下,硅片经过最终清洗后表面颗粒的变化。
关键词 :表面活性剂,金属沾污,颗粒,CMP

Copyright © 2018 by authors and Hans Publishers Inc.
This work is licensed under the Creative Commons Attribution International License (CC BY).
http://creativecommons.org/licenses/by/4.0/


1. 概述
随着信息技术的深入发展和广泛应用,微电子工业快速发展,对电路集成程度的要求也越来越高,这对硅片的表面质量的要求也越来越高。为了获得高平整度硅片,化学机械抛光(简称CMP)是半导体硅片表面加工的关键技术之一 [1] ,CMP (Chemical Mechanical Polishing)后硅片表面清洗不干净引起的电子元器件失效已经达到制造过程中损失量的50%以上 [2] 。化学机械抛光后的硅片表面呈现一个断面,由于原子键被打开,失去表面上方的原子而存在高密度的不饱和键,具有悬挂的原子处于不饱和的状态,因此硅片表面的化学活性很高,能量较大、力场很强,在力场的作用下与周围发生相互作用,周围环境中的物质会被迅速吸附到基体表面上来。根据固体表面和外面粒子力的作用性质,吸附可分为物理吸附和化学吸附。物理吸附是被吸附的流体分子与固体表面分子间的作用力为分子间吸引力,即所谓的范德华力(Vanderwaals)。因此,物理吸附又称范德华吸附,它是一种可逆过程。化学吸附是固体表面与被吸附物间的化学键力起作用的结果。这类型的吸附需要一定的活化能,故又称“活化吸附”。这种化学键亲和力的大小可以差别很大,但它大大超过物理吸附的范德华力。吸附物与硅片表面的吸附形成随着时间的推移会发生化学变化物理吸附有可能变为化学吸附。化学吸附比较难清洗,因此化学机械抛光后的硅片清洗质量和清洗及时性有一定的关系 [3] 。
2. 试验
2.1. 样品
所有样品要求来自同一根单晶,要求抛光工艺完全一致,并且同时抛光。
直径:150 mm。
电阻率:0.01~0.02 Ω∙cm。
晶向:<100>0 ± 0.5。
2.2. 清洗设备
SPMC-5.6寸全自动硅片清洗设备。
2.3. 工艺流程
上料区–SC1 (一号液氨水和双氧水的混合液)–QDR (水冲)–SC1 (一号液氨水和双氧水的混合液带兆声震动)–QDR (水冲)–SC1 (一号液氨水和双氧水的混合液带兆声震动)–QDR (水冲)–SC2 (二号液盐酸和双氧水的混合液)–QDR (水冲)–DRY (干燥)。
2.4. 实验方案
同时抛光后的硅片300片,分为两组每组150片,分别存放在不加活性剂水槽中和加千分之0.5的活性剂水槽中,分别在2.8.12.18.24.36H各取一盒同时清洗。
对比清洗后的>0.16 um和>0.2 um的颗粒水平和表面金属水平。
3. 结果
3.1. 表面颗粒水平
图1和图2是水槽中加活性剂不同的浸泡时间 > 0.16 um和>0.2 um颗粒个数的对比图,水车中加活性剂随着浸泡时间的增加,颗粒没有明显的变差趋势。注:以下图中纵坐标名称是粒径 > 0.16 um或粒径 > 0.2 um的颗粒数,单位是个。

Figure 1. The trend of the >0.16 um particle numbers with the soaking time in the sink plus active agent
图1. 水槽加活性剂 > 0.16 um颗粒个数随浸泡时间的变化趋势
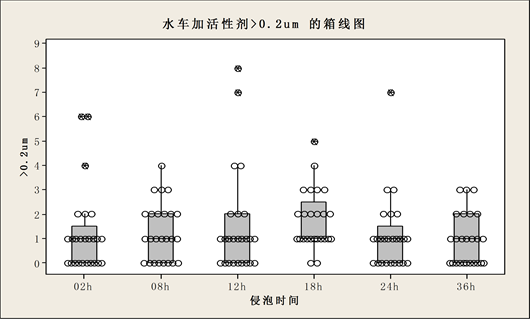
Figure 2. The trend of the >0.2 um particle numbers with the soaking time in the sink plus active agent
图2. 水槽加活性剂 > 0.2 um颗粒个数随浸泡时间的变化趋势
图3和图4是水槽中加活性剂不同的浸泡时间 > 0.16 um和>0.2 um颗粒个数的对比图,水车中不加活性剂随着浸泡时间的增加,当浸泡时间超过12小时后,颗粒数开始增加,超过18小时后颗粒数明显增加。

Figure 3. The trend of the >0.16 um particle numbers with the soaking time in the sink without active agent
图3. 水槽不加活性剂 > 0.16 um颗粒个数随浸泡时间的变化趋势

Figure 4. The trend of the >0.2 um particle numbers with the soaking time in the sink without active agent
图4. 水槽不加活性剂 > 0.2 um颗粒个数随浸泡时间的变化趋势
水槽中不加活性剂24小时后颗粒数已经非常多了,不再做对比,图5和图6对比浸泡2 h、8 h、12 h和18 h水槽加活性剂和不加活性剂的 > 0.16 um和>0.2um颗粒水平,浸泡2小时和8小时 > 0.16 um和>0.2 um颗粒水平颗粒水平相当,但是浸泡12个小时后水槽加活性剂的颗粒水平明显比不加活性剂的好。
3.2. 表面金属水平
表1是各组实验的表面金属水平,随着侵泡时间的增加表面金属水平都有所增加,侵泡8个小时以内无论水车加或者不加活性剂,表面金属含量增加的都不明显,但浸泡12个小时以上不加活性的水车浸泡的硅片的表面金属水平增加较多,而加活性剂的水车浸泡硅片的表面金属水平明显比不加活性剂的的水车浸泡硅片的表面金属水平好。
注:表面金属单位是:1E9atoms/cm2

Figure 5. Comparison of the >0.16 um particle number of active agents and no active agent in the sink
图5. 水槽加活性剂和不加活性剂 > 0.16 um颗粒个数水平对比

Figure 6. Comparison of the >0.2 um particle number of active agents and no active agent in the sink
图6. 水槽加活性剂和不加活性剂 > 0.2 um颗粒个数水平对比
Table 1. Surface metal level of each group of experiments
表1. 各组实验的表面金属水平
4. 总结
颗粒在硅片表面首先是以色散力和范德华力形成的物理吸附,然后逐渐形成紧密的化学吸附 [4] ,颗粒和硅片表面形成化学吸附时,颗粒就比较难去除。当颗粒以物理吸附的形式吸附于硅片表面时,随着分子的热运动会在硅片表面做微小的移动,硅片表面的断裂键会与颗粒不断的吸附和拉开,此时如果水车中有活性剂,活性剂分子会借助于润湿作用迅速在硅片和颗粒表面铺展开,形成一层致密的保护层 [5] ,阻止颗粒和硅片表面形成化学吸附。因此抛光后的硅片浸泡在有活性剂的水溶液中,存放较长时间,洗后硅片表面颗粒能有较好的水平。
这种表面活性剂有机结构中的主要成分是螯合环,两端的N-O共用的电子对和金属离子作用,能去除金属离子。因此抛光后的硅片浸泡在有活性剂的水溶液中,洗后硅片表面金属水平较好。
文章引用
史训达,刘云霞,林 霖,杨少坤,蔡丽艳,赵而敬,刘 卓. 硅片化学机械抛光后存放方法探讨
Discussion on Storage Method of Silicon Wafer after Chemical Mechanical Polishing[J]. 物理化学进展, 2018, 07(04): 184-189. https://doi.org/10.12677/JAPC.2018.74022
参考文献
- 1. Malik, F. and Hesan, M. (1995) Manufacturablilty of CMP Process. Thin Solid Films, 270, 612-615. https://doi.org/10.1016/0040-6090(96)80083-6
- 2. 刘玉林, 汪心想, 孟新志. 半导体硅片CMP后清洗技术的研究进展[J]. 清洗世界, 2018(5): 32-36.
- 3. 刘玉岭, 桑建新, 叶占江, 等. 表面活性剂对硅片表面吸附颗粒的作用[J]. 半导体技术, 2001, 26(7): 59-61.
- 4. 程铸生. 精细化学品化学[M]. 修订版. 上海: 华东理工大学出版社, 1996.
- 5. 刘玉岭, 檀柏梅, 赵之雯. 表面活性剂在半导体硅材料加工技术中的应用[J]. 河北工业大学学报, 200, 33(2): 72-75.
