Smart Grid
Vol.06 No.02(2016), Article ID:17373,13
pages
10.12677/SG.2016.62013
Research Progress of Ohmic Contacts for p-Type SiC
Ziwei Pei, Jing Zhang
Department of Microelectronics, North China University of Technology, Beijing

Received: Apr. 2nd, 2016; accepted: Apr. 17th, 2016; published: Apr. 20th, 2016
Copyright © 2016 by authors and Hans Publishers Inc.
This work is licensed under the Creative Commons Attribution International License (CC BY).
http://creativecommons.org/licenses/by/4.0/



ABSTRACT
Ohmic contact is one of the technical difficulties in the study of the new generation power electronic devices of SiC. In addition to the metal selection, compared to n-type doping, the ionization energy of p-type SiC is much higher. The superior quality of p-type SiC ohmic contact is more difficult to form. In this paper, it is summarized that ohmic contacts for Al-base traditional materials and non Al-base traditional metal materials made on p-type SiC, and discussed for its development prospects.
Keywords:p-Type SiC, Power Electronic Devices, Ohmic Contact

p型SiC欧姆接触的研究进展
裴紫微,张静
北方工业大学微电子学系,北京

收稿日期:2016年4月2日;录用日期:2016年4月17日;发布日期:2016年4月20日

摘 要
欧姆接触是碳化硅(Silicon Carbide, SiC)新一代电力电子器件研究中的技术难点之一。除了金属选择外,相对于n型掺杂,SiC材料中p型杂质的离化能比n型杂质的离化能高,优质的p型SiC欧姆接触更难于形成。该文对近十几年来极具代表性的传统Al基金属体系和非传统Al基金属体系在p型SiC材料上形成欧姆接触的研究进行了总结,并对其发展前景进行了展望。
关键词 :p型SiC,电力电子器件,欧姆接触

1. 引言
SiC电力电子器件主要包括功率整流器(SBD、PiN和JBS等)、单极型功率晶体管(MOSFET、JFET和SIT等)和双极型载流子功率晶体管(BJT、IGBT和GTO等)。其中极具代表的SiC PiN、SiC MOSFET和SiC BJT等器件,均需要形成良好的p型欧姆接触。经过大量的研究工作,SiC欧姆接触问题目前主要集中在两个技术点上:一是大剂量的离子注入,这能显著地增加SiC的载流子密度,并减少它的耗尽层宽度,形成隧穿;这种方法的关键问题是:在离子注入过程中容易形成晶格缺陷或非晶状态,这些缺陷是非常顽固的,需经过大约2000K的极高温退火来复原,从而使制造SiC器件复杂化 [1] ;二是通过淀积金属和退火技术,产生一种具有较窄带隙或高载流子密度的中间层。为形成这种层,大范围的材料可供选择,包括金属化物、硅化物、碳化物、氮化物和石墨等等 [2] 。实际欧姆工艺制备是在综合以上两个技术点的情况下完成的。
2. p型SiC欧姆接触研究进展
和相对成熟的n型SiC欧姆接触(Ni基金属制备的n型SiC欧姆接触已经被普遍应用和比接触电阻值低于10−5 Ω cm2量级 [3] [4] )相比,获得高质量的p型SiC欧姆接触依旧是个挑战。为了实现SiC材料半导体器件的全部优势,p型SiC材料的比接触电阻值应当和n型SiC材料所获得的比接触电阻值相匹配。最成功和最广泛的p型SiC接触是被Suzuki等人 [5] 在1991年提出来的,使用的金属为Al和Ti,这之后又被Crofton等人 [6] 研究,在掺杂浓度为2 × 1019 cm−3的情况下,报到出的最低比接触电阻值为1.5 × 10−5 Ω cm2。可因为Al的低熔点和易被氧化性,Al基欧姆接触应用在商业高温和大功率器件下是不可靠的 [7] ,因此后来,大量的研究人员对传统Al基金属体系作了改进,在传统TiAl两层金属体系的基础上加入了其它金属(TiAl基金属体系),或者直接采用非TiAl基金属体系,以期获得质量更优的p型SiC欧姆接触。
2.1. 传统Al基金属体系
1998年,为了全面了解传统Al基金属体系在p型4H-SiC上的欧姆接触,美国华盛顿海军研究室实施了一项相关实验 [8] 。实验采用厚度分别为25 nm和150 nm的传统Al/Ti金属体系,淀积后分组分别实施了700℃,800℃,900℃,1000℃的退火,最后测试其电压随电流的变化,用I-V特征曲线分别表示(图1所示)。700℃退火后依旧为肖特基特性,800℃退火后开始表现出欧姆特性,900℃和1000℃退火后结果区别不大,但均好于800℃退火后的欧姆行为。并且在900℃退火后所得的最小比接触电阻值为6.4 × 10−4 Ω cm2。2002年,匈牙利的B.Pecz和法国的J.Vacas等人 [9] 使用了Al (150 nm)/Ti (30 nm)金属体系结合高掺杂(1.6 × 1019 cm−2)的p型6H-SiC外延片,在氮气氛围中经900℃,4 min的退火后,形成了欧姆接触。通过I-V特征曲线来表征退火后接触的电学特性(图2所示),使用TLM模型计算得到的最小比接触电阻值为4 × 10−4 Ωcm2。此量级的比接触电阻值,相对于10−5,10−6甚至更低量级的n型比接触电阻值,依旧不够。
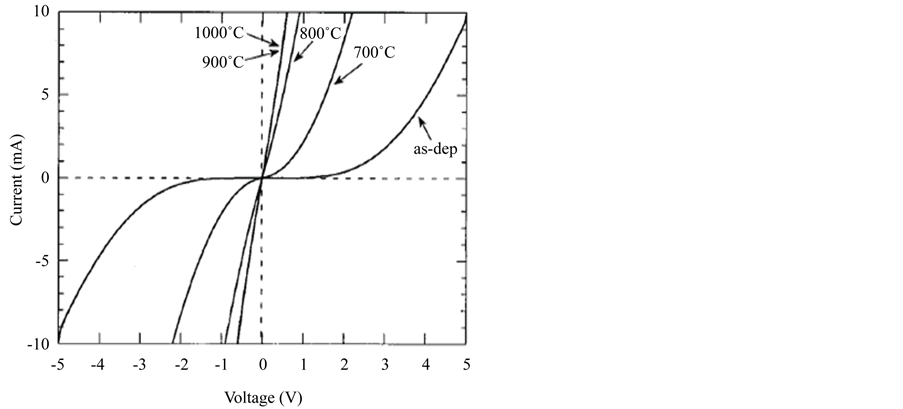
Figure 1. I-V characteristics of the Al/Ti metallization on p-SiC before and after annealing at various temperatures
图1. p型SiC上Al/Ti金属体系在不同温度条件下退火前后的I-V特征
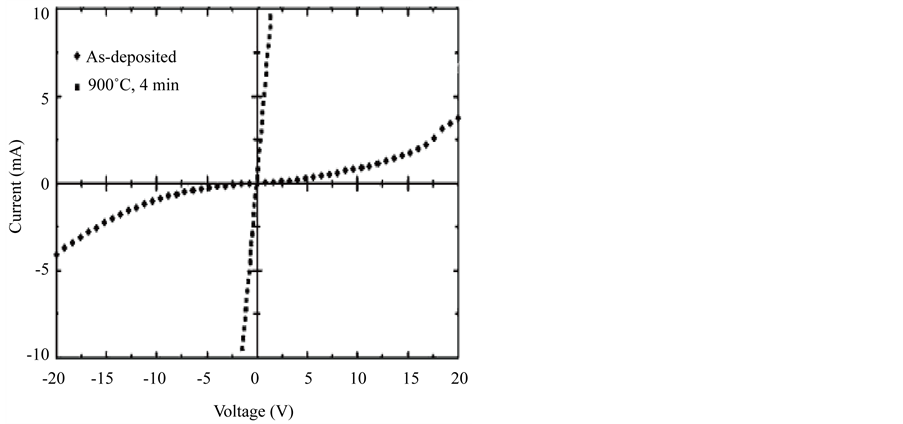
Figure 2. I-V characteristics of the Al/Ti contacts on p-SiC before and after annealing
图2. p型SiC上Al/Ti接触退火前后的I-V特征
因为Al的不稳定性,虽然后来相继也有一些关于AlTi传统金属体系p型欧姆接触的报道,但均是作为其他金属体系的参考来研究,主金属体系使用的金属体系均非传统的AlTi两层金属体系。
2.2. 非传统Al基金属体系
2.2.1. TiAl基金属体系
2003年,日本京都大学材料科学工程部的Ryohei Konishi等人在传统TiAl两层金属的基础上加入了Ni金属,使用Ni/Al (53 nm/44 nm)和Ni/Ti/Al (25 nm/50 nm/300 nm)分别与p型SiC进行实验(和传统的Ti (50 nm)/Al (300 nm)金属体系做比较) [10] 。Ni/Al接触在800℃的退火后形成了欧姆接触,比接触电阻值为5 × 10−3 Ωcm2;而Ni/Ti/Al经800℃退火后形成的欧姆接触比接触电阻值达到1.0 × 10−5 Ωcm2。其I-V特性曲线如图3所示。结果表示,三层金属Ni/Ti/Al的比接触电阻值要比同条件下Ni/Al两层金属的比接触电阻值低两个量级。
该研究还对800℃、1000℃退火后的Ni/Al接触样片和800℃退火后的Ni/Ti/Al样片进行了XRD (X-ray diffraction,X射线衍射仪)扫描分析,分别如图4(a)和图4(b)所示。前者验证了Ni2Si,Ni2Al3和NiAl3化合物的生成;研究认为Ni2Si的形成能够使所掺杂质Al集中在SiC和金属界面上,进而降低1000℃退火后的接触电阻。后者展示的是Ni (25 nm)/Ti (50nm)/Al (300 nm)的样片。验证了具有显著特征的三元化合物Ti3SiC2的生成,和Al-Ti-SiC位相图的预测一致 [11] ;同时也探测到了了TiAl3,TiAl2,Ti3Al,Ni2Si和NiAl3的存在。研究表明,不同Ni层厚度(8,15和35 nm)的Ni/Ti/Al接触经800℃退火后也有上述化合物生成。并且在这些反应中,Ni能够和SiC反应生成Ni2Si,此化合物有助于加强Ti和SiC的反应,形成三元化合物Ti3SiC2。
传统的Ti/Al欧姆接触,退火温度需高达1000℃,该研究中Ni/Al和Ni/Ti/Al接触均在800℃退火后即表现出欧姆行为。另外,Ni/Ti/Al欧姆接触在Ar氛围中400℃退火10 h的条件下展示出了极好的热稳定性。微观分析结果显示,Ni/Al接触形成了Ni2Si,Ni2Al3和NiAl3化合物,而Ni/Ti/Al接触除了形成这些二元化合物之外,还形成了三元化合物Ti3SiC2。
随后的2004年,S. TSUKIMOTO等人使用电子蒸发设备,分别将金属组成为Ti (50 nm)/Al (190 nm)和Ni (35 nm)/Ti (50 nm)/Al (300_nm)的金属体系,沉积在掺Al浓度为4.5 × 1018 cm−3的p型4H-SiC外延片上,实验中Ti (50 nm)/Al (190 nm)金属体系采用的退火条件分别为1000℃,2 min和800℃,30 min;Ni (35 nm)/Ti (50 nm)/Al (300_nm)金属体系采用的退火条件为800℃,30 min。所得最优比接触电阻值分别为2 × 10−5 Ω cm2和7 × 10−5 Ω cm2 [12] 。实验结果表示,Ti (50 nm)/Al (190 nm)金属体系在1000℃,2 min的退火条件下表现出欧姆行为,而在800℃,30 min的退火条件下则表现出肖特基特性;Ni/Ti/Al在800℃退火后表现出欧姆行为。实验中所测I-V特征曲线如图5所示。结果和前期的研究结果 [13] 大致相同:当退火温度低于800℃的时候没有获得传统的Ti/Al欧姆接触。而Ni/Ti/Al在800℃退火后却表现出欧姆行为。结论是Ni的加入有助于退火温度的降低,这归因于Ni和SiC在低至500℃下反应 [14] 。
该实验的XRD分析结果如图6(a)和图6(b)所示,分别是Ti/Al和Ni/Ti/Al金属系统在1000℃,2 min和800℃,30 min退火后的样片结果。对于Ti/Al接触,除了生成Al3Ti之外,还探测到三元化合物Ti3SiC2的存在。而对于Ni/Ti/Al接触,探测到几种化合物(Ti3SiC2,Al4C3,Al3Ti,NiSi2和NiAl3)相关的峰值,也探测到相应于Ti3SiC2尖锐的峰。该XRD分析符合Al-Ti-SiC均衡位相图解 [11] 。研究分析认为,形成于TiAl基欧姆接触上的Ti3SiC2化合物可控制金属和SiC接触间的电流传输。
同年,日本的T. Sakai等人在传统的TiAl金属体系中加入了金属Ge锗,然后沉积在p型4H-SiC上,发现了一种低退火温度就可形成低比接触电阻的实验 [15] 。传统TiAl接触在1000℃的温度下才能将肖特基接触转化为欧姆接触,样品Ge (24 nm)/Ti (32 nm)/Al (144 nm)接触在退火温度低至600℃时即可达到的比接触电阻值为1 × 10−4 Ω cm2。此低退火温度在减小SiC器件栅漏电流方面是令人满意的。并且此样品在Ar氛围中经400℃的热退火,5 h和10 h后展示出极好的热稳定性,这也是器件封装所要求的。XRD分析结果表示,Ti/Al样品上形成了Al3Ti,却没有形成硅化物或碳化物。在Ge/Ti/Al样品上形成了二元化合物Al4C3和三元化合物Ti3SiC2。在其他TiAlGe样品上也形成了上述中间层化合物。证明TiAlGe和SiC衬底发生了反应。最终得出结论,Al4C3和Ti3SiC2等物质在降低金半接触势垒高度方面扮演着重要的角色。
以上三次研究均来自日本京都大学材料科学工程部,虽然作者不同,但从一定程度上可以看出日本半导体行业对p型SiC欧姆接触研究的系统性。2003年的采用了Ni/Al和Ni/Ti/Al金属体系,2004年的
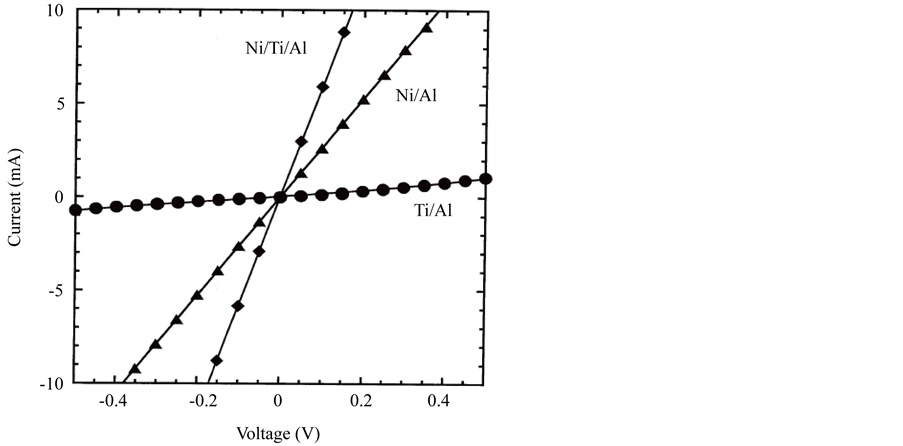
Figure 3. The I-V characteristics of the Ni (53 nm)/Al (44 nm), Ni (25 nm)/Ti (50 nm)/Al (300 nm), and Ti (50 nm)/Al (300 nm) contacts after annealing at 800˚C for 2 min
图3. Ni (53 nm)/Al (44 nm), Ni (25nm)/Ti (50 nm)/Al (300 nm), 和Ti (50 nm)/Al (300 nm)接触样片分别在800℃的温度下退火2 min后的I-V特征

 (a) (b)
(a) (b)
Figure 4. (a) XRD profiles of the Ni/Al contacts after annealing at 800˚C for 2 min, 800˚C for 20 min and 1000˚C for 2 min, respectively; (b) XRD profiles of the Ni (25 nm)/Ti (50 nm)/Al (300 nm) contact after annealing at 800˚C for 30 min
图4. (a) 不同Ni/Al接触样片分别经800℃ 2 min,800℃ 20 min和1000℃ 2 min退火后的的XRD剖面分析;(b) Ni (25 nm)/Ti (50 nm)/Al (300 nm) 接触样片经800℃,30 min退火后的XRD剖面分析
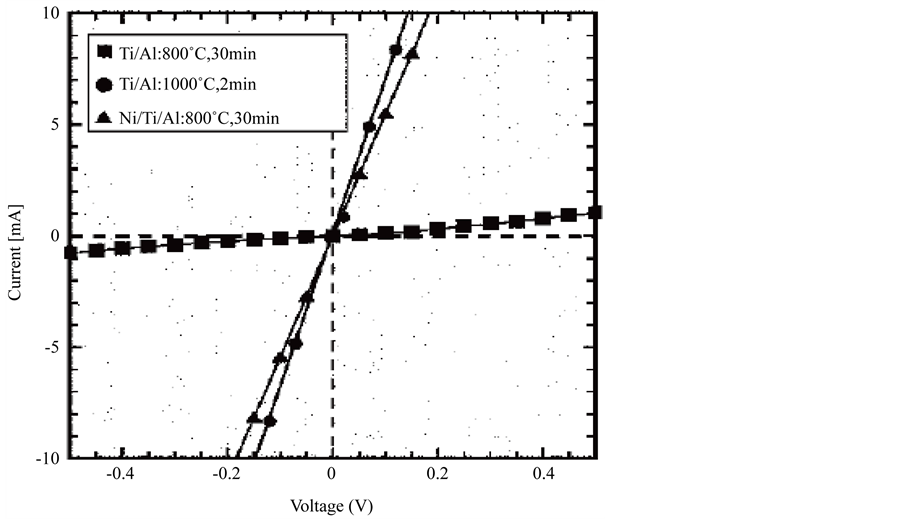
Figure 5. The current-voltage characteristics of Ti (50 nm)/Al (190 nm) contacts after annealing at 800˚C for 30 min and 1000˚C for 2 min, respectively and a Ni (35 nm)/Ti (50 nm)/Al (300 nm) contact after annealing at 800˚C for 30 min
图5. Ti (50 nm)/Al (190 nm)接触样片分别经800℃ 30 min 和1000℃ 2 min,以及Ni(35 nm)/Ti (50 nm)/Al (300 nm)接触样片经800℃ 30 min退火后的I-V特征

Figure 6. XRD profiles of (a) Ti/Al contact annealed at 1000˚C for 2 min and (b) Ni/Ti/Al contact annealed at 800˚C for 30 min
图6. (a) Ti/Al接触经1000℃ 2 min退火后的XRD剖面分析;(b) Ni/Ti/Al接触经800℃ 30 min退火后的XRD剖面分析
S. TSUKIMOTO则用了Ti/Al和Ni/Ti/Al金属体系;同年的T. Sakai在传统的TiAl金属体系中加入了金属Ge锗,GeTiAl接触在退火温度低至600℃时即可达到的比接触电阻值为1 × 10−4 Ω cm2。前两者都在传统TiAl两层金属体系中加入了Ni金属,第三者则均在传统TiAl两层金属体系中加入了Ge金属,三次研究均是为摆脱传统TiAl两层金属体系而做的延伸和改进。实验结果表示,Ni或Ge的加入有助于退火温度的降低;三层金属Ni/Ti/Al与p型SiC的欧姆接触要优于Ni/Al和Ti/Al金属体系;GeTiAl与p型SiC的欧姆接触要优于传统Ti/Al金属体系。
2007年,中国厦门大学微机电中心的朱会丽等人在p型4H-SiC外延片上实施了Ti/Al/Au欧姆接触的研究 [16] ,经930℃的退火后,传输线长度法(Transfer length method, TLM)测得的最小比接触电阻值达到5.4 × 10−4 Ωcm2,其TLM拟合表征曲线如图7所示。该实验也对退火前后的表面形貌和金属界面情况进行了S E M、A E S和X P S等分析。分析结果表示,退火前样品表面平整,退火后的样品表面则变得粗糙,有片状物生成,结果可以肯定在高温退火过程中,金属之间以及金属与半导体之间发生了一定的化学反应,并且认为TiC、TiAl3和AuTi等物质对提高欧姆接触的性能有重要作用。
2013年,有研究 [17] 在Ni/Ti/Al的基础上又加了一层Ni金属,形成Ni/Ti/Al/Ni金属体系,效果很好;而另一组是在传统Ti/Al两层金属上又加两层Ti/Ni金属,形成Ti/Al/Ti/Ni金属体系,效果则不佳。实验首先在掺杂浓度为3 × 1019 cm−3的p型4H-SiC外延片上制备TLM测试结构,然后在氩气氛围中快速热退火(RTA),退火温度范围从700℃~1000℃,持续90 s。随后用I-V特征曲线来检验接触的电学特性,获得的最低比接触电阻值为1.5 × 10−5 Ω cm2,是Ni/Ti/Al/Ni接触在800℃,90 s的退火条件下实现的。700℃,90 s退火后,Ti/Al/Ti/Ni依旧表现出肖特基特性,而Ni/Ti/Al和Ni/Ti/Al/Ni均表现出欧姆行为,且Ni/Ti/Al/Ni要更优一些(图8所示)。700℃的退火温度,比之前研究Ni/Ti/Al的800℃更低。
该研究集中实验了退火温度对Ti/Al/Ti/Ni接触的影响(图9所示)。左半图表示的是退火温度在700℃~900℃范围下的Ni (10)/Ti (40)/Al (240)/Ni (10 nm)样品获得的比接触电阻随退火温度的变化,右半图则是接触电阻随TLM电极间距变化的拟合图(可用来计算比接触电阻值)。XRD分析Ni/Ti/Al/Ni样品在800℃退火前后的界面层成分如图10所示。退火前,只有SiC (0001)基片和非合金金属(Ti,Al,和Ni)的存在。高温退火后,发现了Ti3SiC2,Ni2Si,Al2Ti和NiAl3,证明了几种合金相的形成。此外,研究还得出结论:Al–Ti和Al–Ni合金相的形成限制了元素Al的存在和Al的氧化;该欧姆接触的热稳定性高达300℃;Ti-Al接触合金上增加的Ni金属有助于获得良好的欧姆接触,并且有限制潜在Al元素被氧化的作用。
2015年,中国西安电子科技大学的韩超和张玉明等人研究了一种Ti(x)/Al/Au在p型4H-SiC上形成欧姆接触的实验 [18] 。其中p型SiC外延层的掺杂浓度为1 × 1019 cm−3,Ti厚度分组分别淀积厚度值为50 nm和20 nm,退火条件为1050℃ 3 min,N2氛围。结果在一组50 nm厚的Ti成分下获得一个较低的比接触电阻值为6.4 × 10−5 Ω cm2。Ti (50 nm)/Al/Au接触在1050℃退火前后的I-V特征曲线如图11所示。退火前明显表现出肖特基特性,2 min的退火后I-V特性曲线有所改善,当退火时间为3 min的时候,接触展示出典型的欧姆行为,暗示了微观结构发生了实质性的改变。不同Ti成分下典型的Ti/Al/Au欧姆接触的TLM拟合表征曲线如图12所示,Ti厚度为50 nm的组分获得了较好的欧姆接触,比接触电阻值为6.4 × 10−5 Ω cm2,而Ti厚度为20 nm的组分获得的比接触电阻值仅为2 × 10−4 Ω cm2。
该研究对2 min退火后样品XRD分析结果表明:即有纯Al和纯Au、纯Ti的峰值,也有其它合金相AlAu2Ti,Al3Ti,和AlTi的峰值。研究认为,2 min退火后表现出整流行为是因为没有碳化物或硅化物的形成,而碳化物和硅化物能够作为中间层降低金属和半导体之间的肖特基势垒 [19] - [22] 。3 min退火后的Ti/Al/Au的XRD光谱分析结果认为,三元化合物Ti3SiC2是形成了欧姆接触的主要原因;20 nm厚

Figure 7. Fitting curve of Rs versus spacing based on I-V curve
图7. 基于I-V曲线的电阻Rs随间距变化的拟合曲线
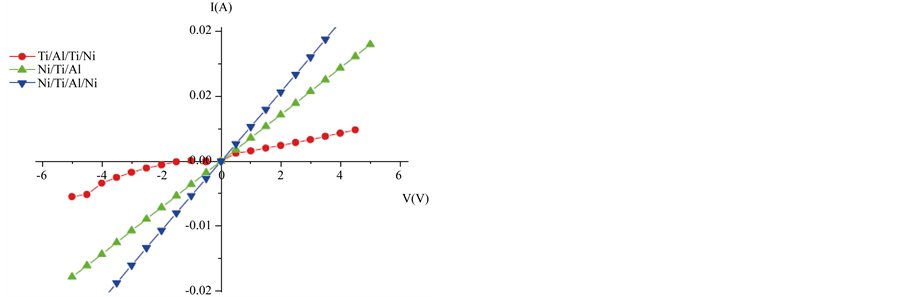
Figure 8. Typical I-V characteristics of the contacts for the three different families of the used alloys obtained after 90 s annealing at 700˚C
图8. 三种不同合金体系经700℃,90 s退火后的I-V特征

Figure 9. Resistance extracted versus distance between TLM pads of the Ni (10)/Ti (40)/Al (240)/Ni (10 nm) contacts and dependence of the specific contact resistance from annealing temperatures at 700˚C-850˚C
图9. Ni (10)/Ti (40)/Al (240)/Ni (10 nm)样片在退火温度范围为700℃~850℃的比接触电阻变化示意图以及不同TLM电极间距上获得的电阻示意图

Figure10. X-ray spectra of Ni/Ti/Al/Ni contacts on 4H-SiC before and annealed at 800˚C
图10. 800℃退火前后4H-SiC上Ni/Ti/Al/Ni接触的X射线光谱

Figure 11. I-V characteristics of the Ti (50 nm)/Al/Au contact before and after annealing at 1050˚C
图11. Ti (50 nm)/Al/Au接触在1050℃退火前后的I-V特征

Figure 12. Comparison of TLM data for Ti/Al/Au ohmic contacts with different Ti content after annealing at 1050˚C for 3 min
图12. 不同Ti含量的Ti/Al/Au接触在1050℃ 3 min退火后的TLM数据比较
Ti组分的的样品,探测到了Al3Ti、Al-Ti-O2、AlAu4的存在,却没有探测到碳化物和硅化物,但表现出欧姆行为。最终原因解释为和Al3Ti、Al-Ti-O2相比,碳化物和硅化物的量过少,设备没有探测到。
2.2.2. 非TiAl基金属体系
非传统Al基金属体系除了TiAl基金属体系外,还有一些关于非TiAl基金属体系的研究。
来自美国的N. A. Papanicolaou等人直接采用非TiAl金属的金属体系,实验了Si (20 nm)/Pt (80 nm)在p型4H-SiC上的欧姆接触,对比于传统的Al/Ti金属系统 [8] 。该研究是在掺Al浓度为1 × 1019 cm−3的p型SiC外延片上完成的。接触形成于真空下1100℃ 3 min的退火后,得到的比接触电阻低至10−4 Ω cm2量级。研究用I-V特征曲线表示p型SiC上Si/Pt接触900℃,1000℃,1100℃,和1200℃退火后的电学特性(图13(a)所示),未经退火的样品表现出整流特性。900和1000度退火后,I-V特征曲线越来越趋向欧姆行为。1100℃ 3 min退火后完全形成了欧姆接触。在室温下所测电阻做间距的函数的TLM拟合(图13(b)所示),得到的最优比接触电阻值为5.8 × 10−4 Ω cm2。
俄歇电子能谱仪(Auger electron spectroscopy, AES)分析结果表明,有Pt迁移到SiC中,使得C扩散出来进入金属层中。该现象有降低比接触电阻值和改善退火后表面形态的作用。SEM检查900℃退火后的表面形态,发现它是光滑的,类似于未退火前的表面,而1100℃退火后的表面形态则很粗糙。该实验还在p-SiC上研究了Si/Pt/Au和Si/Pt/Ni/Au金属体系,验证了Au能够改善金属的导电性和粘合性。该研究的缺点在于退火温度过高,达1100℃,且比接触电阻值也不够优,仅为10−4量级。
2000年,瑞典皇家学会电子科技部门的S.-K. Lee等人报道了一种使用金属TiC (150 nm)的掺杂浓度大于1020 cm−3的p型Si面4H-SiC欧姆接触 [23] 。退火条件选择在氩气氛围中退火950℃,180 s。得到最小比接触电阻值为1.9 × 10−5 Ω cm2 (300℃的测试条件)。
2014年,来自意大利CNR-IMM实验室的M Vivona等人研究在n型和p型4H-SiC上同时形成欧姆接触的实验 [24] 中,使用了100 nm厚的Ni金属,然后在氮气中经1000℃ 60 s退火后,利用TLM测试法获得的p型比接触电阻值为1 × 10−3 Ωcm2。Ni金属与n型和p型4H-SiC接触的I-V特性曲线如图14所示。
XRD分析结果如图15所示,退火后有硅化物合金相形成,且所有的峰值均是Ni2Si的映射。该结果

 (a) (b)
(a) (b)
Figure 13. (a) I-V characteristics of the Si/Pt metallization on p-SiC before and after annealing at various temperatures; (b) Fitting curve of Rs versus spacing based on I-V curve
图13. (a) p型SiC上Si/Pt金属接触体系经不同温度退火前后的I-V特征;(b) 基于I-V曲线的电阻Rs随间距变化的拟合曲线
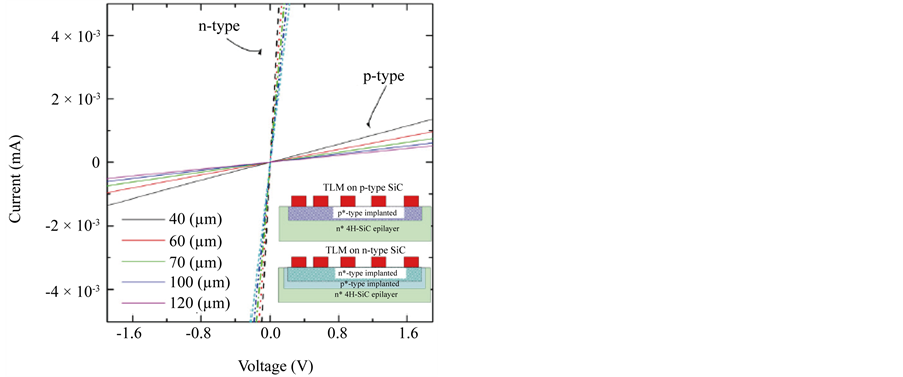
Figure 14. I-V characteristics in terms of different distances between patterns using the TLM model
图14. TLM模型中不同间距的I-V特征

Figure 15. XRD pattern recorded on the Ni/4H-SiC sample after the annealing at 1000˚C for 60 s
图15. Ni/4H-SiC样品在1000℃退火60 s后的XRD模型
和之前报到出Ni2Si在高温下是最稳定物质之一的热力学数据是吻合的 [25] 。同时也证明,Ni2Si对形成p型欧姆接触有着很好的促进作用。
虽然还有一些关于非TiAl基金属体系在p型SiC上形成欧姆接触的研究有待列出,但总体来讲,效果均不如TiAl基金属体系(传统TiAl两层金属外加其它金属形成的金属体系)好。在可预见的将来,p型SiC欧姆接触研究采用的金属体系主要还是传统TiAl两层金属外加其他金属形成的金属体系,亦即TiAl基金属体系。
3. 总结和展望
p型SiC欧姆接触的研究是在缺乏高质量的p型SiC欧姆接触的背景下被逐渐放到研究前沿的,该文总结了近十几年来极具代表性的关于传统Al基金属体系和非传统Al基金属体系在p型SiC材料上形成欧姆接触的研究。目前p型SiC欧姆接触的研究主要是通过掺杂工艺结合沉积退火工艺来实现。掺杂浓度均高于1018 cm−3;传统的TiAl接触退火温度均高达1000℃左右,而高的退火温度会引起了极粗糙的表明形态,且传统Al基金属体系是不可靠的,在传统TiAl两层金属体系中加入Ni、Ge、Au等金属后,有利于退火温度的降低及稳定性的改善。截止目前,大量p型SiC欧姆接触研究报道出的比接触电阻值在10−3~10−5 Ωcm2范围之内,和相对成熟的n型SiC欧姆接触比接触电阻值依旧存在着差距。在可预见的将来,p型SiC欧姆接触研究的方向主要还在TiAl基金属体系的选择以及掺杂激活工艺的改进上。相信随着工艺技术的不断改进和完善,p型SiC欧姆接触的难题一定能够成功解决。
基金项目
项目支持:02重大专项支持。项目编号:2013ZX02501。
文章引用
裴紫微,张 静. p型SiC欧姆接触的研究进展
Research Progress of Ohmic Contacts for p-Type SiC[J]. 智能电网, 2016, 06(02): 116-128. http://dx.doi.org/10.12677/SG.2016.62013
参考文献 (References)
- 1. Lee, S.K., Zetterling, C.M., Danielsson, E., et al. (2000) Electrical Characterization of TiC Ohmic Contacts to Alumimum Ion Implanted 4H-Silicon Carbide. Applied Physics Letters, 77, 1478-1480. http://dx.doi.org/10.1063/1.1290690
- 2. Pécz, B. (2001) Contact Formation in SiC Devices. Applied Surface Science, 184, 287-294. http://dx.doi.org/10.1016/S0169-4332(01)00678-X
- 3. Crofton, J., Luckowshi, E.D., Williams, J.R., et al. (1996) Specific Contact Resistance as a Function of Doping for n-Type 4H- and 6H-SiC. Institute of Physics Conference Series, 142, 569-572.
- 4. Yakimova, R., Hemmingsson, C., Macmillan, M.F., et al. (1998) Barrier Height Determination for n-Type 4H-SiC Schottky Contacts Made Using Various Metals. Materials Science and Engineering, 27, 871-875. http://dx.doi.org/10.1007/s11664-998-0112-5
- 5. Suzuki, A., Fujii, Y., Saito, H., et al. (1991) Effect of the Junction Interface Properties on Blue Emission of SiC Blue LEDs Grown by Step-Controlled CVD. Journal of Crystal Growth, 115, 623-627. http://dx.doi.org/10.1016/0022-0248(91)90815-m
- 6. Crofton, J., Barnes, P.A., Williams, J.R., et al. (1993) Contact Resistance Measurements on p-Type 6H-SiC. Applied Physics Letters, 62, 384. http://dx.doi.org/10.1063/1.108964
- 7. Porter, L.M. and Davis, R.F. (1995) Chemistry, Microstructure, and Electrical Properties at Interfaces between Thin Films of Cobalt and Alpha (6H) Silicon Carbide (0001). Journal of Materials Research, 10, 668-679. http://dx.doi.org/10.1557/jmr.1995.0026
- 8. Papanicolaou, N.A., Edwards, A., Rao, M.V., et al. (1998) Si/Pt Ohmic Contacts to p-type 4H-SiC. Applied Physics Letters, 73, 2009. http://dx.doi.org/10.1063/1.122351
- 9. Pecz, B., Toth, L., di Forte-Poisson, M.A., et al. (2003) Ti3SiC2 Formed in Annealed Al/Ti Contacts to p-Type SiC. Applied Surface Science, 206, 8-11. http://dx.doi.org/10.1016/S0169-4332(02)01195-9
- 10. Konishi, R., Yasukochi, R., Nakatsuka, O., et al. (2003) Development of Ni/Al and Ni/Ti/Al Ohmic Contact Materials for p-Type 4H-SiC. Materials Science and Engineering, B98, 286-293.
- 11. Viala, J.C., Peillon, N., Bosselet, F. and Bouix, J. (1997) Phase Equilibria at 1000˚C in the Al-C-Si-Ti Quaternary System: An Experimental Approach. Materials Science and Engineering: A, 229, 95-113. http://dx.doi.org/10.1016/S0921-5093(97)00002-6
- 12. Tsukimoto, S., Nitta, K., Sakai, T., Moriyama, M. and Murakami, M. (2004) Correlation between the Electrical Properties and the Interfacial Microstructures of TiAl-Based Ohmic Contacts to p-Type 4H-SiC. Journal of Electronic Materials, 33, 460-466. http://dx.doi.org/10.1007/s11664-004-0203-x
- 13. Crofton, J., Porter, L.M. and Williams, J.R. (1997) The Physics of Ohmic Contacts to SiC. Physica Status Solidi (b), 202, 581-603. http://dx.doi.org/10.1002/1521-3951(199707)202:1<581::AID-PSSB581>3.0.CO;2-M
- 14. Bächli, A., Nicolet, M.-A., Baud, L., Jaussaud, C. and Madar, R. (1998) Nickel Film on (001) SiC: Thermally Induced Reactions. Materials Science and Engineering: B, 56, 11-23. http://dx.doi.org/10.1016/S0921-5107(98)00204-9
- 15. Sakai, T., Nitta, K., Tsukimoto, S., Moriyama, M. and Murakami, M. (2004) Ternary TiAlGe Ohmic Contacts for p-Type 4H-SiC. Journal of Applied Physics, 95, 2187. http://dx.doi.org/10.1063/1.1643772
- 16. 朱会丽, 陈厦平, 吴正云. 用于4H-SiC雪崩光电探测器p型欧姆接触的研究[J]. 量子电子学报, 2007, 24(6): 743-747.
- 17. Laariedh, F., Lazar, M., Cremillieu, P., Penuelas, J., Leclercq, J.-L. and Planson, D. (2013) The Role of Nickel and Titanium in the Formation of Ohmic Contacts on p-Type 4H-SiC. Semiconductor Science and Technology, 28, Article ID: 045007. http://dx.doi.org/10.1088/0268-1242/28/4/045007
- 18. Han, C., Zhang, Y.M., Song, Q.W., Tang, X.Y., Guo, H., Zhang, Y.M., et al. (2015) Interface Annealing Characterization of Ti/Al/Au Ohmic Contacts to p-Type 4H-SiC. Journal of Semiconductors, 36, Article ID: 123006.
- 19. Johnson, B.J. and Capano, M.A. (2004) Mechanism of Ohmic Behavior of Al/Ti Contacts to p-Type 4H-SiC after Annealing. Journal of Applied Physics, 95, 5616. http://dx.doi.org/10.1063/1.1707215
- 20. Vassilevski, K., Zekentes, K., Tsagaraki, K., Constantinidis, G. and Ni-kitina, I. (2001) Phase Formation at Rapid Thermal Annealing of Al/Ti/Ni Ohmic Contacts on 4H-SiC. Materials Science and Engineering: B, 80, 370-373. http://dx.doi.org/10.1016/S0921-5107(00)00597-3
- 21. Vang, H., Lazar, M., Brosselard, P., Raynaud, C., Cre-millieu, P., Leclercq, J.-L., et al. (2006) Ni-Al Ohmic Contact to p-Type 4H-SiC. Superlattices and Microstructures, 40, 626-631. http://dx.doi.org/10.1016/j.spmi.2006.08.004
- 22. Han, L.C., Shen, H.J., Liu, K.A., Wang, Y.Y., Tang, Y.D., Bai, Y., et al. (2014) Improved Adhesion and Interface Ohmic Contact on n-Type 4H-SiC Substrate by Using Ni/Ti/Ni. Journal of Semiconductors, 35, Article ID: 072003. http://dx.doi.org/10.1088/1674-4926/35/7/072003
- 23. Lee, S.-K., Zetterling, C.-M., Ostling, M., Palmquist, J.-P., Högberg, H. and Jansson, U. (2000) Low Resistivity Ohmic Titanium Carbide Contacts to n- and p-Type 4H-Silicon Carbide. Solid-State Electronics, 44, 1179-1186. http://dx.doi.org/10.1016/S0038-1101(00)00056-3
- 24. Vivona, M., Greco, G., Giannazzo, F., Lo Nigro, R., Rascunà, S., Saggio, M. and Roccaforte, F. (2014) Thermal Stability of the Current Transport Mechanisms in Ni-Based Ohmic Contacts on n- and p-Implanted 4H-SiC. Semiconductor Science and Technology, 29, Article ID: 075018. http://dx.doi.org/10.1088/0268-1242/29/7/075018
- 25. Roccaforte, F., La Via, F. and Ranieri, V. (2005) Ohmic Contacts to SiC. International Journal of High Speed Electronics and Systems, 15, 781-820. http://dx.doi.org/10.1142/S0129156405003429