Applied Physics
Vol.4 No.07(2014), Article ID:13862,13 pages
DOI:10.12677/APP.2014.47017
An Investigation of the Solder Ball Reliability for a Thermally Enhanced FC-PBGA Assembly
1Department of Mechanical Engineering, National Cheng-Kung University, Tainan
2Department of Civil Engineering, National Cheng-Kung University, Tainan
Email: d1014519@mail.ncku.edu.tw
Copyright © 2014 by authors and Hans Publishers Inc.
This work is licensed under the Creative Commons Attribution International License (CC BY).
http://creativecommons.org/licenses/by/4.0/



Received: Jun. 2nd, 2014; revised: Jul. 2nd, 2014; accepted: Jul. 10th, 2014
ABSTRACT
In this paper, the thermally enhanced FC-PBGA (Flip-Chip Plastic Ball Grid Array) assembly is a basic FC-PBGA package that is over-molded with molding compound, after which an aluminum heat spreader is adhered to the top of the molding compound and subsequently mounted on a PCB (Printed Circuit Board). Three-dimensional finite element analysis using the commercial ANSYS software is performed to study solder ball fatigue life for this thermally enhanced FC-PBGA assembly subjected to temperature cycling. In the simulation, all the solder bumps and the solder balls are modeled with nonlinear viscoplastic time and temperature dependent material properties based on Anand’s constitutive equation. Solder ball fatigue life is estimated by the widely accepted modified Coffin-Manson equation. The thermo-mechanical behavior of the assembly is presented. Effects of alternative design parameters of the package components on solder ball fatigue life are analyzed. It is found that higher CTE of the substrate core, higher Young’s modulus of the substrate core, thicker substrate core, lower heat spreader CTE, lower heat spreader Young’s modulus, reduction of the thickness or width of the heat spreader, higher CTE of the molding compound and lower Young’s modulus of the molding compound result in better solder bump fatigue life. The effects of the parameters of the adhesive are found to have lesser impact on package reliability. However, lower CTE, lower Young’s modulus and greater thickness are found preferable.
Keywords:Modified Coffin-Manson Equation, Finite Element Analysis, Anand’s Constitutive Equation, Packaging

散热强化型覆晶球栅数组组合体之锡球
可靠度研究
林家帆1,吴俊煌1,朱圣浩2
1国立成功大学机械工程学系,台南市
2国立成功大学土木工程学系,台南市
Email: d1014519@mail.ncku.edu.tw
收稿日期:2014年6月2日;修回日期:2014年7月2日;录用日期:2014年7月10日

摘 要
本文探讨之散热强化型覆晶球栅数组组合体是基本型覆晶球栅数组封装体包封着封胶,接着在封胶上面黏附着一片铝质散热板,最后以锡球构装在印刷电路板上。凸块与锡球是锡铅合金属于黏塑材料,在文中的数值模拟中,是以亚兰德模型来定义并描述其弹性、塑性及潜变行为,其余组件是假设为弹性材料。本文使用有限元素分析软件ANSYS建立一精确之三维有限元素模型,于温度循环负载下,针对此组合体并搭配修正型Coffin-Manson疲劳寿命估算式进行锡球可靠度分析。本文报告了锡球应力、应变及疲劳寿命等机械行为。最后,进行參数化分析,探讨组合体组件的设计参数对锡球疲劳寿命的影响。结果表明:增加基板基材的热膨胀系数、杨氏系数与厚度可以提高锡球疲劳寿命。减少散热板膨胀系数、杨氏模数、厚度与宽度也会造成锡球寿命增加。增加封胶热膨胀系数或减少封胶杨氏模数会造成锡球疲劳寿命增加。黏着剂所占的体积小对锡球疲劳寿命的影响很小。在本文之研究范围内,减少热膨胀系数、减少杨氏模数及增大厚度有助于提升锡球疲劳寿命。
关键词
修正型Coffin-Manson估算式,有限元素法,亚兰德模型,封装

1. 引言
集成电路(Integrated Circuit, IC)封装之目的是要将集成电路与相关组件包封起来,防止外来的破坏、保护封装体结构、提供散热途径、维持电子讯号与电力的传输。近年来由于电子产品朝向轻、薄、短小、高功率与多功能发展,覆晶球栅数组(Flip-Chip Plastic Ball Grid Array, FC-PBGA)封装因为有高I/O接脚数、高密度、高散热率、高频噪声容易控制与高传输速度等优点,已成为先进封装的主流。基本型覆晶球栅数组组合体的示意图如图1所示,组合体是由许多组件组成,由于各组件热膨胀系数的不一致很容易受到环境温度变化的影响而于各组件产生热应变及热应力。这些热应变及热应力之大小会不断地变化与累积。由于锡球体积相对地小,容易发生疲劳破坏,造成封装体失效。
所以近年来许多学者针对基本型覆晶球栅数组封装体之锡球可靠度进行研究,1997年Lau[1] 与Mercado[2] 相继提出基本型覆晶球栅数组封装体中,锡球最容易发生破坏,并指出基板厚度增加会增加封装体命。1999年Mercado与Sarihan[3] 针对基本型覆晶球栅数组封装体于温度循环负载下,使用有限元素法,分析芯片大小、芯片厚度、基板基材与凸块高度对锡球寿命的影响,并指出增加基板基材厚度、增加芯片厚度会增加锡球疲劳寿命。2001年Verma[4] 使用有限元素法配合实验方法,也针对基本型覆晶
球栅数组封装体进行锡球可靠度分析,发现基板之热膨胀系数对锡球可靠度的影响很显着。
由于电子产品朝向高功率、高封装密度发展,使得散热问题变得很重要。很多散热的方法被发展出来,零件有:散热板、金属盖、封胶与散热鳍片等,于是有散热强化型覆晶球栅数组封装体的发展。但是增加这些组件会改变原来组合体的应力、应变与疲劳寿命等机械行为。到目前为止,针对散热强化型覆晶球栅数组组合体之锡球可靠度研究比较少。
基本型覆晶球栅数组组合体,包封着封胶,示意图如图2所示,在本文称为第2型组合体。包封封胶的目的是加强散热并防止外来环境因子(溶剂、湿气与辐射线)对芯片的侵害。2006年shim and Lo等人[5] 对此种散热强化型组合体进行可靠度研究,发现包封封胶会减少锡球寿命。
2006年Jen等人[6] ,使用有限元素软件,针对某特定型态的散热强化型覆晶球栅数组组合体进行锡球可靠度研究,并搭配Darreau所提出的疲劳寿命公式计算出锡球的疲劳寿命,指出改变黏着剂尺寸,可以提升锡球的疲劳寿命。2008年Biswas[7] 针对另一种型态的散热强化型覆晶球栅数组组合体,也使用有限元素法,搭配Darreau所提的疲劳寿命公式计算锡球的疲劳寿命,进行锡球可靠度研究,指出增加基板基材厚度、增加芯片厚度会造成锡球疲劳寿命增加。2011年Liu等人[8] ,使实验方法研究FC-BGA封装体的变形,指出加入散热板可能会导致封装体由向上弯曲,变成向下弯曲。
本文是针对基本型覆晶球栅数组组合体,包封着封胶,接着在封胶上面黏附着一片铝质散热板,示意图如图3所示,在本文称为第3型组合体,进行锡球可靠度研究。以ANSYS商业软件建立一精确之三维有限元素模型,于温度循环负载下针对此组合体进行应力及应变等机械行为模拟分析,进而估算其疲劳寿命。最后,进行参数化分析,探讨封装体组件的设计参数对凸块疲劳寿命的影响。
2. 有限元素仿真分析
2.1. 覆晶球栅数组组合体描述
本文研究分析的三个覆晶球栅数组组合体是来自文献[9] ,包括第1型、第2型与第3型组合体。第

Figure 1. Type 1 assembly
图1. 第一型组合体(基本型覆晶球栅数组组合体)

Figure 2. Type 2 assembly
图2. 第二型组合体

Figure 3. Type 2 assembly
图3. 第二型组合体
1型组合体又称为基本型覆晶球栅数组组合体,凸块(Solder bump)是全数组分布在芯片(Die)上,然后建构在基板(substrate)上方,芯片与基板间的空隙充填着底胶(Underfill)。底胶的功用是减少芯片与基板间的热膨胀系数不匹配造成的问题,并保护凸块,这样就形成基本型的覆晶球栅数组封装体。接着以锡球(Solder Ball),将此封装体建构在印刷电路板(PCB)上,这样就形成基本型的覆晶球栅数组组合体。基板的尺寸是 25 × 25 × 1.0 mm;印刷电路板的尺寸是100 × 100 × 1.4 mm。二者都是外层有防护层(Solder Mask),里面有铜箔层(Cu Layer)的多层板。基板的基材是BT(bismaleimidetriazine);印刷电路板的基材是FR-4。热通孔(Vias)目的是信号与热量传输,分布在基板及印刷电路板的内部。凸块是全数组分布;锡球是部分数组分布,分布图(从基板往下看的下视图)如图4所示。由于组合体的对称,图4只显现四分之一的分布。第2型组合体是基本型覆晶球栅数组组合体包封着封胶,如图2所示。第3型组合体是第二型组合体上面黏着一片散热板,如图3所示。黏着剂的厚度是1.4 mm,组合体组件的尺寸如表1所示。
2.2. 组合体组件的材料性质
凸块与锡球是63Sn37Pb锡铅合金属于黏塑材料具有低熔点,良好焊接性,良好机械性质等特性。在本文仿真分析是以亚兰德模型(Anand’s model)[6] 来定义并描述他们的弹性、塑性与潜变行为。方程式如

Figure 4. Location of solder balls
图4. 锡球分布图
表1. 组合体组件尺寸
下所示:
 (1)
(1)
 (2)
(2)
 (3)
(3)
其中
 :塑性应变率(Plastic strain rate)
:塑性应变率(Plastic strain rate)
A:前置指数因子(Pre-exponential factor)
 :活化能(Activation energy)
:活化能(Activation energy)
 :气体常数(Universal gas constant)
:气体常数(Universal gas constant)
 :应力的乘数(Multiplier of stress)
:应力的乘数(Multiplier of stress)
 :绝对温度(Absolute temperature)
:绝对温度(Absolute temperature)
 :应变率敏感度(Strain rate sensitivity)
:应变率敏感度(Strain rate sensitivity)
 :硬化常数(Hardening constant)
:硬化常数(Hardening constant)
 :饱和变形阻力值之系数(Coefficient for saturation deformation
resistance value)
:饱和变形阻力值之系数(Coefficient for saturation deformation
resistance value)
 :硬化之应变率敏感度(Strain rate sensitivity of hardening)
:硬化之应变率敏感度(Strain rate sensitivity of hardening)
 :饱和变形阻力值之应变率敏感度(the strain rate sensitivity
of saturation (deformation resistance) value)).
:饱和变形阻力值之应变率敏感度(the strain rate sensitivity
of saturation (deformation resistance) value)).
参数值 = 9400
= 9400 ,
, =1.5,
=1.5, =
= ,
, = 0.303,
= 0.303, =1380Mpa,
=1380Mpa, =13.8 Mpa,
=13.8 Mpa, = 0.07,
= 0.07, =1.3 and
=1.3 and
 = 12.42 Mpa。组合体其他组件的材料性质如表2所示。
= 12.42 Mpa。组合体其他组件的材料性质如表2所示。
2.3. 温度循环负载
温度循环测试是采用电子组件工程委员会(Joint Electronic Devices Engineering Council, JEDEC) JESD 22A105-B规范。温度循环负载曲线如图5所示,最高温为125℃,最低温为−40℃,恒温时间各为10分钟,升温降温时间各为15分钟,温度变换速率为11℃/min,每一循环有三个温度周期,每一个温度周期是50分钟。
2.4. 网格收敛分析
网格过密与过多会造成运算时间冗长;网格太疏松与数目太少会造成模拟结果不正确。为了探讨网格对锡球之疲劳寿命的影响,模拟过程中,逐次增加网格数量,直至疲劳寿命值收敛为止。本文选用了四种网格,分别命名为M1(154764元素)、M2(206540元素)、M3(251658元素)与M4(315012元素)进行仿真分析,图6显示了网格数目对疲劳寿命的影响。由图可知使用网格M3(251658元素),锡球之疲劳寿命值已趋近收敛,也就是使用M3网格即能达到精密结果,M3网格如图7所示。
3. 结果与讨论
本文使用三维有限元素法来研究散热强化型覆晶球栅数组组合体的热热机械行为,得到的结果如下:
表2. 组件材料性质

Figure 5. The temperature cycle used in the simulation
图5. 温度循环负载曲线

Figure 6. Relation between fatigue life and element number for Type 3 assembly
图6. 温度循环负载曲线

Figure 7. Finite element mesh M3 used in simulations for Type 3 FC-PBGA assembly
图7. M3有限元素网格
3.1. 应力与应变分析
组合体是由许多组件组成,由于各组件热膨胀系数的不一致,很容易受到环境温度变化的影响而导致组合体变形进而造成组合体内产生应力及应变问题。
von Mises应力计算方程式如下所示:
 (4)
(4)
von Mises应变计算方程式如下所示:
 (5)
(5)
图8~10分别为第一型组合体之锡球von Mises应力分布图、锡球von Mises应变分布图与组合体变形图。分布图中显示,最大von Mises应力与最大von Mises应变皆发生在锡球内围的1号锡球(称为关键锡球)上。此处位于芯片边缘下方, 充斥着各种组件,容易发生最大热膨胀系数不匹配。再加上基板中央没有锡球支撑(参考图8或图9的锡球排列),如果发生较大的变形挤压,1号锡球会受到较大的挤压力。这些因素导致1号锡球受到最大的挤压变形。参考变形图(图10),也发现1号锡球受到的挤压变形,较其他锡球严重,所以该锡球最容易发生疲劳破坏。
图11~13分别为第2型组合体之锡球von Mises应力分布图,锡球von Mises应变分布图与组合体变形图。分布图显示,最大von Mises应力与最大von Mises应变也发生在锡球内围的1号锡球上,这是因为加入了封胶后,封装体的翘曲出现少许的增加,变形图(图13)与原变形(图10)相似,以至于关键锡球的位置没有改变。参考变形图(图13)发现1号锡球受到的挤压变形,较其他锡球严重,所以该锡球最容易发生疲劳破坏。
图14~17分别为第3型组合体之锡球von Mises应力分布图,锡球von Mises应变分布图,组合体变形图。由分布图发现加入散热板后,最大von Mises应力与最大von Mises应变皆发生在7号锡球上,此处挤压最严重。关键锡球的位置发生改变,原因是加入了散热板后,大幅地减缓了封装体的翘曲,因而关键锡球的位置改变,导致靠近封胶边缘下方的7号锡球挤压最严重。
3.2. 疲劳寿命预测
组合体于温度循环负载分析后,凸块之疲劳寿命通常以疲劳寿命周期数Nf(mean cycle to failure)来表示,疲劳寿命周期数一般使用modified Coffin-Manson方程式[10] 来预测,此方程式考虑周期频率和温度
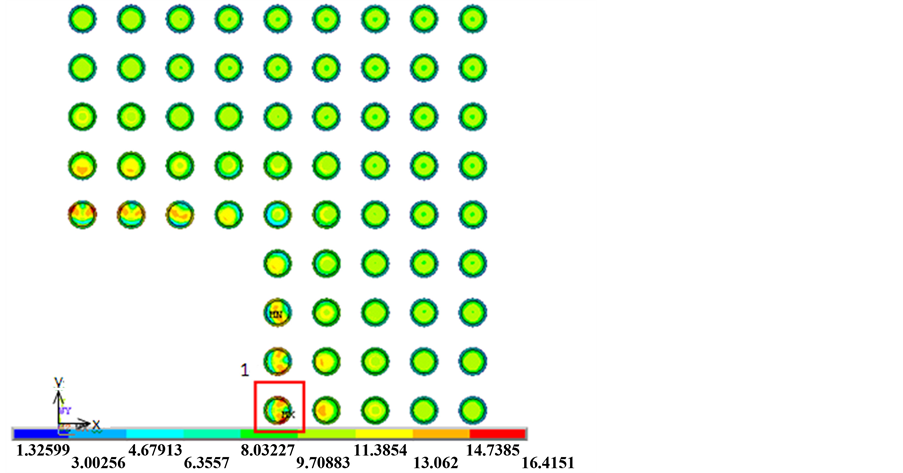
Figure 8. Von Mises stress distribution of solder ball (Type 1 assembly)
图8. 锡球的Von Mises应力分布图(第一型组合体)

Figure 9. Von Mises strain distribution of solder ball (Type 1 assembly)
图9. 锡球的Von Mises应变分布图(第一型组合体)
范围的影响,定义如下:
 (6)
(6)
其中, 为疲劳寿命周期数,
为疲劳寿命周期数,
c=为疲劳延性指数,
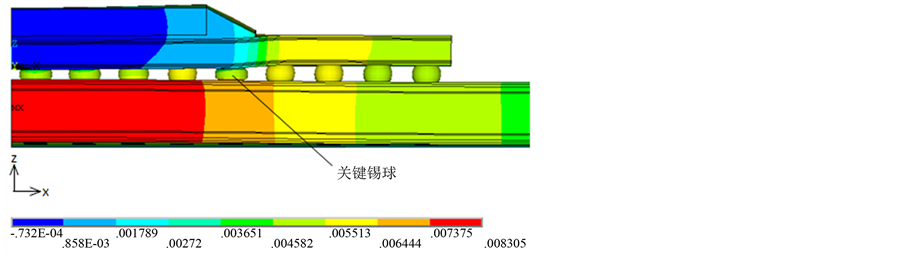
Figure 10. Deformation of the type1 assembly
图10. 变形图(第1型组合体)

Figure 11. Von Mises stress distribution of solder ball (Type 2 assembly)
图11. 锡球的Von Mises应力分布图(第二型组合体)

Figure 12. Von Mises strain distribution of solder ball (Type 2 assembly)
图12. 锡球的Von Mises应变分布图(第二型组合体)
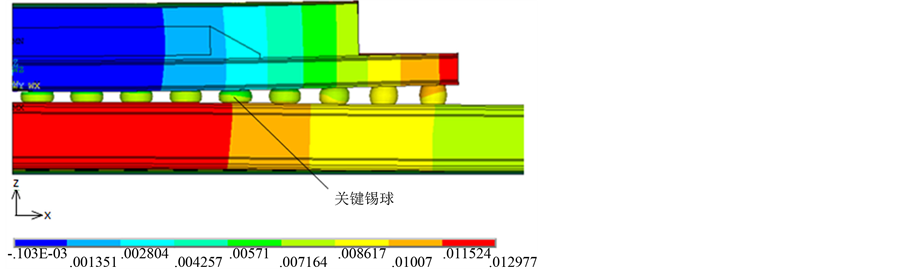
Figure 13. Deformation of the type 2 assembly
图13. 变形图(第2型组合体)
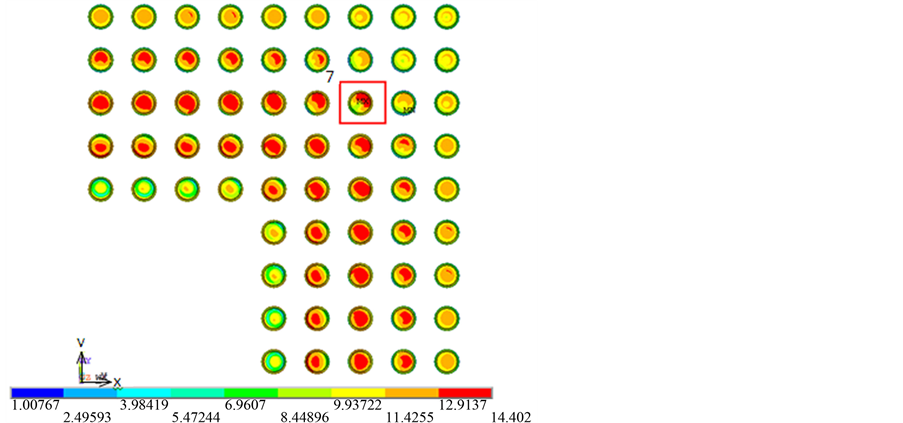
Figure 14. Von Mises stress distribution of solder ball (Type 3 assembly)
图14. 锡球的Von Mises应力分布图(第三型组合体)
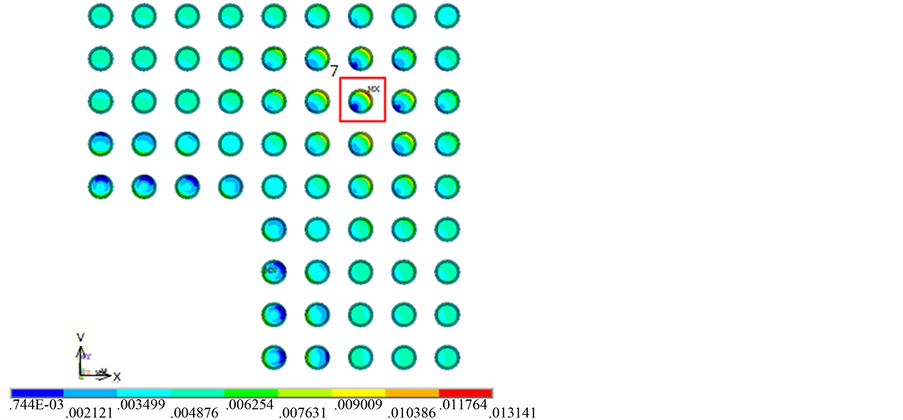
Figure 15. Von Mises strain distribution of solder ball (Type 3 assembly)
图15. 锡球的Von Mises应变分布图(第三型组合体)
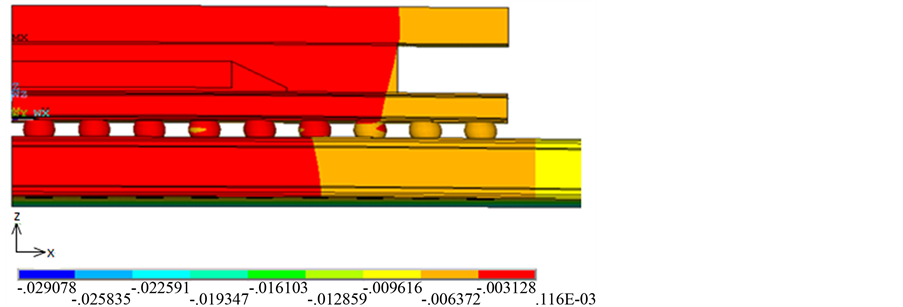
Figure 16. Deformation of the type 3 assembly
图16. 变形图(第3型组合体)

Figure 17. Solder ball fatigue life for the three different types of FC-PBGA assembly
图17. 锡球疲劳寿命于三种不同组合体之比较
 为温度循环负载之周期频率,
为温度循环负载之周期频率,
 为一个温度周期之温度范围(最高温与最低温之平均值),
为一个温度周期之温度范围(最高温与最低温之平均值),
 为疲劳延性系数(如果是63Sn37Pb锡铅合金,
为疲劳延性系数(如果是63Sn37Pb锡铅合金, =0.325 [10] ),
=0.325 [10] ),
 为剪应变范围。
为剪应变范围。
根据von Mises破坏准则,剪应变 与von Mises应变值
与von Mises应变值 的关系为:
的关系为:

将 以
以 代入6式,可以得到
代入6式,可以得到
 (7)
(7)
如果我们将模拟得到之锡球最大von Mises应变范围与相关系数(c、 )代入7式,可求得锡球的疲劳寿命。图11比较三种不同组合体之锡球疲劳寿命。由图可以发现,包附封胶会造成锡球寿命减少,这
)代入7式,可求得锡球的疲劳寿命。图11比较三种不同组合体之锡球疲劳寿命。由图可以发现,包附封胶会造成锡球寿命减少,这
是因为包覆封胶,封胶热膨胀系数小于基板热膨胀系数,造成封装体翘曲增加。但如果封胶上面再黏附着散热板,锡球寿命会显着增加,原因是加入了散热板后,散热板膨胀系数大于封胶热膨胀系数,导致散热板下弯,大幅地减缓了封装体的翘曲。
3.3. 设计参数的影响
本文考虑不同封装体组件的设计参数对锡球疲劳寿命的影响。封装体组件包括基板基材、散热板、封胶与黏着剂。以材料参数±30%改变与尺寸参数±15%改变,作为探讨范围。
3.3.1. 基板基材对锡球寿命的影响
由图18~19可以得知,基板基材的热膨胀系数与杨氏系数对锡球寿命影响是显着的,增加其热膨胀

Figure 18. Relation between solder ball fatigue life and the coefficient of thermal expansion
图18. 锡球疲劳寿命与热膨胀系数的关系

Figure 19. Relation between solder ball fatigue life and Young’s modulus
图19. 锡球疲劳寿命与杨氏系数的关系
系数与杨氏系数都可以提高锡球疲劳寿命。因为增加基板基材的热膨胀系数可以减少基板基材热膨胀系数与锡球热膨胀系数的差异;而增加基板基材的杨氏系数可以提升基板的支撑力,造成锡球变形减小,因而锡球疲劳寿命会增加。
由图20可发现基板尺寸也对锡球寿命影响显着,增加基板厚度导致基板不易变形,因此锡球寿命增加。
3.3.2. 散热板的影响
由图18~19可以得知,散热板的热膨胀系数对锡球寿命影响非常显着。因为散热板的体积很大,增加散热板热膨胀系数会造成锡球与周边组件的热膨胀系数差异显着恶化,并促使封装体作大幅度下弯,使得锡球受到较大程度的挤压,导致锡球寿命急遽减少;减少扬氏系数会降低锡球上下端的等效杨氏系数的差异,使得锡球寿命增加。
散热板厚度与宽度的影响如图20所示,减少厚度与宽度都会使得膨胀程度差异降低,导致锡球疲劳寿命增加。
3.3.3. 封胶对锡球寿命的影响
由图18~19可知,封胶热膨胀系数对锡球寿命的影响是显着的。增加封胶热膨胀系数,构装体翘曲会减缓,造成锡球寿命增加;增加封胶的杨氏系数,封胶会变硬,构装体愈容易翘曲,造成锡球疲劳寿命下降。
封胶尺寸对锡球寿命的影响由图20可知,增加宽度与厚度都会使锡球寿命下降。但是宽度的影响比厚度的影响显着,因为当封胶宽度改变,会改变封胶与上下组件的接触面积,但是厚度改变却不会改变接触面积。
3.3.4. 封胶对锡球寿命的影响
由图18~20可知,黏着剂对锡球疲劳寿命影响很小。在本文黏着剂之热膨胀系数(160 ppm/℃~300 ppm/℃)、杨氏系数(2.5 MPa~4.5 MPa)以及厚度研究范围(1.2 mm~1.6 mm)内,增加热膨胀系数,减少杨氏系数与增加黏着剂厚度都会提高锡球的疲劳寿命。
4. 结论
使用三维有限元素法于温度循环负载下针对散热强化型覆晶球栅数组组合体之热机械行为进行研究。

Figure 20. Relation between solder ball fatigue life and dimensions
图20. 锡球疲劳寿命与尺寸的关系
研究结果发现第1型与第2型组合体的关键锡球皆发生在芯片边缘下方的1号锡球上。第3型组合体的关键锡球发生在封胶边缘下方的7号锡球上。基本型覆晶球栅数组组合体,包附封胶会造成锡球寿命减少。接着,如果封胶上面再黏附着散热板,会造成锡球疲劳寿命显着地增加。从参数化分析,各参数对锡球疲劳寿命的影响,总结如下:
(1) 基板基材的热膨胀系数与杨氏系数对锡球寿命的影响是显着的,增加其热膨胀系数与杨氏系数都可以提高锡球疲劳寿命。增加基板基材厚度会增加锡球寿命。
(2) 散热板的设计也会显着地影响锡球的寿命。减少散热板膨胀系数与杨氏模数会造成锡球寿命显着地增加。减少散热板厚度与宽度也会造成锡球寿命增加。
(3) 增加封胶热膨胀系数或减少封胶杨氏模数会造成锡球疲劳寿命增加。封胶宽度的影响远大于厚度的影响。
(4) 黏着剂所占的体积小,由模拟结果可以得知黏着剂对锡球疲劳寿命的影响很小。在本文黏着剂设计参数之研究探讨范围内,减少热膨胀系数、减少杨氏模数及增大黏着剂厚度有助于提升锡球疲劳寿命。
参考文献 (References)
- [1] Lau, J.H. (1997) Low cost flip chip technologies for DCA, WLCSP, and PBGA assemblies. McGraw-Hill Professional, New York.
- [2] Mercado, L., Sarihan, V., Guo, Y. and Mawer, A. (1999) Impact of solder pad size on solder joint reliability in flip chip PBGA package. Proceeding of Electronic Components and Technology Conference, San Diego, 1-4 Jun 1999, 255-259
- [3] Mercado, L.L. and Sarihan, V. (1999) Predictive design of flip-chip PBGA for high reliability and low cost. Electronic Components and Technology Conference, San Diego, 1-4 Jun 1999, 1111-1115.
- [4] Verma, K.S., Park, B. and Ackerman, W. (2001) On the design parameters of flip-chip PBGA assembly for optimum solder ball reliability. IEEE Transactions on Components and Packaging, 24, 300-307.
- [5] Shim, K.W. and Lo, W.Y. (2006) Solder fatigue modeling of flip-chip bumps in molded packages. IEEE International Electronic Manufacturing Technology Conference, 8-10 November 2007, Petaling Jaya, 109-114.
- [6] Jen, Y.M., Fang, C.K. and Yeh, Y.H. (2006) Effect of size of lid-substrate adhesive on reliability of solder balls in thermally enchanced flip-chip PBGA packages. IEEE Transactions on Components and Packaging Technologies, 29, 718-727.
- [7] Biswas, K., Liu, S.G. and Zhang, X.W. (2008) Effects of detailed substrate modeling and solder layout design on the 1st and 2nd level solder joint reliability for the large die FCBGA. International Conference on Thermal, Mechanical and Nultiphysics Simulation and Experiments in Micro-Electronics and Micro-Systems, Freiburg im Breisgau, 20-23 April 2008, 1-7.
- [8] Liu, A.H., Wang, D.W. and Huang, H.M. (2011) Correlation between Shadow Moiré and Micro Moiré techniques through characterization of flip-chip BGA. IEEE International Microsystems, Packaging, Assembly and Circuits Technology Conference, Taipei, 19-21 October 2011, 71-75.
- [9] Liu, T.P., Wu, G.H., Ju, S.H. and Lai, H.Y. (2012) Investigation of fatigue life of solder bumps in a thermally enhanced FC-PBGA assembly. Applied Physics, 2, 20-27.
- [10] Engelmaier, W. (1983) Fatigue life of leadless chip carrier solder joints during power cycling. IEEE Transaction on Component, Hybrids and Manufacturing Technology, 6, 232-237.
