Applied Physics
Vol.
09
No.
01
(
2019
), Article ID:
28348
,
6
pages
10.12677/APP.2019.91001
Research Progress of Laser Assisted Discharge Produce Plasma Extreme Ultraviolet Source
Jiazhi Wu, Zhuo Xie*, Yinping Dou, Jingquan Lin
School of Science, Changchun University of Science and Technology, Changchun Jilin

Received: Dec. 16th, 2018; accepted: Dec. 31st, 2018; published: Jan. 7th, 2019

ABSTRACT
Extreme ultraviolet (EUV) lithography is promising technique to manufacture chips with feature sizes less than 22 nm, which is an important means to promote the development of semiconductor integrated circuits. The EUV source is an important part of EUV lithography system. The method of laser assisted discharge plasma EUV source can make the traditional solid target as the material required for discharge plasma, and has advantages of a simple device structure, high power of the EUV source, precise control of discharge time and stability of discharge that make it has good application prospects. This paper discusses the research progress of laser-assisted discharge plasma EUV source, and introduces the generation of EUV source with different target electrode polarity, discharge parameter and pulse laser parameters. The characteristics of producing EUV light source under different conditions are summarized, which provides a useful reference for the better use of laser-assisted discharge plasma to produce EUV light source.
Keywords:Laser Assisted Discharge Plasma, Z-Pinch Plasma, Extreme Ultraviolet Source
激光辅助放电等离子体极紫外光源研究进展
吴家志,谢卓*,窦银萍,林景全
长春理工大学理学院,吉林 长春

收稿日期:2018年12月16日;录用日期:2018年12月31日;发布日期:2019年1月7日

摘 要
极紫外光刻技术可以制造特征尺寸小于22 nm的芯片,是推动半导体集成电路发展的重要手段。极紫外光源是极紫外光刻系统的重要组成部分。激光辅助放电等离子体极紫外光源方法可以使传统固体靶材作为放电等离子体所需要的材料,其装置结构简单,产生极紫外光源功率高,能够精确控制放电时间和提高放电的稳定性等,具有良好的应用前景。本文系统阐述了激光辅助放电等离子体极紫外光源相关研究进展,介绍靶材作为不同电极极性、不同放电参数和激光参数下放电等离子体极紫外光源的产生,并对不同条件下产生极紫外光源的特点进行了归纳总结,为更好地使用激光辅助放电等离子体进行产生极紫外光源提供有益的参考。
关键词 :激光辅助放电等离子体,Z箍缩等离子体,极紫外光源

Copyright © 2019 by author(s) and Hans Publishers Inc.
This work is licensed under the Creative Commons Attribution International License (CC BY).
http://creativecommons.org/licenses/by/4.0/


1. 引言
极紫外光源光刻技术的问世推动半导体集成电路的发展,在极紫外光源光刻系统中,极紫外光源是该系统的重要组成部分。目前,极紫外光源主要由两种途径获得:激光等离子体(Laser Produced Plasma, LPP)极紫外光源和放电等离子体(Discharge Produced Plasma, DPP)极紫外光源。激光等离子体极紫外光源指高能量的脉冲激光聚焦在靶材上面产生高温高密度等离子体,同时可以产生几十或者几百eV的光子光源。产生极紫外光源比较稳定和亮度高,但是光源的能量经过了电能、光能、等离子体能的三级转化进而降低了转化效率,其最终的转换效率小于10% [1] 。放电等离子体是另一种获得极紫外光源的方法,通常情况下将气体冲入电极之间,在高压作用下产生高温高密等离子体辐射极紫外光源。相对于LPP方法,此光源具有辐射强度强、输出功率高、最终能量转化率可达到45% [1] 及其装置成本较低等优点,受到研究人员的青睐。目前放电产生等离子体光源的方法有很多,比如:中空阴极放电等离子体 [2] 、等离子体聚焦 [3] 、毛细管放电等离子体 [4] 。但是放电等离子体产生光源区域不稳定和产生光源的时间很难精确控制。基于此,F. Pinnekamp等人 [5] 提出了激光辅助放电等离子体(Laser-Assisted Discharge Produce Plasma, LADPP)的方法来解决以上问题。其基本的物理过程为:脉冲激光辐照靶材形成初始等离子体并使带有高压的电极导通,产生放电等离子体和脉冲电流。变化的电流产生轴向磁场,等离子体中的带电粒子在自生的磁场中受到洛伦兹力的作用向轴向移动,压缩等离子体,在电流上升到最大值时,等离子体直径被压缩至最小,这种现象叫做Z箍缩效应 [6] [7] 。等离子体经过箍缩形成高温高密度等离子体,能够向外辐射极紫外光源。近十年左右,研究人员开始利用激光辅助放电等离子体方法来进行极紫外光源研究。本文中,我们阐述了靶材作为不同电极极性、放电参数和激光参数情况下极紫外光源的产生。
2. 放电电极极性
在激光辅助放电等离子体实验中,靶材电极极性影响极紫外光源的产生。当脉冲激光辐照阴极时,等离子体羽最外层电子在电场的作用下将被加速,向阳极运动,此时很容易形成Z箍缩等离子体并向外辐射极紫外光源。相反,脉冲激光辐照阳极时,等离子体羽最外层电子在电场的作用下减速,抑制了等离子体向阴极膨胀,导致放电电流不能有效地压缩和加热等离子体产生高温高密度箍缩等离子体,从而很难转化为EUV辐射输出。2010年,日本东京工业大学的朱秋实 [8] 等人进行激光辅助放电等离子体实验,将脉冲激光分别作用于阳极(a)和阴极(b)靶材,用前面带有Zr膜的pinhole相机来拍摄极紫外辐射光源,如图1所示。可以看出,脉冲激光作用于阴极时更容易产生极紫外辐射。因此,通常情况下人们将激光辐照于阴极靶材来研究放电等离子体极紫外光源。

Figure 1. EUV radiation from target as anode (a) and cathode (b), respectively
图1. 靶材分别作为阳极(a)和阴极(b)时的EUV辐射
根据国外研究者结果表明,固体靶材的形状一般为平面和曲面等,并且设计比较单一,下面介绍两种较好的激光辅助放电等离子体实验靶材装置。Tatsuya Sodekoda等人 [9] 设计了两电极为圆柱对称形,每一个圆柱由内部一个电极和外部六个电极构成,如图2所示。在内电极上面安装靶材,激光辐照此靶材上面进行放电等离子体实验,此装置具有增强光谱纯度、提高转换效率、较少碎屑和产生高能量密度的极紫外等离子体等优点。另一个为德国Xtreme公司于2008年设计比较先进的激光辅助放电等离子体实验装置,如图3所示。采用旋转的圆盘作为正负电极,其中电极一部分被浸入到液体锡池中。圆盘旋转时,电极表面重新附着上了液体锡保证下一发脉冲作用于新靶材,同时电极上过高的热量被液体锡吸收,对电极起到冷却作用,降低了电极的热负荷。Tobin [10] 和Erik Wagenaars等人 [11] 用此电极装置进行实验获得了极紫外光源辐射。总之不同靶材形状具有各自的优点,获得的极紫外光源强度无法进行对比,因此不能判断哪种形状最好,但是可以为国内进行相关工作的研究者提供参考。
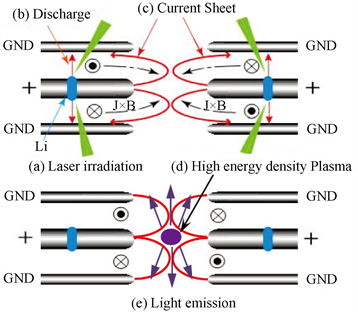
Figure 2. Cylindrical symmetrical discharge electrode device diagram
图2. 圆柱对称放电电极装置图
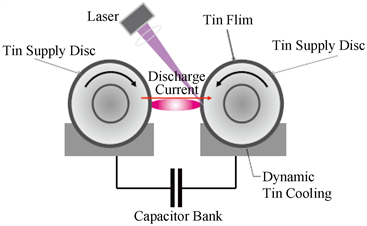
Figure 3. Rotating disk vacuum discharge electrode device diagram
图3. 旋转圆盘真空放电电极装置图
3. 电流上升时间对LDP极紫外光源的影响
在激光辅助放电等离子体极紫外光源实验中,提高极紫外输出功率一直是极紫外光刻技术的研究重点,研究的主要内容集中在电流上升时间对极紫外光源的影响。
为了提高极紫外输出功率,增加放电电流是一种方法,但是高脉冲电流产生很高的电磁场,会对其他低压设备造成干扰或者直接损坏,因此人们往往研究放电电流上升时间对极紫外辐射的影响。2012年,陆鹏等人研究了脉冲电流的上升时间对气体氙箍缩等离子体极紫外光源的影响 [12] 。对比了上升时间为43 ns和55 ns超短脉宽电流下放电放电产生极紫外光源,得到了上升时间为43 ns的脉冲电流产生的箍缩等离子体半径小且X-ray二极管测量所得极紫外辐射更强。2016年,Soowon Lim等人 [13] 研究了不同的电流上升时间对放电锡等离子体极紫外光源的影响,结果表明,电流上升时间为30 ns情况下产生13.5 nm极紫外辐射强度要比上升时间为55 ns情况下强55%。并且电流上升时间为30 ns所产生的碎屑少,光源也比较稳定。上升时间快产生极紫外强度高的原因是有足够的时间来压缩等离子体和加热等离子,进而可以产生较强的极紫外光源。Girum A. Beyene等人 [14] 分别用纳秒和皮秒脉冲激光辅助放电产生锡等离子体来获得13.5 nm EUV辐射,实验中获得了皮秒情况下产生的放电电流上升时间要快于纳秒情况,并且皮秒产生的极紫外转化效率为2.4%,远大于纳秒转换效率1.7%。除了上述原因外,另一个原因为皮秒脉冲激光作为触发放电产生等离子体的源,相比于纳秒脉冲激光来说,皮秒脉冲激光可以提前使放电电极击穿,能够更进一步压缩和加热等离子体。
4. 脉冲激光参数对LDP极紫外光源的影响
放电参数影响着极紫外光源的输出功率,但是激光参数对优化极紫外光源起着重要的作用。2011年,朱秋实等人研究激光辅助放电Z箍缩锡等离子体极紫外光源,研究结果表明,通过改变激光能量,随着激光能量的增加极紫外光源辐射先增强后减少,激光能量为77 mJ时产生的极紫外光源辐射最强 [15] 。2016年,G. A. Beyene等人 [14] 的研究也得到上述的趋势,在激光能量为43 mJ时产生的极紫外光源辐射最强。引起这种现象的原因是能量能量大时产生的自吸收效应较大,另外,激光能量大时,脉冲电流产生的磁压强很难压缩和加热等离子体,因此产生的极紫外光源减少。国外对激光辅助放电等离子体实验进行的较多,目前为止,国内只有哈尔滨工业大学展开了相关的实验。2014年,哈尔滨工业大学的李小强等人 [16] 构建了激光辅助放电等离子体极紫外光刻光源的实验装置,用罗兰圆光谱仪获得了锡等离子体13.5 nm极紫外辐射输出。同时,研究了激光与主脉冲电流延时和激光能量分别对锡等离子体极紫外辐射输出的影响,得到激光脉冲与主脉冲电流延时时间500 ns~3500 ns之间可以得到极紫外辐射光谱,且延时时间大约在2500 ns时极紫外辐射强度会达到峰值,大于或小于2500 ns时极紫外辐射强度都会减弱。另外得到当激光能量小于20 mJ时,光谱强度与激光能量成正比,激光能量大于20 mJ时,光谱强度与激光能量无关的结果。
除了纳秒之外,研究人员也用皮秒脉冲作为放电产生等离子体的触发源,相比于纳秒脉冲来说,皮秒具有脉冲持续时间较短的优势,其激光辐照靶材所对应的强度要高于纳秒激光,有利于产生极紫外光源。2005年,Moorti, A.等人 [17] 分别用脉冲持续时间为4 ns和27 ps脉冲激光进行辅助放电产生等离子体。得到27 ps脉冲激光辅助产生箍缩等离子体极紫外光源所需激光能量为5 mJ,而4 ns激光情况下所需要激光能量要大于250 mJ。原因为箍缩等离子体的产生需要最小的离子线密度,离子线密度与烧蚀质量成正比,同时烧蚀质量随着烧蚀靶材的激光强度增加而增加,所以皮秒激光需要的能量较少些。2016年,Girum A. Beyene等人 [14] 分别用7 ns和170 ps脉冲激光进行激光辅助放电产生等离子体来获得EUV辐射。相同实验条件下,模拟结果表明皮秒激光产生等离子体的电子温度(Te)、轴向速度(V)、电导率(σ)和平均价态数(Z)均要高于纳秒情况。高电导率可以增加等离子体和电能的耦合率进而增加了极紫外辐射效率。另外,皮秒产生等离子体的不透明度少于纳秒,即自吸收效应小,因此其产生的极紫外强度高。实验结果也证明了上面的情况,相对于纳秒情况,皮秒脉冲激光所产生的极紫外光谱窄、辐射强度和转换效率较高。
上面所述的研究人员用单脉冲作为触发源,但是Harald Verbraak [18] 和Yusuke Teramoto等人 [19] 分别利用双脉冲作为触发源进行激光辅助放电等离子体实验,结果表明此方法可以减少碎屑的产生,增加了极紫外收集器件的寿命。此外,后者的实验结果又表明双脉冲情况下产生的极紫外强度要比单脉冲作为触发源增强了60%。
5. 结论
本文论述了靶材作为不同放电电极、放电参数和激光参数情况下极紫外光源的产生,讨论了近年来激光辅助放电等离子体的最新研究进展。可以看出,靶材作为阴极更有利于箍缩等离子和极紫外光源的产生。放电电流的上升时间越快,产生的极紫外光源辐射强度越高。激光参数对优化极紫外光源具有重要的作用,能量小产生的烧蚀物质少,但是能量大时,自吸收效率大,都不利于极紫外光源的产生,只有在能量到达某个值时能够和电能很好的耦合产生较强的极紫外光源。皮秒具有脉冲持续时间较短的优势,其激光辐照靶材所对应的强度要高于纳秒激光,有利于产生极紫外光源。双脉冲作为辅助源时,可以减少碎屑的产生,并且能够增强极紫外光源的辐射。希望上述论述能够对相关的研究人们提供帮助。
文章引用
吴家志,谢 卓,窦银萍,林景全. 激光辅助放电等离子体极紫外光源研究进展
Research Progress of Laser Assisted Discharge Produce Plasma Extreme Ultraviolet Source[J]. 应用物理, 2019, 09(01): 1-6. https://doi.org/10.12677/APP.2019.91001
参考文献
- 1. Yusuke, T., Takuma, Y., Hideyuki, U. and Kazuaki, H. (2011) Sn Film and Ignition Control for Performance Enhancement of Laser-Triggered DPP Source. Proceedings of SPIE, 997-1005.
- 2. Schriever, G., Semprez, O., Jonkers, J., Yoshioka, M. and Apetz, R. (2012) Laser Produced Plasma versus Laser Assisted Discharge Plasma: Physics and Technology of Extreme Ultraviolet Lithography Light Sources. Journal of Micro/Nanolithography, MEMS, and MOEMS, 11, Article ID: 021104. https://doi.org/10.1117/1.JMM.11.2.021104
- 3. Kieft, E.R., van der Mullen, J.J.A.M. and Kroesen, G.M.W. (2003) Time-Resolved Pinhole Camera Imaging and Extreme Ultraviolet Spectrometry on a Hollow Cathode Dis-charge in Xenon. Physical Review E, 68, Article ID: 056403. https://doi.org/10.1103/PhysRevE.68.056403
- 4. Fomenkov, I.V., B¨owering, N., Rettig, C.L., Melnychuk, S.T. and Oliver, I.R. (2004) EUV Discharge Light Source Based on a Dense Plasma Focus Operated with Positive and Negative Polarity. Journal of Physics D: Applied Physics, 37, 3266-3276. https://doi.org/10.1088/0022-3727/37/23/007
- 5. Juschkin, L., Chuvatin, A., Zakharov, S.V., Ellwi, S. and Kunze, H-J. (2002) EUV Emission from Kr and Xe Capillary Discharge Plasmas. Journal of Physics D: Applied Physics, 35, 219-227. https://doi.org/10.1088/0022-3727/35/3/309
- 6. Pinnekamp, F., Himmel, G. and Bergstedt, K. (1974) Triggering of a Spark Gap with a Low-Power Laser. Optics Communications, 11, 3. https://doi.org/10.1016/0030-4018(74)90167-9
- 7. Stallings, C. (1979) Imploding Argon Plasma Experiments. Applied Physics Letters, 35, 524. https://doi.org/10.1063/1.91195
- 8. Hussey, T.W., Matzen, M.K. and Roderick, N.F. (1986) Domain Wall Pinning at Planar Defects. Journal of Applied Physics, 58, 2677. https://doi.org/10.1063/1.336974
- 9. Qiushi, Z. (2012) Plasma Dynamics in a 13.5 nm Laser-Assisted Discharge Plasma Extreme Ultraviolet Source. Ph.D. Thesis, Tokyo Institute of Technology, To-kyo.
- 10. Tatsuya, S., Shintaro, K., Hajime, K., Tomoaki, K., Shotaro, K. and Kazuhiko, H. (2017) Laser-Assisted Counter-Facing Plasma Focus Device as a Light Source for EUV Lithography. IEEE Transactions on Plasma Science, 45, 836-842. https://doi.org/10.1109/TPS.2017.2680434
- 11. Tobin, I., Juschkin, L., Sidelnikov, Y., O’Reilly, F., Sheridan, P., Sokell, E. and Lunney, J.G. (2013) Laser Triggered Z-Pinch Broadband Extreme Ultraviolet Source for Metrology. Applied Physics Letters, 102, 3978. https://doi.org/10.1063/1.4807172
- 12. Erik, W., Felix, K., Jürgen, K., Willi, N., Marcel, D., van der Wel, P., Dominik, V. and Jeroen J. (2008) Power Scaling of an Extreme Ultraviolet Light Source for Future Lithography. Applied Physics Letter, 92, Article ID: 181501.
- 13. Peng, L., Watanabe, T., Katsuki, S., Sakugawa, T. and Akiyama, H. (2012) Effect of Current Pulse Width on Xenon Z-Pinch Discharge Plasma for Extreme Ultraviolet Source. 2012 IEEE International Power Modulator and High Voltage Conference, San Diego, 3-7 June 2012, 140-143.
- 14. Lim, S., Kamohara, T., Hosseini, S.H.R. and Katsuki, S. (2016) Dependence of Current Rise Time on Laser-Triggered Discharge Plasma. Journal of Physics D: Applied Physics, 49, Article ID: 295207. https://doi.org/10.1088/0022-3727/49/29/295207
- 15. Beyene, G.A., Tobin, I., Juschkin, L., et al. (2016) Laser-Assisted Vacuum Arc Extreme Ultraviolet Source: A Comparison of Picosecond and Nanosecond Laser Triggering. Journal of Physics D: Applied Physics, 49, Article ID: 225201. https://doi.org/10.1088/0022-3727/49/22/225201
- 16. Qiushi, Z., Yamada, J., Kishi, N., Watanabe, M., Okino, A., Horioka, K. and Hotta, E. (2011) Investigation of the Dynamics of the Z-Pinch Imploding Plasma for a Laser-Assisted Discharge-Produced Sn Plasma EUV Source. Journal of Physics D: Applied Physics, 44, Article ID: 145203.
- 17. 李小强. 激光辅助放电Sn等离子体13.5 nm极紫外辐射研究[D]: [博士学位论文]. 哈尔滨: 哈尔滨工业大学, 2014.
- 18. Moorti, A., Kumbhare, S.R., Naik, P.A., Gupta, P.D., Romanov, I.V., Korobkin, Yu.V., Rupasov, A.A. and Shikanov, A.S. (2005) Charac-teristics of Moderate Current Vacuum Discharge Triggered by Multipicosecond and Nanosecond Duration Laser Pulses. Journal of Applied Physics, 97, Article ID: 044303. https://doi.org/10.1063/1.1848189
- 19. Verbraak, H., Kupper, F., Jonkers, J. and Bergmann, K. (2010) Angular Ion Emission Characteristics of a Laser Triggered Tin Vacuum Arc as Light Source for Extreme Ul-traviolet Lithography. Journal of Applied Physics, 108, Article ID: 093304. https://doi.org/10.1063/1.3499611
NOTES
*通讯作者。