Computer Science and Application
Vol.4 No.07(2014), Article
ID:13885,9
pages
DOI:10.12677/CSA.2014.47019
The Parametric Model and Simulation Analysis of IGBT
Academy of Physics and Electronics, Henan University, Kaifeng
Email: gengtao@henu.edu.cn
Copyright © 2014 by authors and Hans Publishers Inc.
This work is licensed under the Creative Commons Attribution International License (CC BY).
http://creativecommons.org/licenses/by/4.0/



Received: Jun. 4th, 2014; revised: Jul. 1st, 2014; accepted: Jul. 11th, 2014
ABSTRACT
In this paper, based on the analysis of the structure and work principle and characteristics of IGBT, the simplified model of IGBT by matlab/simulink is built. The problems of the IGBT failure are analyzed theoretically from the perspectives of IGBT failure factors and failure mechanism, respectively. According to simulation results, it was verified that IGBT is subjected to constant electric shocks due to work environment, etc., then, module internal bonding wire begins to creep and fatigue cracks occur, which eventually lead to failure. Thus, the model can be used to predict the lifetime of the IGBT.
Keywords:IGBT Module, Fault Detection, Lifetime, Reliability

IGBT参数建模与仿真分析
耿 涛,曹文明
河南大学物理与电子学院,开封
Email: gengtao@henu.edu.cn
收稿日期:2014年6月4日;修回日期:2014年7月1日;录用日期:2014年7月11日

摘 要
本论文首先在对IGBT的结构,工作原理以及特性进行深入分析的基础上,利用matlab/simulink软件搭建IGBT的简化模型;其次对IGBT失效问题进行理论分析,分别从IGBT失效因素,失效机理等方面进行深入分析、总结与探讨;再次根据仿真结果验证由于IGBT工作环境等因素影响使其不断受到电热冲击,导致模块内部键合线发生蠕动,芯片内部产生疲劳裂痕,最终导致失效的结论,从而建立起能够预测IGBT寿命的模型。
关键词
绝缘栅型晶体管(IGBT),故障检测,寿命,可靠性

1. 引言
自从上世纪80年代绝缘栅双极性集体管(IGBT)问世以来,其逐步取代了功率集体管,晶闸管和功率MOSFET,在中频,中功率电力电子电路中得到广泛应用[1] [2] 。正是由于IGBT的广泛使用与缺点,人们对其可靠性,可维护性的要求也越来越高。在电力电子设备中,IGBT的工作环境急剧变化,或者长时间经受电热压力等因素会导致老化,使器件失效而产生故障。一旦故障发生,轻则造成设备严重破坏,重则产生灾难性事故。因此对IGBT可靠性研究一直是个热门的研究课题。近些年来,国内外诸多学者一直在研究可以一套预测IGBT寿命的方法。
然而由于IGBT失效是一个比较复杂的问题,现在正处在认识不断深化阶段,所以定量问题研究方面,国内外对此研究很少。国内外学者对于这个问题的研究分两个方向:一是对IGBT模块进行功率循环或者电热循环,人工加速老化过程模拟热疲劳实验,然后不断检测IGBT模块的输出变量,计算输出变化是否超过一定范围或者对IGBT模块进行无伤探测扫描成像,对图像进行观察焊锡材料发生裂痕,铝键合线脱落或者焊锡层发生金属化重结晶的状况来判定器件老化的程度;二是根据IGBT等功率器件寿命依赖于温度参数,如温度变化范围,持续时间,平均值等,采用统计计数法提取温度幅值循环次数和均值循环次数,然后依据相关损伤累计理论建立寿命预测模型,据此推断器件损伤度与寿命[3] -[5] 。
基于上述,论文将首先根据IGBT器件工作原理,和工作特性建立IGBT的半解析模型,之后验证其正确性;然后通过改变其内部某些参数,来模拟IGBT发生老化程度,将其反映到IGBT的外部信号输出上;最后根据IGBT实际工作中的输出特性,反过来推断IGBT的失效程度;期望依此可以建立起IGBT寿命模型,进而可以达到预测其健康状况,估计剩余使用寿命,方便功率器件管理的目的。
2. IGBT硅参数模型及仿真分析
IGBT工作时不断承受功率循环与电热循环,过电压,过电流等;这些原因将诱发器件内部结构的变化。而这些结构的变化与IGBT模块承受的温度密切相关。本章将详细分析温度变化对器件禁带宽度,本征载流子,双核扩散系数等物理参数的影响,揭示IGBT开关速度减慢、通态压降、漏电流增大,阈值电压突变,擎住效应等容易导致IGBT器件失效的电气现象的物理机理。
2.1. IGBT硅参数模型
首先研究总结半导体关键参数关于温度的模型,并对此进行理论分析,在此基础上详细分析影响IGBT失效因素和IGBT电气参数失效的物理机制。
2.1.1. 热导率
在半导体材料中,若存在温度梯度![]() ,便有热流,热流密度正比于温度梯度,即
,便有热流,热流密度正比于温度梯度,即
 (1)
(1)
式中,比例系数称为热导率。
半导体的热传导是通过载流子的运动和晶格的热振动实现的。晶格导热是依靠晶格振动产生“格波”,格波在晶体中传播,将热量从高温端带到低温端。在复合半导体中,晶格导热比载流子运动导热的贡献大得多,热传导![]() 与温度有关系,因为“格波”在传播过程中药受到散射,该散射可以看作是吸收或者碰撞的过程,通过这种“格波”之间的散射交换能量,在半导体中实现热传导。热传导率越大,说明在相同温度梯度下,传导的热量越多,热传导率的计算表达式:
与温度有关系,因为“格波”在传播过程中药受到散射,该散射可以看作是吸收或者碰撞的过程,通过这种“格波”之间的散射交换能量,在半导体中实现热传导。热传导率越大,说明在相同温度梯度下,传导的热量越多,热传导率的计算表达式:
 (2)
(2)
2.1.2. 载流子寿命
载流子寿命是指移去产生过剩电子、空穴对的外部激励后,过剩载流子浓度恢复到平衡态时所用的时间。IGBT的暂态和稳定性在很大程度上受到漂移区的载流子寿命的影响。并且IGBT的漂移区一般工作在大注入条件下。载流子有效寿命为电子和空穴少子寿命之和。模型考虑到本征载流子寿命,SRH复合及其原子间歇过程,假设在大注入和准中性 的条件下,得到的有效载流子寿命为[1] :
的条件下,得到的有效载流子寿命为[1] :
 (3)
(3)
而在较高温度的情况下,载流子寿命模型只是温度的函数。
对于低掺杂基区![]() ,对上式简化得到载流子寿命为:
,对上式简化得到载流子寿命为:
 (4)
(4)
其中, 为
为![]() 时载流子寿命,载流子在
时载流子寿命,载流子在![]() 时的经验值为2.5。
时的经验值为2.5。
2.1.3. 本征载流子浓度
在本征半导体中,导电电子和空穴对仅能通过价键破裂而产生,电子和空穴成对生成,因此,电子的浓度等于空穴浓度,这个浓度成为半导体的本征载流子浓度 ;其是晶格振动能量的函数,故而也是温度的函数,它和温度、禁带宽度有关系,理论表达式为:
;其是晶格振动能量的函数,故而也是温度的函数,它和温度、禁带宽度有关系,理论表达式为:
 (5)
(5)
式中: 、
、 分别是电子和空穴的有效质量。
分别是电子和空穴的有效质量。
2.1.4. 载流子迁移率
载流子迁移率定义为单位电场强度时载流子的速度[3] 。载流子迁移率受掺杂类型和掺杂浓度影响最大,半导体功率器件的通态压降和开关特性受电子空穴迁移率影响很大。
载流子的迁移率是由载流子的散射机制决定,载流子散射分为电离杂质散射和晶格(声子)散射两种,对电离杂质散射而言,温度越高,载流子的平均热运动速度越大,载流子经过电离杂质时,在其附近停留的时间越多,离子的散射作用越弱,即电离杂质散射的相关迁移率随温度升高而增大;对晶格(声子)散射来说,温度越高,声子浓度越大,散射越强,迁移率越小。这两种载流子同时作用于载流子,在较低温度下,电离杂质散射主导;在较高温度下,声子散射主导。电子迁移率计算表达式为[6] :
 (6)
(6)
空穴迁移率表达式:
 (7)
(7)
高温时,载流子迁移率的计算表达式可以简化为[7] :
 (8)
(8)
 (9)
(9)
2.1.5. 双极扩散系数
载流子的扩散系数与迁移率满足爱因斯坦关系式[8] 。
双极扩散系数计算表达式为
 (10)
(10)
式中 、
、 分别为电子扩散系数和空穴扩散系数,由下式计算:
分别为电子扩散系数和空穴扩散系数,由下式计算:
 (11)
(11)
 (12)
(12)
把上述式子(8),(9),(11),(12)带入公式,可以得到高温时双极扩散系数表达式[9]
 (13)
(13)
式中: 为硅玻尔兹曼常数
为硅玻尔兹曼常数![]() ,
,![]() 为电子电荷
为电子电荷![]() 。
。
2.2. IGBT硅参数的仿真
IGBT的失效因素与硅参数有着密切关系,而二者均会受到温度的影响。以下是在matlab中对上述几个参数进行编程和仿真的效果图。
图1是其热导率随温度变化的情况,可以热导率随着温度的升高而降低。
本征载流子浓度随温度变化情况入图2所示,可以看出随着温度升高本征载流子浓度上升,尤其是450 K时,其上升速率急剧增加。
载流子寿命随温度变化的情况如图3所示,随着温度的上升,IGBT内部载流子寿命会变长,且其受温度变化的影响较大。
空穴和电子迁移率随温度变化的情况分别如图4(a),(b)所示,显然由图知,随着温度增加,空穴、

Figure 1. Relationship between thermal conductivity and temperature
图1. 热导率与温度关系图

Figure 2. The intrinsic carrier concentration and temperature
图2. 本征载流子浓度与温度关系图

Figure 3. The relationship between the carrier lifetime and temperature
图3. 载流子寿命与温度关系图
 (a)
(a) (b)
(b)
Figure 4. (a) The hole mobility and relationship, (b) The electron transfer rate and temperature
图4. (a) 空穴迁移率与关系图 (b) 电子迁移率与温度关系图
电子迁移率将降低。
图5是IGBT双极扩散系数随温度变化的情况,可以看出双极扩散系数基本不随温度变化,所以老化过程中可以忽略该因素引起的失效问题。
由图1知随着温度的增加,可以看出热导率会下降,尤其是高温下,IGBT的传导率会明显下降,因此高温下IGBT极易因为热击穿而失效;由图2知温度小于450 K时,对于载流子浓度的影响极其微小;但是温度高于450 K时载流子浓度呈指数上升,因此实际使用过程中载流子浓度对IGBT的电特性影响较微小;由图3知载流子寿命对温度很敏感,温度越高,载流子寿命越长,导致IGBT关断拖尾时间变长,进而导致功耗增加;由图4知,随着温度的增加,电子和空穴迁移率会下降,而且温度对电子迁移率的影响比对空穴迁移率的影响大。迁移率的下降使得IGBT关断时间变长,功率器件的饱和导通压降增大,使得IGBT功率增大而失效。
3. IGBT失效因素及仿真
当功率器件工作在功率循环或者电热循环时,会处于高温状态,可能发生热失效,而功率半导体的电流,电压与温度之间有着密切的联系,因此从温度对IGBT外参数的影响来研究IGBT的失效机理。

Figure 5. The relationship between the ambipolar diffusion coefficient and temperature
图5. 双极扩散系数与温度的关系图
3.1. 通态压降
在IGBT的栅极加大的正向偏压时,在MOSFET栅极下面的沟道形成的反型层具有很高的电导率,此时正向电流对栅极偏压反应不再敏感[4] 。在大注入的水平,阳极电流的表达式为:
 (14)
(14)
当集电极电流增大时,正态压降随电流增加而迅速增加,这时因为载流子-载流子散射使得大注入下双极扩散长度减小,另一个导致正态压降增加的因素是大电流下阳极注入效率的降低。IGBT的总通态压降可以等效为P-I-N二极管压降和MOS管沟道电压之和。其中P-I-N二极管压降的表达式为:
 (15)
(15)
式中![]() 为流经IGBT的总电流,
为流经IGBT的总电流, 为准中性基区有效电子浓度,
为准中性基区有效电子浓度,![]() 为内部晶体管发射机边缘处的载流子浓度。该电压降随温度变化的情况如图6所示,可以看出随着温度的增加,PIN二极管压降会增大。
为内部晶体管发射机边缘处的载流子浓度。该电压降随温度变化的情况如图6所示,可以看出随着温度的增加,PIN二极管压降会增大。
MOS管的沟道压降表达式为:
 (16)
(16)
式中 ,
,![]() 表示通过MOS的沟道电流;其中
表示通过MOS的沟道电流;其中 表示MOS管的跨导,
表示MOS管的跨导, 表示IGBT的阈值电压,
表示IGBT的阈值电压, 表示栅源极所加偏压。
表示栅源极所加偏压。
3.2. 漏电流
IGBT的漏电流来源于PN结耗尽层空间电荷产生的电流及中性基区扩散电流的结合。漏电流表达式为[10]
 (17)
(17)
式中![]() 为PN结中耗尽层的宽度,其表达式如下
为PN结中耗尽层的宽度,其表达式如下
 (18)
(18)
 为硅的相对介电常数,
为硅的相对介电常数, 为基极集电极电压。
为基极集电极电压。
漏电流很可能诱发IGBT击穿和发生擎住效应,是导致IGBT失效的主要原因之一。与其它半导体器件一样,IGBT的漏电流随温度的升高而增大,在室温条件下,空间电荷产生的电流其主要决定作用,而高温时扩散电流起主导作用。由漏电流表达式可知:随着温度的增加,漏电流将会增强,而漏电流的增加又会导致结温的增加,进一步加剧漏电流的增加,从而导致IGBT击穿和发生擎住效应。
3.3. 阈值电压
因为IGBT相当于一个由MOSFET驱动的厚基区PNP晶体管,而MOSFET的阈值电压表达式为[4]
 ; (19)
; (19)
式中:![]() 表示电子电量,
表示电子电量, 为玻尔兹曼系数,
为玻尔兹曼系数,![]() 为真空介电常数,
为真空介电常数, 为硅的相对介电常数,取11.7,
为硅的相对介电常数,取11.7,
 ,
,![]() 为栅极氧化层厚度,
为栅极氧化层厚度,![]() 为基区掺杂浓度,取
为基区掺杂浓度,取 。由于受温度变化的参数为
。由于受温度变化的参数为
本征载流子浓度 ,故可以得出随温度变化时阈值电压的变化情况。如下图7所示,阈值电压随温度升高而降低。
,故可以得出随温度变化时阈值电压的变化情况。如下图7所示,阈值电压随温度升高而降低。

Figure 6. The pressure drop of PIN variation with temperature
图6. PIN压降随温度变化的仿真结果
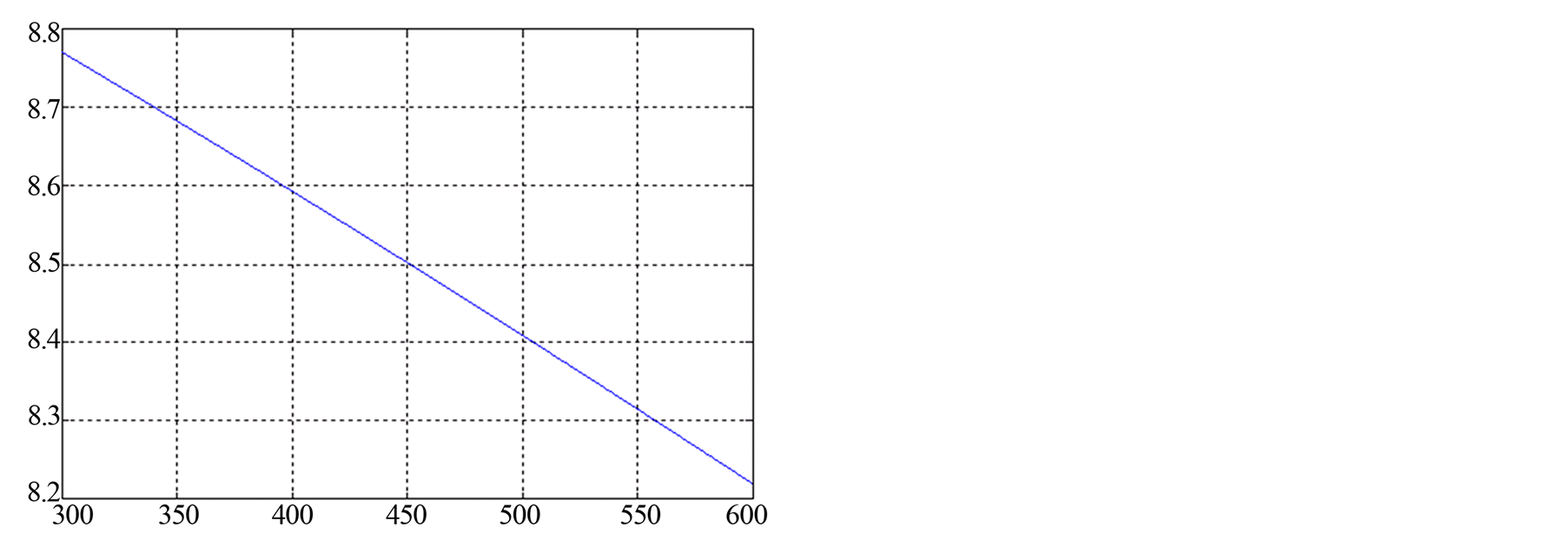
Figure 7. Variation of threshold voltage with temperature
图7. 阈值电压随温度变化的仿真结果
随着温度的增加,本征载流子浓度变大,导致IGBT的阈值电压下降。由于MOS的阈值电压的漂移,在高电压、大电流和高温的情况下,可能会使IGBT出现误导通,从而导致IGBT失效。
3.4. 擎住电流
由于影响IGBT发生静态擎住效应的主要因素是IGBT中PNP、NPN共基极电流增益 的变化,其计算表达式为[11]
的变化,其计算表达式为[11]

PNP、NPN共射极电流增益与共基极电流增益的关系为
 (20)
(20)
IGBT一旦发生擎住效应,器件失控,集电极电流很大,造成过高的功率损耗从而导致器件损坏。发生擎住效应必须具备两个条件:
1) 触发电流即漏电流 在
在 阱区横向电阻
阱区横向电阻 上的压降大于NPN管的发射结正向导通压降,即
上的压降大于NPN管的发射结正向导通压降,即
 (21)
(21)
2) 为保证正反馈,应满足
 (22)
(22)
由于 ,
, ,可以(22)条件可以变为
,可以(22)条件可以变为 。
。
基于上述,知擎住效应的发生与晶体管的共射极电流放大系数 ,
, 阱区电阻
阱区电阻 及IGBT的关断速度有关。当温度上升时,晶体管的电流放大系数增大,载流子迁移率降低,各寄生电阻(包括
及IGBT的关断速度有关。当温度上升时,晶体管的电流放大系数增大,载流子迁移率降低,各寄生电阻(包括 )增大,将加大IGBT发生擎住效应的危险。
)增大,将加大IGBT发生擎住效应的危险。
共射极电流放大系数 随温度变化的情况如下图8所示。随着温度上升,共射极电流放大系数随温度增加而增加;这样发生擎住效应的所需的电流会减小;同时温度升高会使IGBT内部的寄生晶体管发射结分流电阻增大,同样也使擎住电流减小。故而随着温度的升高,发生擎住效应的可能性越大,之后IGBT栅极电压失去控制导致其烧毁。
随温度变化的情况如下图8所示。随着温度上升,共射极电流放大系数随温度增加而增加;这样发生擎住效应的所需的电流会减小;同时温度升高会使IGBT内部的寄生晶体管发射结分流电阻增大,同样也使擎住电流减小。故而随着温度的升高,发生擎住效应的可能性越大,之后IGBT栅极电压失去控制导致其烧毁。

Figure 8. Common emitter current gain variation with temperature
图8. 共射极电流放大倍数随温度变化情况
3.5. 开关速度
IGBT的关断电流分为突然下降和缓慢衰减两个部分。第一阶段对应于MOSFET的关断过程,随着栅极电压下降,MOSFET的沟道消失,因为MOSFET的沟道电流时IGBT集电极电流 的主要部分,所以这段时间
的主要部分,所以这段时间 下降较快;第二段由BJT的存储电荷决定,因为在第一阶段结尾,MOSFET已关断,IGBT又无反向电压,
下降较快;第二段由BJT的存储电荷决定,因为在第一阶段结尾,MOSFET已关断,IGBT又无反向电压,![]() 基区中剩余载流子复合缓慢,所以这段时间内
基区中剩余载流子复合缓慢,所以这段时间内 下降较慢。
下降较慢。
由上述论述可知,BJT的共射极电流增益 决定了IGBT关断的第一阶段
决定了IGBT关断的第一阶段 的下降幅度;剩余载流子的寿命决定了IGBT关断的第二阶段
的下降幅度;剩余载流子的寿命决定了IGBT关断的第二阶段 的下降速率,即BJT的电流增益
的下降速率,即BJT的电流增益 和剩余载流子的寿命
和剩余载流子的寿命 对IGBT的关断速度影响显著。
对IGBT的关断速度影响显著。
IGBT集电极电流的上升速率是其开通速度的一个重要表征。MOSFET的跨导系数 对集电极电流的上升速率有明显影响。由于MOSFET的跨导系数与载流子的迁移率呈正相关,即MOSFET的跨导系数随温度的上升而减小。跨导系数表达式为:
对集电极电流的上升速率有明显影响。由于MOSFET的跨导系数与载流子的迁移率呈正相关,即MOSFET的跨导系数随温度的上升而减小。跨导系数表达式为:
 (23)
(23)
式中: ,
, 表示绝对温度为300 K时MOSFET的跨导。由上式随着温度升高,跨导系数减少,集电极电流上升速度变慢,IGBT的开通速度越慢。
表示绝对温度为300 K时MOSFET的跨导。由上式随着温度升高,跨导系数减少,集电极电流上升速度变慢,IGBT的开通速度越慢。
4. 结论
论文介绍了IGBT器件的基本结构,工作原理及基本特性,推导总结了本征载流子浓度、载流子寿命、载流子迁移率及双极扩散系数等物理参数的温度特性,建立了IGBT器件物理参数与电气参数间的对应关系,在此基础上,详细分析IGBT通态压降、漏电流,阈值电压以及发生擎住效应等电气现象的物理机理。
参考文献 (References)
- 陈永淑 (2010) IGBT的可靠性模型研究. 硕士学位论文, 重庆大学, 重庆.
- 王兆安 (2009) 电力电子技术. 机械工业出版社, 西安, 27-36.
- Patil, N., Das, D., Goebel, K. and Pecht, M. (2009) Precursor parameter identification for insulated gate bipolar transistor prognostics. IEEE Transactions on Industrial Electronics, 58, 271-276.
- Zhou, L.W. and Zhou, S.Q. (2010) Effects of wire-bond lift-off on gate circuit of IGBT power modules. 14th International Power Electronics and Motion Control Conference, Ohrid, 6-8 September 2010, 45-47.
- Khong, B., Legros, M., Tounsi, P., Dupuy, Ph., Chauffeur, X., Levade, C., Vanderschaeve, G. and Scheid, E. (2007) Characterization and modeling of ageing failures on power MOSFET devices. Microelectronics Reliability, 47, 1735-1740.
- Patil, N., Das, D., Goebel, K. and Pecht, M. (2008) Identification of failure precursor parameters for Insulated Gate Bipolar Transistors (IGBTs). Proceeding of the 1st International Conference on Prognostic and Health Management, Denver, 6-9 October 2008, 1-5.
- Xiong, Y.L., Cheng, X., Shen, J. and Mi, C. (2008) Prognostic and warming system for power-electronic modules in electric, hybrid electric, and fuel-cell vehicles. IEEE Transactions on Industrial Electronics, 55, 2268-2276.
- Rodríguez-Blanco, M.A., Claudio-Sánchez, A., Theilliol, D. and Vela-Valdés, L.G. (2001) A failure-detection strategy for IGBT based on gate-voltage behavior applied to the motor drive system. IEEE Transactions on Industrial Electronics, 58, 1625-1633.
- Lu, H., Bailey, C. and Yin, C.Y. (2009) Design for reliability of power electronics modules. Microelectronics Reliability, 49, 1250-1255.
- Hefener, A.R. (2002) Analytical modeling of device-circuit interactions for power insulated gate bipolar transistor (IGBT). IEEE Transactions on Industry Application, 26, 995-1005.
- Jacob, P., Held, M., Scacco, P. and Wu, W. (1995) Reliabilty testing and analysis of IGBT power semiconductor modules. IEE Colloquium on IGBT Propulsion Drives, London, 25 April 1995, 440-445.