Applied Physics
Vol.08 No.01(2018), Article ID:23615,17
pages
10.12677/APP.2018.81007
Research Progress of 2 - 5 μm Mid-Infrared GaSb Semiconductor Materials
Pei Yu, Dan Fang*, Jilong Tang, Xuan Fang, Dengkui Wang, Xinwei Wang, Xiaohua Wang, Zhipeng Wei
State Key Laboratory of High Power Semiconductor Laser, Changchun University of Science and Technology, Changchun Jilin

Received: Jan. 6th, 2018; accepted: Jan. 23rd, 2018; published: Jan. 30th, 2018

ABSTRACT
III-V group semiconductors have received a great deal of attention because of their potential advantages for use in optoelectronic and electronic applications. Among these materials, with characteristics that include high carrier mobility and a narrow band gap, gallium antimonide (GaSb) and GaSb-related semiconductors have been recognized as most suitable candidates for high-per- formance optoelectronics in the mid-infrared range. The performance of semiconductor devices, however, strongly dependent on the structure and optical properties of materials, so the GaSb materials research focus is to improve the quality of crystal, adjust the alloy composition, improve the luminous performance, etc. In this paper, the progress of epitaxial growth and material properties of 2 - 5 μm GaSb and GaSb-related semiconductor materials are briefly reviewed. The epitaxial growth processes and material properties of GaSb, GaSb related alloy materials and GaSb- based quantum well materials are discussed in order to obtain the optimal conditions for epitaxial growth of GaSb-based semiconductor materials.
Keywords:GaSb, Type-I Quantum Well, Type-W Quantum Well, MBE
2~5 μm中红外波段GaSb半导体材料研究进展
余沛,房丹*,唐吉龙,方铉,王登魁,王新伟,王晓华,魏志鹏
长春理工大学高功率半导体激光国家重点实验室,吉林 长春

收稿日期:2018年1月6日;录用日期:2018年1月23日;发布日期:2018年1月30日

摘 要
III-V族半导体材料因其光电子应用中的优势而备受关注。这些材料中,GaSb和GaSb相关半导体材料因具有高的载流子迁移率和较窄的禁带宽度而被认为是中红外波段光电子半导体器件的首选材料。然而,半导体光电子器件的性能强烈依赖于材料的结构和光学性质,所以GaSb材料的研究工作重点是如何提高晶体质量,精确调整合金组分,提高发光性能等。本文对2~5 μm GaSb和GaSb相关半导体材料的外延生长和材料性质的研究进展做出了简要的概述,主要讨论了GaSb材料、GaSb合金薄膜材料以及GaSb基量子阱材料的外延生长过程及材料性质,以期获得GaSb基半导体材料外延生长的最优条件。
关键词 :锑化镓,I型量子阱,W型量子阱,分子束外延

Copyright © 2018 by authors and Hans Publishers Inc.
This work is licensed under the Creative Commons Attribution International License (CC BY).
http://creativecommons.org/licenses/by/4.0/


1. 引言
2~5 μm中红外(MIR)光谱区域具有巨大的研究价值,因为在2~5 μm波长区域中工作的光电子器件在广泛的领域中具有潜在的应用,包括光学气体感测,环境监测,空间激光通信,红外对抗和热成像等 [1] [2] [3] 。因此,中红外半导体激光器件以其高吸收系数,高载流子迁移和广泛可调的带隙成为全球的研究重点 [4] 。III-V半导体材料是中红外半导体激光器和探测器的首选材料体系。在这些材料中,GaSb及GaSb基合金化合物可以提供广泛的电子带隙,带隙偏移以及极高的电子迁移率 [5] [6] 。因此,GaSb合金薄膜材料,GaSb基量子阱结构材料等GaSb半导体材料正在引起相当大的关注。另外,基于GaSb基半导体材料,已经实现了包括激光二极管,激光器和探测器在内的各种先进的光电子器件 [1] [4] 。
到目前为止,GaSb半导体材料的外延生长主要采用液相外延(LPE),金属有机化合物化学气相沉淀(MOCVD)和分子束外延(MBE)技术。在这些外延技术中,MBE通过改变材料组分来调节材料的能带,最适合用于制造MIR波段工作的发光二极管,激光器和探测器 [1] [5] [7] 。通过调整外延参数,可以实现具有高表面和界面质量的各种复合量子结构。然而,GaSb基半导体器件材料外延质量会直接影响器件性能,在材料外延生长过程中,晶格的失配、缺陷密度、应力等问题制约着中红外锑化物半导体器件的应用和发展。
在本文中,我们对GaSb和GaSb相关材料的外延生长和材料性质的研究进展做出了简要的概述,第一部分为GaSb合金薄膜材料的外延生长及材料性质研究,描述了GaSb合金薄膜材料的外延生长过程及材料性质的研究现状;第二部分为GaSb基量子阱材料的外延生长及材料性质研究,描述了GaSb基量子阱材料的外延生长过程及材料性质的研究现状。
2. GaSb基合金材料
锑化物的重要性被给予了大量的关锑化物半导体材料是指由III族元素Al、Ga、In和V族元素As、Sb所构成的含有锑元素的III-V族化合物半导体,如GaAsSb、InAsSb、InGaAsSb、AlGaAsSb等三元、四元合金。其中,GaSb是一种重要的III-V族化合物半导体,GaSb具有介于三元和四元III-V族化合物半导体材料之间的晶格常数(如图1所示),所以GaSb能够与很多III-V族锑化物材料实现晶格的完美匹配,有利于高质量锑化物材料的生长。并且GaSb与GaAs一样具有闪锌矿(ZB)结构,它的带隙比GaAs要小,其带隙在0 K时为0.822 eV,在300 K下为0.725 eV [8] [9] [10] ,因此,在中红外波段范围内的光电子材料应用方面GaSb材料优势明显。
液相外延(LPE)是GaSb材料外延生长中最早使用的方法,并且有许多关于通过LPE技术外延生长GaSb的报道。在GaSb外延层的表面形貌和光学性质的早期研究中,发现Ga在500℃~550℃的温度范围会产生具有优异表面形貌的高质量外延层 [11] 。虽然在低温下生长的外延层具有较低的天然缺陷浓度,但它们的表面形态差,因此不适合于器件应用 [12] 。Jakowetzet W [13] 等人报道了GaSb的CVD生长。GaSb的MOCVD生长也已经实现 [14] 。
目前,锑化物材料主要使用基于非热力学平衡的分子束外延(MBE)技术生长。近年来,随着非热力学平衡的发展,MBE被广泛用于制造高纯度单晶和超精细结构,从而大大增强了锑基材料和器件的研究进展。MBE是将原子束或分子束的单个或复杂组分推向加热衬底的技术,在超高真空条件下被吸收,迁移和沉积在衬底上 [15] 。
由于晶格常数的差异,为了提高外延薄膜的晶体质量,通常在外延膜和衬底之间生长一层缓冲层。InAs,AlSb和GaSb材料通常作为缓冲层的选择材料。在Noh [6] 等人报道中,GaAs(001)衬底在低温下外延生长了高质量的GaSb薄膜,并研究了不同缓冲层的GaSb薄膜的结构特性。他们的结果表明,AlSb或GaSb缓冲层对于提高GaAs衬底上生长的GaSb薄膜的质量非常有用。
作为GaSb材料的重要组成部分,多组分合金化合物是非常重要的。通过调整合金中的组分,可以在很宽范围内调节材料带隙和晶格常数。例如,通过理论计算,Wieder和Clawson [16] 确定了InAsxSb1-x材料在温度T下组分x与带隙的关系表达式,如下:
在GaSb基三元合金材料 [17] 中,GaAsxSb1-x以其波长可以在0.8 μm至1.7 μm的范围内进行调制,并且这样的波长带将使得其与InP和GaAs相比在光电器件应用方面具有更广泛的前景。Chou [18] 等人报道了衬底倾斜度对采用MBE在InP衬底外延生长的GaAsSb合金的材料性质的影响。厚度为1 μm的
GaAsSb合金在InP(100)和倾斜的InP衬底(2˚, 3˚, 4˚)上生长,并通过XRD表征。由较窄的X射线半高宽得知,衬底倾斜改善了GaAsSb合金结晶质量,其结果预期适用于采用MBE生长的器件的有源层。然而,虽然Sb可以用作表面活性剂,但是Sb元素的掺入会导致外延生长困难,例如出现组分分布不均匀的问
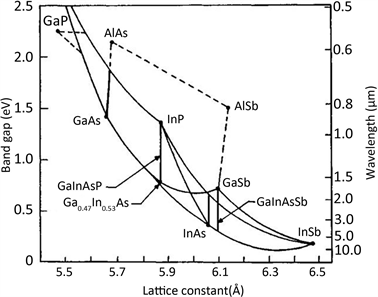
Figure 1. Band gap as a function of lattice constant for III-V compounds and their ternary and quaternary alloys
图1. III-V半导体化合物及其三元、四元合金的晶格常数与带隙的关系
题,因此,合金组分的调节更为重要。Wei [19] 小组报道了采用混合束流条件下生长的GaAsSb三元合金。GaAsSb合金样品的生长条件和Sb组分如表1所示。结果表明,局部态与GaAsSb合金中的Sb组分有关。然而,这也导致材料的晶体质量变差,GaAsSb合金的应用将受到质量恶化的限制。
与GaSb晶格匹配的InGaAsSb四元合金材料已经被广泛的研究,原因在于InGaAsSb四元合金材料是2~3 μm波段激光器器件有源区的重要组成部分 [20] 。在早期的工作中,Karouta [21] 等人总结了GaSb富集的InGaAsSb的直接带隙,他们提出了0.6 eV的弯曲系数。最近A. P. Craig [22] 等人报道了与GaSb的晶格匹配的In0.28Ga0.72As0.25Sb0.75外延层,并且在室温和250 K下获得2.9 μm和3.0 μm的发光波长。图2显示了4 K到300 K的光致发光结果以及在190 K到300 K的归一化光谱响应数据。其结果表明可以实现红外波段的短波探测器。
相比于InGaAsSb四元合金材料,与GaSb晶格匹配的AlGaAsSb四元合金材料也是非常重要的,其常用作于中红外半导体激光器的覆盖层以及波导层材料。Adachi [23] 通过理论计算得到了AlGaAsSb四元合金的直接带隙与间接带隙之间的关系,Ait-Kaci [24] 等人通过实验结果也总结得到了这个关系。对于AlGaAsSb四元合金材料来说,如何精确的确定其元素组分是一个难题,图3给出了与GaSb晶格匹配的AlxGa1−xAsySb1−y四元合金材料的组分x与其带隙能量的关系。
在最近的研究中,Jasik [25] 等报道了在无意掺入砷元素的背景下对MBE生长的AlGaAsSb外延层的组成成分的研究。基于他们获得的实验结果,提出了确定AlGaAsSb四元合金材料的化学成分的方法。表2给出了多个AlxGa1−xAsySb1−y外延层的化学成分结果。
综合考虑,GaSb基合金薄膜材料,GaSb二元合金材料的外延生长已经非常完善,国内外均可以外延生长出高质量的GaSb薄膜材料,难点在于锑化物三元系、四元系材料存在很大的不互溶隙,在不互溶隙内的材料为亚稳态,优质材料的生长难度十分大,是III-V族化合物中最复杂的材料之一。其中GaAsSb、InGaAsSb、AlGaAsSb合金薄膜材料中存在V族元素As、Sb竞争的问题,可以采用As2和Sb2/Sb4混合方式获得As2和(Sb2/Sb4)构成V族元素混合束流,抑制Sb分子活性,增强As分子结合率,进行GaSb基三元、四元合金薄膜材料的外延生长。
Table 1. Growth conditions of the GaAsSb alloy samples
表1. GaAsSb合金样品的生长条件

Figure 2. Photoluminescence results measured between 4 and 300 K and Normalized spectral response data, between 190 and 300 K
图2. 4 K到300 K的光致发光结果以及在190 K到300 K的归一化光谱响应数据

Figure 3. Band-gap energies as a function of the x composition parameter forAlxGa1−xAsySb1−y when lattice matched to GaSb
图3. 与GaSb晶格匹配的AlxGa1−xAsySb1−y四元合金材料的组分x与其带隙能量的关系
Table 2.Chemical compositions of AlxGa1−xAsySb1−ylayers
表2. AlxGa1−xAsySb1−y外延层的化学成分结果
3. GaSb基量子阱材料
锑化物的重要性被给予了大量的关注,并取得了许多突破性进展。最重要的成果为:MBE技术成功地克服了四元系锑化物材料生长的难题,制备得到优良性能的光电子器件材料。经过多年的努力,锑化物材料激光器的结构从异质结逐渐发展到多量子阱、量子点和量子级联等。根据能带构成的不同,又可分为I型量子阱和II型(W型)量子阱。
3.1. GaSb基I型量子阱材料
锑化物I型量子阱半导体器件,最具代表的材料体系为InGaAsSb/AlGaAsSb量子阱结构体系。MBE生长的InGaAsSb/AlGaAsSb量子阱激光器已实现了波谱在1.7~2.7 μm的激射 [26] [27] [28] ,300 K时锑化物I型量子阱激光器在3.1 μm [29] [30] 、3.2 μm [31] 、3.36 μm [32] 波长实现激射。2 μm波段InGaAsSb/AlGaAsSb多量子阱激光器材料体系的能带结构是I型量子阱结构,采用禁带宽度相对较窄的InGaAsSb材料为势阱层,禁带宽度相对较大的AlGaAsSb材料为势垒层。
最早的关于InGaAsSb/AlGaAsSb半导体激光器材料的研究始于1978年。1986年,贝尔实验室的研究人员首先用MBE生长了双异质结InGaAsSb/AlGaAsSb激光器材料,材料的发光波长为2.1 μm。2000年,新墨西哥大学高技术材料中心C.Mourad [33] 等人用MBE方法成功制备了In0.1Ga0.9As0.08Sb0.92/Al0.3Ga0.7As0.03Sb0.97双量子阱材料,由于合金组分不易精确控制,在生长过程中,通过控制As快门的占空比,As2和Sb2交替调制来实现对V族元素As组分的精确控制。所制备的In0.1Ga0.9As0.08Sb0.92/Al0.3Ga0.7As0.03Sb0.97量子阱材料获得了2 μm的发光。2004年,美国纽约哥伦比亚大学电气工程中心Li W [34] 等人提出并在I型InGaAsSb/AlGaAsSb量子阱材料体系中使用了应变补偿机制,采用14 nm宽的压应变In0.4Ga0.6As0.15Sb0.85为势阱层,21 nm宽的张应变Al0.25Ga0.75As0.02Sb0.98为势垒层,量子阱周期为4周期,量子阱材料实现了2.82 μm发光。图4为InGaAsSb/AlGaAsSb量子阱材料的XRD衍射曲线。
2009年,加拿大微观结构科学研究所J. A. Gupta [35] 等人用MBE生长了9.42 nm宽的In0.4Ga0.6As0.14Sb0.86量子阱,通过30nm的Al0.25Ga0.75As0.02Sb0.98和分离层进行补偿,分离层厚度为0.53 μm,量子阱的压应变为1.49%,实现发光波长为2.4 μm。图5为InGaAsSb/AlGaAsSb多量子阱结构的X射线衍射谱。
2014年,台湾交通大学Chien-Hung Lin [36] 等人通过通过控制界面V族元素处理界面的手段,成功

Figure 4. The XRD diffraction curves of InGaAsSb/AlGaAsSb strain-compensated quantum well structure
图4. InGaAsSb/AlGaAsSb应变补偿量子阱结构的XRD衍射曲线

Figure 5. The XRD diffraction curves of InGaAsSb/AlGaAsSb multiple quantum well structures
图5. InGaAsSb/AlGaAsSb多量子阱结构的XRD衍射曲线
生长了高质量的InGaAsSb/AlGaAsSb量子阱材料,并获得了优异的光谱质量。图6为InGaAsSb/AlGaAsSb量子阱材料的生长过程中元素快门的控制图以及样品的PL光谱。通过变温PL与变功率PL来对生长的量子阱材料进行全面的表征。在室温下观察到2.2 μm的激子发光。低温时PL强度保持恒定不变,并且变温PL表现出Bulk-like行为,表明阱层/垒层界面质量优异。正因为量子阱的均匀性和界面的光滑,PL发射谱线宽度在低温下有一个非常小的非均匀展宽为5 meV。
2014年,中科院北京半导体所牛智川 [37] 等人分析了生长温度和压缩应变对InGaAsSb/Al0.3Ga0.45In0.25As0.22 Sb0.78 MQWs样品光致发光(PL)性质的影响,以优化生长参数。通过优化生长参数,MQW结构的波长范围扩展到3.83 μm。图7为在优化生长参数条件下InGaAsSb/AlGaInAsSb多量子阱结构的归一化PL光谱。同年,牛智川 [38] 等人制备了GaSb基2.4 μm发光InGaAsSb/AlGaAsSb I型量子阱激光二极管。激光器由
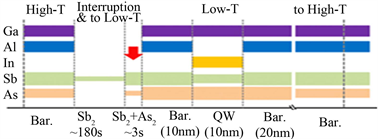 (a)
(a) (b)
(b)
Figure 6. (a) The element shutter control scheme for the growth of InGaAsSb/AlGaAsSb quantum wells; (b) PL diagram of quantum well sample
图6. (a) InGaAsSb/AlGaAsSb量子阱的生长中元素快门控制图;(b) 量子阱样品的PL图
 (a)
(a)  (b)
(b)
Figure 7. (a) Normalized PL Spectra of InGaAsSb/AlGaInAsSb Multiple Quantum Well Structures with optimized growth parameters; (b) Dark-field TEM image of 3.83 μm quantum well sample
图7. (a) 优化生长参数条件下InGaAsSb/AlGaInAsSb多量子阱结构的归一化PL光谱;(b) 3.83 μm量子阱样品的暗场TEM图像
三个In0.35Ga0.65As0.1Sb0.9/Al0.35Ga0.65As0.02Sb0.98量子阱组成,具有1%的压缩应变。图8为量子阱材料的室温PL光谱。
2015年,Seth R. Bank [39] 等人在低温下生长GaSb基I型量子阱,通过增加二极管激光器中的有源层的应变来延长发射波长。在350℃的衬底温度下生长量子阱结构,高达2.8%的压缩应变被掺入具有GaSb阻挡层的InGaAsSb/AlGaAsSb量子阱中,这些结构表现出室温光致发光峰值至3.96 μm。图9为不用In组分与应变的InGaAsSb/AlGaAsSb量子阱样品的室温PL光谱。
2016年,俄罗斯圣彼得堡理工大学Maxim Ya. Vinnichenko [40] 等人实验研究了具有不同阱层宽度的InGaAsSb/AlGaAsSb量子阱的带间光致发光光谱,并计算了参与辐射复合的电荷载流子浓度对泵浦强度的依赖性。理论计算结果与实验结果得到很好地一致。在一个样品中检测到涉及两个空穴和一个电子简并导致电荷载流子浓度显着降低的共振俄歇复合。制定了抑制有害非辐射俄歇复合的建议,以提高波长约3 μm半导体注入激光器的工作效率。2017年,他们 [41] 继续在理论与实验条件下研究了不同的光泵浦能级下不同势阱层宽度的InGaAsSb/AlGaAsSb量子阱结构光致发光(PL)光谱。实验测定了光致发光强度与光抽运能级的依赖关系,计算了光致发光强度对非平衡载流子浓度的依赖关系。通过实验与理论计算的对比证明了在一个研究的样品中共振非辐射俄歇复合的存在。图10为不同阱层宽度的InGaAsSb/AlGaAsSb量子阱的光致发光光谱。
2017年,Maxim Ya. Vinnichenko [42] 等人在具有各种势垒材料和量子阱宽度的InGaAsSb/AlGaAsSb量

Figure 8. Room temperature PL spectra of In0.35Ga0.65As0.1Sb0.9/ Al0.35Ga0.65As0.02Sb0.98 quantum well structure
图8. In0.35Ga0.65As0.1Sb0.9/Al0.35Ga0.65As0.02Sb0.98量子阱结构的室温PL光谱

Figure 9. Room temperature PL spectra of InGaAsSb/AlGaAsSb quantum well sample
图9. InGaAsSb/AlGaAsSb量子阱样品的室温PL谱
子阱结构中研究了带间光致发光的时间依赖性。将光致发光强度的光学激发水平的实验确定的依赖性与计算的光致发光强度对非平衡载流子浓度的依赖性进行比较。通过分析不同光泵浦水平的光致发光动力学,可以获得载流子俘获到量子阱中的时间和与极光学光子发射相关的能量弛豫时间。确定了相对于非辐射Shockley-Read-Hall和Auger重组的重组率。表明在某些参数组中,InGaAsSb/AlGaAsSb量子阱结构中可以存在共振俄歇复合,这将导致参与辐射复合的载流子浓度降低。图11为实验所得到InGaAsSb/AlGaAsSb量子阱e1到hh1的跃迁与实验得到的PL发光峰的位置关系和计算所得到的带隙能量。
GaSb基I型量子阱材料最具代表性的材料体系为InGaAsSb/AlGaAsSb材料体系,采用禁带宽度相对

Figure 10. Photoluminescence spectra of structures InGaAsSb/ AlGaAsSb quantum wells of different well width, in nanometers: 9(1), 7(2), 5(3), 4(4)
图10. 不同阱层宽度的InGaAsSb/AlGaAsSb量子阱的PL谱(1~4分别代表阱层宽度为9、7、5、4 nm)

Figure 11. Experimental positions of the photoluminescence peaks related to the transitions e1→hh1 (circles) and calculated energy gaps (lines): E(hh1)-E(so1), E(e1)-E(hh1), E(e2)-E(e1) marked as 1, 2 and 3, respectively
图11. InGaAsSb/AlGaAsSb量子阱e1到hh1的跃迁与实验得到的PL发光峰的位置关系和计算所得到的带隙能量:E(hh1)~ E(so1),E(e1)~E(hh1),E(e2)~E(e1)分别标记为1,2,3
较窄的InGaAsSb材料为势阱层,禁带宽度相对较大的AlGaAsSb材料为势垒层。在InGaAsSb/AlGaAsSb量子阱结构生长中,考虑到与材料应与衬底匹配,应该选择GaSb衬底材料。通过调节InGaAsSb/AlGaAsSb量子阱中材料组分,势阱层与势垒层厚度以及量子阱数目的多少可以实现对InGaAsSb/AlGaAsSb量子阱的应变、带隙以及结构进行调控。
3.2. GaSb基“W”型量子阱材料
锑化物I型量子阱体系覆盖波长为2~3 μm,如果继续向长波3~5 μm方向推进,存在生长难度大、量子阱质量不高等问题,已不能满足中长波锑化物半导体激光器研制的要求。为突破I型量子阱结构在波长扩展上的限制,有研究者提出“W”型量子阱结构,由双InAs电子量子阱和GaInSb空穴量子阱构成“三明治”结构,采用AlSb或AlGaAsSb在其外围形成限制层共同组成“W”型量子阱,如图12所示。通过调节GaInSb空穴量子阱中的In组分及电子阱和空穴阱薄膜厚度实现对发光波长的调节。其主要优势相对于I型量子阱结构在于:1) 更宽的波长覆盖范围;2) 更高的微分增益 [43] ;3) 更强的载流子限制作用 [44] ;4) 更好的俄歇限制能力 [45] 。
1995年,美国休斯研究实验室D. H. Chow [46] 等人通过调节InAs/GaInSb “W”型量子阱材料各层参数,获得了3.28 µm至3.90 µm发光。表3所示为四个实验样品的生长条件以及测试结果。
2005年C. L. Canedy [47] 等人报道了在n型GaSb衬底上外延生长的InAs(15Å)/Ga0.75In0.25Sb(27Å)/ InAs(15Å)/Al0.15Ga0.85As0.05Sb0.95(80Å)“W”型量子阱结构,获得了3.56 μm的发光波长。2009年J. Hader

Figure 12. The band structure diagram of “W” shaped quantum well
图12. “W”型量子阱能带示意图
Table 3. The growth conditions and test results of four experimental samples
表3. 实验样品的生长条件以及测试结果
[48] 实验生长了InAs(21.2Å)/Ga0.91In0.09Sb(30Å)/InAs(21.2Å)/Al0.35Ga0.65Sb(40Å)“W”型量子阱结构,测得的PL发光峰位约为5.1 μm。同年MarcinMotyka [49] 等人用分子束外延生长了GaSb/AlSb/InAs/InGaSb/ InAs/AlSb/GaSb “W”型量子阱结构,图13为所生长的量子阱样品的能带结构图。通过调节“W”型量子阱结构的As束流的压力和改变InAs层的厚度对“W”型量子阱结构进行表征。图14为不同As束流压力和InAs层的厚度条件下GaSb/AlSb/InAs/InGaSb/InAs/AlSb/GaSb “W”型量子阱结构的室温PL和PR图谱。

Figure 13. The band structure diagram of GaSb/AlSb/InAs/ InGaSb/InAs/AlSb/GaSb “W”-shaped quantum well
图13. GaSb/AlSb/InAs/InGaSb/InAs/AlSb/GaSb“W”型量子阱能带结构图
 (a) (b)
(a) (b)
Figure 14. Room temperature PL (dashed red lines) and PR (solid blue lines) spectra of GaSb/AlSb/InAs/GaInSb/InAs/AlSb/GaSb type II W-shaped quantum wells: (a) grown at arsenic pressures of (A) 0.6, (B) 0.47, and (C) 0.3 Pa, (b) grown for various InAs layers thickness of (D) 2.15, (E) 2.3, and (F) 2.5 nm
图14. GaSb/AlSb/InAs/InGaSb/InAs/AlSb/GaSb “W”型量子阱结构的室温PL (红色虚线)和PR图(蓝色实线):(a) As的束流压力为(A) 0.6,(B) 0.47,(C) 0.3 Pa;(b) InAs层的厚度为(D) 0.6,(E) 0.47,(C) 0.3 Pa
2011年,G. Sęk [50] 等人研究了MBE生长不同厚度InAs和GaInSb的“W”型量子阱样品的光致发光热淬灭行为,以确定有源区内载流子损耗的主要机理。研究结构表明,重空穴从价带向周围的GaSb层的逃逸已经被认为是载流子损耗的主要原因。图15所示为不同GaInSb厚度条件下“W”型量子阱结构的变温PL光谱。
2012年,M. Motyka [51] 等人采用MBE在GaSb(001)衬底上外延生长了InAs/GaInSb “W”型量子阱结构,该结构由两个2.3 nm的InAs层和一个3 nm宽的Ga0.7In0.3Sb层组成,这些层被包覆着2 nm厚的AlSb势垒层,之前和之后是300 nm的GaSb缓冲层和50 nm的GaSb盖层。通过室温PL和室温PR对其进行了表征,图16为InAs/GaInSb样品的室温PL和室温PR测试结果。

Figure 15. Temperature dependence of photoluminescence spectra for samples with different GaInSb layer thickness
图15. 不同GaInSb层厚度样品的变温PL光谱

Figure 16. Fourier transformed PL (red line) and PR (blue line) room temperature spectra of GaSb/AlSb(2.0 nm)/InAs(2.3 nm)/ GaInSb(3.0 nm)/InAs(2.3 nm)/AlSb(2.0 nm)/GaSb W-shaped quantum well
图16. GaSb/AlSb(2.0 nm)/InAs(2.3 nm)/GaInSb(3.0 nm)/ InAs(2.3 nm)/AlSb(2.0 nm)/GaSb W型量子阱的傅里叶变换PL图(红色)和室温PR (蓝色)图
2015年,Mateusz Dyksik [52] 等人报道了在GaSb和InAs衬底上生长的AlSb/InAs/InGaSb/InAs/AlSb “W”型量子阱结构的PL光谱特性,分析了发光波长,线宽以及PL强度的变化。图17是AlSb/InAs/ InGaSb/InAs/AlSb “W”型量子阱结构的室温PL光谱。
2016年,M. Dyksik [53] 等人报道了InAs/GaAsSb “W”型量子阱结构,详细研究了不同GaAsSb层厚度的AlSb/InAs/Ga0.7In0.3Sb/InAs/AlSb量子阱结构的PL光谱。图18所示为不同GaAsSb层厚度的AlSb/InAs/Ga0.7In0.3Sb/InAs/AlSb “W”型量子阱结构的PL光谱。
因此,采用“W”型量子阱作为锑化物半导体激光器有源区材料,是将激光器激射波长向长波扩展的有效途径。3~5 μm“W”型量子阱材料代表体系为InAs/GaInSb材料体系,InAs/GaInSb材料体系成功

Figure 17. Room temperature PL spectra from (a) InAs-based and (b) GaSb-based W-shaped quantum well structures
图17. (a) InAs基;(b) GaSb基W型量子阱结构的室温PL图
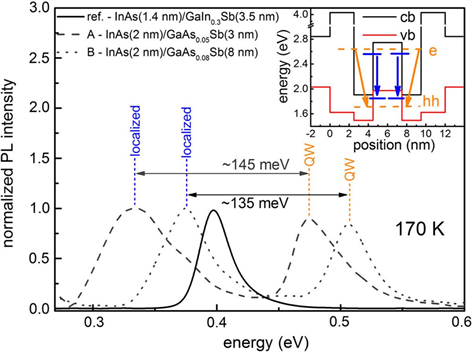
Figure 18. Photoluminescence spectra for the reference InAs/GaInSb sample (solid) and two samples with GaAsSb layer of different thickness and As content (see legend)
图18. 不同GaAsSb层厚度的AlSb/InAs/Ga0.7In0.3Sb/InAs/AlSb量子阱结构的PL光谱(参考InAs/GaInSbII型量子阱结构)
制备的基础在于其合金材料InAs、GaInSb薄膜的外延生长。在构建量子阱结构时,根据波长要求选择合适的GaInSb层的组分,InAs、GaInSb层的厚度,应变量,才是成功制备InAs/GaInSb量子阱结构的关键。
4. 结论与展望
本文简要回顾了2~5 μm中红外波段GaSb半导体材料的研究进展情况,描述了GaSb材料的基本结构、基本性质以及制备方法,重点叙述了GaSb合金薄膜材料及GaSb基量子阱材料的外延生长和材料性质的研究进展。明确高质量的GaSb半导体材料外延生长的根本在于外延生长过程中生长条件(温度、压力、束流等)的精确控制。在材料研究基础上,已经获得了GaSb基I型和W型量子阱结构的激光器器件,值得一提的是,中科院半导体 [54] 所结合激光器外延生长和锑化物工艺,制备出锑化物量子阱激光器器件。激光器工作电流450 mA时激射波长1.995 μm,激射谱半高宽0.35 nm。室温连续工作下出光功率达到82.2 mW。进一步提高工作温度至80℃时激光器仍可以连续工作,出光功率达到63.7 mW,达到国际先进水平。接下来锑化物半导体激光器的研究将围绕材料生长-器件制备-器件应用三个层次,立足GaSb基量子阱激光器有源区激光器材料制备、器件结构设计、器件制备工艺及性能测试,以实现高性能的I型InGaAsSb/AlGaAsSb及W型量子阱激光器器件,推动2~5 μm中红外波段GaSb基量子阱激光器的实用化。
随着MBE技术的成熟,开始生长低维锑化物合金结构。一些研究小组已经实现了GaSb基纳米线的可控生长 [55] 。纳米线的光学特性与薄膜材料类似,但纳米线中的表面态相对较大,这可以归因于它们的高表面积与体积比。建立这些结构的生长条件和光学性质之间的关系对于低维结构的研究是非常重要的。在此基础上,一维半导体器件的研究工作仍在进行之中,目前仍处于初级阶段,这将是以后GaSb半导体材料的又一研究重点。
致谢
感谢国家自然科学基金(61404009, 61474010, 61574022, 61504012, 61674021, 11674038)和吉林省科技发展计划(20160519007JH, 20160101255JC, 20160204074GX, 20170520117JH)对本研究工作的支持。感谢方铉老师对论文的帮助。
文章引用
余 沛,房 丹,唐吉龙,方 铉,王登魁,王新伟,王晓华,魏志鹏. 2~5 μm中红外波段GaSb半导体材料研究进展
Research Progress of 2 - 5 μm Mid-Infrared GaSb Semiconductor Materials[J]. 应用物理, 2018, 08(01): 45-61. http://dx.doi.org/10.12677/APP.2018.81007
参考文献 (References)
- 1. Borg, B.M. and Wernersson, L.E. (2013) Synthesis and Properties of Antimonies Nanowires. Nanotechnology, 24, 202001. https://doi.org/10.1088/0957-4484/24/20/202001
- 2. Cui, Q., Yang, Y., Li, J., et al. (2017) Material and Device Architecture Engineering toward High Performance Two- Dimensional (2D) Photodetectors. Crystals, 7, 149. https://doi.org/10.3390/cryst7050149
- 3. Chen, H., Liu, H., Zhang, Z., et al. (2016) Nanostructured Photodetectors: From Ultraviolet to Terahertz. Advanced Materials, 28, 403-433. https://doi.org/10.1002/adma.201503534
- 4. Zhang, Y., Wu, J., Aagesen, M., et al. (2015) III-V Nanowires and Nanowire Optoelectronic Devices. Journal of Physics D: Applied Physics, 48, 463001. https://doi.org/10.1088/0022-3727/48/46/463001
- 5. Li, L., Pan, D., Xue, Y., et al. (2017) Near Full-Composition-Range High-Quality GaAs1-xSbx Nanowires Grown by Molecular-Beam Epitaxy. Nano Letters, 17, 622-630. https://doi.org/10.1021/acs.nanolett.6b03326
- 6. Noh, Y.K., Hwang, Y.J., Kim, M.D., et al. (2007) Structural Properties of GaSb Layers Grown on InAs, AlSb, and GaSb Buffer Layers on GaAs (001) Substrates. Journal of the Korean Physical Society, 50, 1929.
- 7. La Pierre, R.R., Robson, M., Azizur-Rahman, K.M., et al. (2017) A Review of III-V Nanowire Infrared Photodetectors and Sensors. Journal of Physics D: Applied Physics, 50, 123001. https://doi.org/10.1088/1361-6463/aa5ab3
- 8. Dutta, P.S., Bhat, H.L. and Kumar, V. (1997) The Physics and Technology of Gallium Antimonide: An Emerging Optoelectronic Material. Applied Physics, 81, 5821-5870. https://doi.org/10.1063/1.365356
- 9. Johnson, G.R., Cavenett, B.C., Kerr T M, et al. (1988) Optical, Hall and Cyclotron Resonance Measurements of GaSb Grown by Molecular Beam Epitaxy. Semiconductor Science and Technology, 3, 1157. https://doi.org/10.1088/0268-1242/3/12/002
- 10. Vurgaftman, I., Meyer, J.R. and Ram-Mohan, L.R. (2001) Band Parameters for III-V Compound Semiconductors and Their Alloys. Applied Physics, 89, 5815-5875. https://doi.org/10.1063/1.1368156
- 11. Dutta, P.S., Rao, K.S.R.K., Bhat, H.L., et al. (1995) Surface Morphology, Electrical and Optical Properties of Gallium Antimonide Layers Grown by Liquid Phase Epitaxy. Journal of Crystal Growth, 152, 14-20. https://doi.org/10.1016/0022-0248(95)00071-2
- 12. Dutta, P.S., Bhat, H.L. and Kumar, V. (1995) Liquid Phase Epitaxial Growth of Pure and Doped GaSb Layers: Morphological Evolution and Native Defects. Bulletin of Materials Science, 18, 865-874. https://doi.org/10.1007/BF02745278
- 13. Jakowetz, W., Rühle, W., Breuninger, K., et al. (1972) Luminescence and Photoconductivity of Undoped p-GaSb. Physica Status Solidi, 12, 169-174.
- 14. Shin, J., Verma, A., Stringfellow, G.B., et al. (1972) Growth of GaSb using Tris(dimethylamido)antimony. Journal of Crystal Growth, 151, 1-8. https://doi.org/10.1016/0022-0248(94)01024-2
- 15. Chang, L.L. and Ploog, K. (1985) Molecular Beam Epitaxy and Heterostructures. Springer, Berlin. https://doi.org/10.1007/978-94-009-5073-3
- 16. Wieder, H.H. and Clawson, A.R. (1973) Photo-Electronic Properties of InAs0.07Sb0.93 Films. Thin Solid Films, 15, 217-221. https://doi.org/10.1016/0040-6090(73)90045-X
- 17. Miyoshi, H. and Horikoshi, Y. (2001) Substrate Lattice Constant Effect on the Miscibility Gap of MBE Grown InAsSb. Journal of Crystal Growth, 227, 571-576. https://doi.org/10.1016/S0022-0248(01)00774-6
- 18. Chou, C.Y., Torfi, A. and Wang, W.I. (2013) Improvement of GaAsSb Alloys on InP Grown by Molecular Beam Epitaxy with Substrate Tilting. Journal of Applied Physics, 114, Article ID: 153111. https://doi.org/10.1063/1.4825220
- 19. Gao, X., Wei, Z.P., Zhao, F., et al. (2016) Investigation of Localized States in GaAsSb Epilayers Grown by Molecular Beam Epitaxy. Scientific Reports, 6, Article No. 29112. https://doi.org/10.1038/srep29112
- 20. Garbuzov, D.Z., Martinelli, R.U., Lee, H., et al. (1997) 4 W Quasi-Continuous-Wave Output Power from 2 μm AlGaAsSb/InGaAsSb Single-Quantum-Well Broadened Waveguide Laser Diodes. Applied Physics Letters, 70, 2931- 2933. https://doi.org/10.1063/1.118747
- 21. Karouta, F., Mani, H., Bhan, J., et al. (1987) Croissance par épitaxieen phase liquide et caractérisation d’alliages Ga1−xInxAsySb1−y à paramètre de mailleaccordé sur celui de GaSb. Revue de Physique Appliquée, 22, 1459-1467. https://doi.org/10.1051/rphysap:0198700220110145900
- 22. Craig, A.P., Jain, M., Wicks, G., et al. (2015) Short-Wave Infrared Barriode Detectors using InGaAsSb Absorption Material Lattice Matched to GaSb. Applied Physics Letters, 106, Article ID: 201103. https://doi.org/10.1063/1.4921468
- 23. Adachi, S. (1987) Band Gaps and Refractive Indices of AlGaAsSb, GaInAsSb, and InPAsSb: Key Properties for a Variety of the 2-4 μm Optoelectronic Device Applications. Journal of Applied Physics, 61, 4869-4876. https://doi.org/10.1063/1.338352
- 24. Ait, K.H., Boukredimi, D. and Mebarki, M. (1997) Band Discontinuities of Perfectly Lattice-Matched GaSb(n)/ GaAlAsSb(p)/GaSb(p) Double Heterojunction. Physica Status Solidi, 163, 101-106.
- 25. Jasik, A., Kubacka-Traczyk, J., Regiński, K., et al. (2011) Method of Determination of AlGaAsSb Layer Composition in Molecular Beam Epitaxy Processes with Regard to Unintentional as Incorporation. Journal of Applied Physics, 110, Article ID: 073509. https://doi.org/10.1063/1.3642995
- 26. Keyes, R.J. and Quist, T.M. (1962) Recombination Radiation Emitted by Gallium Arsenide. Proceedings of the IRE, 50, 1822-1823.
- 27. Nathan, M.I., Dumke, W.P., Burns, G., et al. (1962) Stimulated Emission of Radiation from GaAs p-n Junctions. Applied Physics Letters, 1, 62-64. https://doi.org/10.1063/1.1777371
- 28. Quist, T.M., Rediker, R.H., Keyes, R.J., et al. (1962) Semiconductor Master of GaAs. Applied Physics Letters, 1, 91-92. https://doi.org/10.1063/1.1753710
- 29. Panish, M., Hayashi, I. and Sumski, S. (1969) A Technique for the Preparation of Low-Threshold Room-Temperature GaAs Laser Diode Structures. Quantum Electronics, 5, 210-211. https://doi.org/10.1109/JQE.1969.1075757
- 30. Alferov, Z.I., Andreev, V.M., Portnoi, E.L., et al. (1970) AlAs-GaAs Heterojunction Injection Lasers with a Low Room-Temperature Threshold. Soviet Physics Semiconductors, 3, 1107-1110.
- 31. Panish, M.B., Hayashi, I. and Sumski, S. (1970) Double-Heterosture Injection Lasers with Room Temperature Thresholds as Low as 2300 A/cm2. Applied Physics Letters, 16, 326-327. https://doi.org/10.1063/1.1653213
- 32. Hasan, M.M., Islam, M.R. and Teramoto, K. (2012) Crystallographic Orientation-Dependent Optical Properties of GaInSb Mid-Infrared Quantum Well Laser. Optik—International Journal for Light and Electron Optics, 123, 1993- 1997. https://doi.org/10.1016/j.ijleo.2011.09.021
- 33. Mourad, C., Gianardi, D., Malloy, K.J., et al. (2000) 2 μm GaInAsSb/AlGaAsSb Mid-Infrared Laser Grown Digitally on GaSb by Modulated-Molecular Beam Epitaxy. Journal of Applied Physics, 88, 5543-5546. https://doi.org/10.1063/1.1319967
- 34. Li, W., HÉ, J.B., et al. (2004) Strain-Compensated InGaAsSb/AlGaAsSb Mid-Infrared Quantum-Well Lasers. Applied Physics Letters, 84, 2016-2018. https://doi.org/10.1063/1.1687981
- 35. Rodriguez, J.B., Cerutti, L. and Tournié, E. (2009) GaSb-Based, 2.2 μm Type-I Laser Fabricated on GaAs Substrate Operating Continuous Wave at Room Temperature. Applied Physics Letters, 94, Article ID: 023506. https://doi.org/10.1063/1.3072596
- 36. Lin, C.H. and Lee, C.P. (2014) Enhanced Optical Property in Quaternary GaInAsSb/AlGaAsSb Quantum Wells. Journal of Applied Physics, 116, Article ID: 153504. https://doi.org/10.1063/1.4898389
- 37. Xing, J., Zhang, Y., Xu, Y., et al. (2014) High Quality above 3 μm Mid-Infrared InGaAsSb/AIGaInAsSb Multiple-Quantum Well Grown by Molecular Beam Epitaxy. Chinese Physics B, 23, 454-457. https://doi.org/10.1088/1674-1056/23/1/017805
- 38. Xing, J.L., Zhang, Y., Liao, Y.P., et al. (2014) Room-Temperature Operation of 2.4 μm InGaAsSb/AlGaAsSb Quantum-Well Laser Diodes with Low-Threshold Current Density. Chinese Physics Letters, 31, Article ID: 054204. https://doi.org/10.1088/0256-307X/31/5/054204
- 39. Sifferman, S.D., Nair, H.P., Salas, R., et al. (2015) Highly Strained Mid-Infrared Type-I Diode Lasers on GaSb. IEEE Journal of Selected Topics in Quantum Electronics, 21, 248-257. https://doi.org/10.1109/JSTQE.2015.2427742
- 40. Vinnichenko, M.Y., Makhov, I.S., Selivanov, A.V., et al. (2016) Effect of Auger Recombination on Non-Equilibrium Charge Carrier Concentration in InGaAsSb/AlGaAsSb Quantum Wells. St Petersburg Polytechnical University Journal Physics & Mathematics, 2, 287-293. https://doi.org/10.1016/j.spjpm.2016.11.007
- 41. Vinnichenko, M.Y., Makhov, I.S., Selivanov, A.V., et al. (2017) Photoluminescence in InGaAsSb/AlGaAsSb Quantum Wells: Impact of Nonradiative Recombination. Journal of Physics: Conference Series, 816, Article ID: 012017.
- 42. Vinnichenko, M.Y., Makhov, I.S., Balagula, R., et al. (2017) The Effect of Auger Recombination on the Nonequilibrium Carrier Recombination Rate in the InGaAsSb/AlGaAsSb Quantum Wells. Superlattices& Microstructures, 109, 743-749. https://doi.org/10.1016/j.spmi.2017.05.065
- 43. Janiak, F., Seek, G., Motyka, M., Ryczko, K., Misiewicz, J., Bauer, A., Höfling, S., Kamp, M. and Forchel, A. (2012) Increasing the Optical Transition Oscillator Strength in GaSb-Based Type II Quantum Wells. Applied Physics Letters, 100, Article ID: 231908. https://doi.org/10.1063/1.4726423
- 44. Ryczko, K., Seek, G. and Misiewicz, J. (2013) Eight-Band k p Modeling of InAs/InGaAsSb Type-II W-Design Quantum Well Structures for Interband Cascade Lasers Emitting in a Broad Range of Mid Infrared. Journal of Applied Physics, 114, Article ID: 223519. https://doi.org/10.1063/1.4843076
- 45. Bewley, W.W., Lindle, J.R., Kim, C.S., Kim, M., Canedy, C.L., Vurgaftman, I. and Meyer, J.R. (2008) Lifetimes and Auger Coefficients in Type-II W Interband Cascade Lasers. Applied Physics Letters, 93, Article ID: 041118. https://doi.org/10.1063/1.2967730
- 46. Chow, D.H., Miles, R.H., Hasenberg, T.C., Kost, A.R., Zhang, Y.H., Dunlap, H.L. and West, L. (1995) Mid-Wave Infrared Diode Lasers Based on GaInSb/InAs and InAs/AlSb Superlattices. Applied Physics Letters, 67, 3700-3702. https://doi.org/10.1063/1.115354
- 47. Canedy, C.L., Bewley, W.W., Lindle, J.R., Vurgaftman, I., Kim, C.S., Kim, M. and Meyer, J.R. (2005) Mid-Infrared “W” Diode Lasers with Improved Electrical Characteristics. Applied Physics Letters, 86, Article ID: 211105. https://doi.org/10.1063/1.1938256
- 48. Hader, J., Moloney, J.V., Koch, S.W., Vurgaftman, I. and Meyer, J.R. (2009) High-Power Continuous-Wave Midinfrared Type-II “W” Diode Lasers. Applied Physics Letters, 94, Article ID: 061106. https://doi.org/10.1063/1.3080216
- 49. Motyka, M., Sęk, G., Misiewicz, J., et al. (2009) Fourier Transformed Photoreflectance and Photoluminescence of Mid Infrared GaSb-Based Type II Quantum Wells. Journal of Applied Physics Express, 2, 126505-126505. https://doi.org/10.1143/APEX.2.126505
- 50. Sęk, G., Janiak, F., Motyka, M., et al. (2011) Carrier Loss Mechanisms in Type II Quantum Wells for the Active Region of GaSb-Based Mid-Infrared Interband Cascade Lasers. Optical Materials, 33, 1817-1819. https://doi.org/10.1016/j.optmat.2011.06.019
- 51. Motyka, M., Ryczko, K., Sęk, G., et al. (2012) Type II Quantum Wells on GaSb Substrate Designed for Laser-Based Gas Sensing Applications in a Broad Range of Mid Infrared. Optical Materials, 34, 1107-1111. https://doi.org/10.1016/j.optmat.2012.01.012
- 52. Dyksik, M., Motyka, M., Sęk, G., et al. (2015) Submonolayer Uniformity of Type II InAs/GaInSb W-Shaped Quantum Wells Probed by Full-Wafer Photoluminescence Mapping in the Mid-Infrared Spectral Range. Nanoscale Research Letters, 10, 1-7. https://doi.org/10.1186/s11671-015-1104-z
- 53. Dyksik, M., Motyka, M., Weih, R., et al. (2017) Carrier Transfer between Confined and Localized States in Type II InAs/GaAsSb Quantum Wells. Optical & Quantum Electronics, 49, 59. https://doi.org/10.1007/s11082-017-0891-0
- 54. Yu, Z., Yongbin, W., Yingqiang, X., et al. (2012) High-Temperature (T = 80℃) Operation of a 2 μm InGaSb- AlGaAsSb Quantum Well Laser. Journal of Semiconductors, 33, Article ID: 044006. https://doi.org/10.1088/1674-4926/33/4/044006
- 55. Huh, J., Yun, H., Kim, D.C., et al. (2015) Rectifying Single GaAsSb Nanowire Devices Based on Self-Induced Compositional Gradients. Nano Letters, 15, 3709-3715. https://doi.org/10.1021/acs.nanolett.5b00089
