 Hans Journa l of Nanotechnology纳米技术, 2011, 1, 39-44 http://dx.doi.org/10.12677/nat.2011.11008 Published Online May 2011 (http://www.hanspub.org/journal/nat/) Copyright © 2011 Hanspub NAT Properties of Microporous Nanocomposite GaAs by Metal-Assisted Etching Technique Cheng-Chiang Chen*, Lung-Chien Chen, Suz-Wei Lu, Wen-Fang Tsai Department of Electro-optical Engineering, National Taipei University of Technology, Taibei Email: t7659004@ntut.edu.tw; ocean@ntut.edu.tw; hkj105@gmail.com; dryadc93389@gmail.com Received: Apr.29th, 2011; revised: May 11th, 2011; accepted: May 12th, 2011. Abstract: This work reports on the photovoltaic properties of n-type microporous GaAs substrates. The mi- croporous morphology on GaAs substrates were fabricated utilizing Ag metal-assisted etching technique un- der electroless condition. Then, we investigates the surface morphology of microporous GaAs substrates with different etching times.The experimental results indicated the microporous structures of GaAs are larger and clearly defined as increasing etching time. The lower reflectivity of microporous structures was observed in 20 min of etching time. Incident angle near 0 degrees using the reflection spectrum of GaAs polished without etching before the reflectivity curve of reflectance of 50% or less, in the range of 400~800 nm average reflection rate was 33.69%, with 45-degree angle of reflection for incident Spectra, reflectance spectra of GaAs is not polished and near 0° incidence of the specular reflection spectra of spectral structure are less than 50%, 400~800 nm band average reflectance between the rate of 33.56%. Keywords: Gallium Arsenide (GaAs); Metal-Assisted Etching Technique 利用奈米技术制作砷化镓之微奈米孔洞 陈正强*,陈隆建,吕思纬,蔡文芳 国立台北科技大学,光电工程系,台北 Email: t7659004@ntut.edu.tw; ocean@ntut.edu.tw; hkj105@gmail.com; dryadc93389@gmail.com 收稿日期:2011年4月29 日;修回日期:2011 年5月11 日;录用日期:2011 年5月12 日 摘 要:本研究利用金属辅助式蚀刻技术在无通电下制作出具有微米等级的孔洞于 n型砷化镓(GaAs)基 板,观察其不同时蚀刻时间条件下砷化镓基板表面型态与反射光谱。实验结果显示随着蚀刻时间的增加 孔洞结构越明显,并在蚀刻时间 20 分钟有较低的反射率。使用近 0度角入射之反射式光谱,在未蚀刻 前抛光 GaAs 之反射光谱曲线反射率在 50%以下,在 400~800 nm范围内平均的反射率为 33.69%,使用 45 度角入射之反射式光谱,未蚀刻前抛光 GaAs 反射光谱与近 0度角入射之镜面反射式光谱架构的光谱 都低于 50%,400~800 nm 波段间之平均反射率为 33.56%。 关键词:砷化镓;金属辅助蚀刻 1. 引言 孔洞的蚀刻技术早已在 80 年代时开始研究,在 1984 年由 Pickering 提出多孔硅(porous silicon)有光激 发光现象[1],许多研究人员对多孔硅形成的机制与发 光原理有更深入的探讨与实验,但多孔硅形成的解释 机制常见的有—量子局限模型、扩散局限模型、Beale 模型[2-3],多孔硅材料除了保留单晶硅的特性外,其微 结构及蚀刻液的化学成分,会决定其光电特性。根据 Lehmann et al.所提多孔硅之量子模型,电洞是电化学 蚀刻反应形成多孔硅必要之元素,p型硅基板较 n型  陈正强等 利用奈米技术制作砷化镓之微奈米孔洞 40 | 硅基板容易蚀刻出大孔隙率的多孔硅,多孔硅相较于 单晶硅有较大的能隙,随着阳极氧化蚀刻反应的进行, 多孔硅的尺寸逐渐变小而有效能隙则逐渐变大,所以 电洞需要更多的能量来穿越多孔硅层。孔洞 Si 的蚀刻 方法以电化学方式主要以通电流供应,少数有改以供 应电压方式蚀刻,也有研究以阳极氧化铝(Anodized Aluminum Oxide, AAO)制作出周期、排列性的孔洞 Si, 但利用前述化学蚀刻或 AAO 方式蚀刻,在制程上需 要电源供应器及特殊夹具才能制作,在制作成本上较 高,最近几年来开始有研究其它简易的方式制作大面 积的孔洞硅,2008 年C.Chartier、S. Bastide 与C. Le’vy-Cle’men 三人提出以化学溶液方式进行无电极 蚀刻方式[4],先以硝酸银(AgNO3)溶液产生氧化银金属 层(metalization),再利用氢氟酸(HF)与过氧化氢(H2O2) 混合溶液与银金属层产生“自发性”的电化学反应, 利用其氧化还原法进行硅晶圆蚀刻,此方法应用金属 粒子辅助式蚀刻,由于制程简单即可进行蚀刻出大面 积的孔洞。 本研究以无电极方式利用Ag 金属粒子的催化辅 助式蚀刻技术制做大面积的孔洞结构,利用Ag 粒子 的催化辅助把抛光之 GaAs表面蚀刻出微米孔洞大小 型态,表面处理后降低其反射率,另一方面增加与有 机材料接触时的接触面积,使载子分离的界面增加。 2. 实验 本研究主要使用金属辅助式蚀刻技术于(100) n-GaAs 蚀刻出具有微米孔洞结构之型态。 2.1. 去除砷化镓基板上原生氧化层 利用 n-type GaAs基板,分别用以氢氟酸缓冲液 BOE(Buffer oxide etch, 40%NH4F:49%HF = 6:1)将 n-type GaAs基板浸泡 10 分钟去除表面之原生氧化层 杂质,最后用去离子水将清洗干净,并放入加热平台 120°C、10 分钟去除水气。 2.2. 硝酸银溶液调配 使用 0.4 g硝酸银,1 ml氢氟酸,加入 100 ml去 离子水,以磁石搅拌子搅拌后,完成硝酸银金属化溶 液。取 40 ml氢氟酸,35 ml过氧化氢(H2O2)及25 ml 去离子水混合成100 ml 的化学蚀刻溶液,配成体积百 分比为 8:7:5的溶液。 2.3. GaAs化学蚀刻阳极处理蚀刻方式 将砷化镓芯片浸泡至硝酸银金属化溶液后,放入 配置好的化学蚀刻阳极处理溶液中进行孔洞蚀刻,并 且分别蚀刻 5分钟、10 分钟、15 分钟、20 分钟以及 40 分钟,浸泡时芯片上的 Ag 金属粒子与蚀刻液会产 生反应产生气泡,原来乳肤色薄膜会开始慢慢的自然 脱落后,开始进行氧化还原反应,形成一种化学式阳 极氧化处理。待硝酸银薄膜脱落后,将砷化镓芯片会 蚀刻出不规则的微米级孔洞,随不同浓度及时间改变 而改变孔径宽度及深度。 3. 实验结果与讨论 使用金属辅助式蚀刻技术在无通电下制作出具有 微米等级的孔洞,进行下列几项量测: 3.1. 扫瞄式电子显微镜(Scanning Electron Microscope,SEM)分析 如图 1,SEM 表面可发现粒子的大小约 670 nm~1 μm之间。图 2(a)为n型抛光GaAs 基板尚未蚀刻之表 面形态,表面为平整面。图2(b)(c)为浸泡蚀刻液 5分 钟,放大 5000 倍时能观察到较清楚的微凹孔洞,这些 微凹孔洞密度不高且直径约在数百奈米之间。图 2(d)(e)(f)为浸泡蚀刻液10 分钟,与浸泡蚀刻液 5分钟 相比,在 10 分钟蚀刻时间下尚有部分区块还未被蚀刻 到,而形成岛块状的分布。图 3(a)(b)(c)为浸泡蚀刻液 15 分钟,蚀刻的孔洞密度相对提升,孔洞的型态也明 显的形成,孔洞的大小约在数百奈米到一微米间。图 3(d)(e)(f)为浸泡蚀刻液20 分钟,孔洞的分布密度大幅 提升,原本还可见的大岛块状分布已变更小或形成孔 洞状,孔洞深度也明显的突显出来,孔洞的大小有些 部分稍微超过几微米,但大多约在一微米间,虽然蚀 刻为孔洞状,却又像是一根一根直径约一微米大小的 柱状结构的分布。在图 2、3中可发现当浸泡于蚀刻液 的时间加长后,孔洞的深度与密度有着明显的变化, 从原本平整的 GaAs基板表面到形成岛块状分布之蚀 刻,可发现浸泡时间的拉长与孔洞深度及表面密度之 间的关系。 图4(a)~(d)为浸泡 AgNO3金属化溶液5分钟后, Copyright © 2011 Hanspub NAT 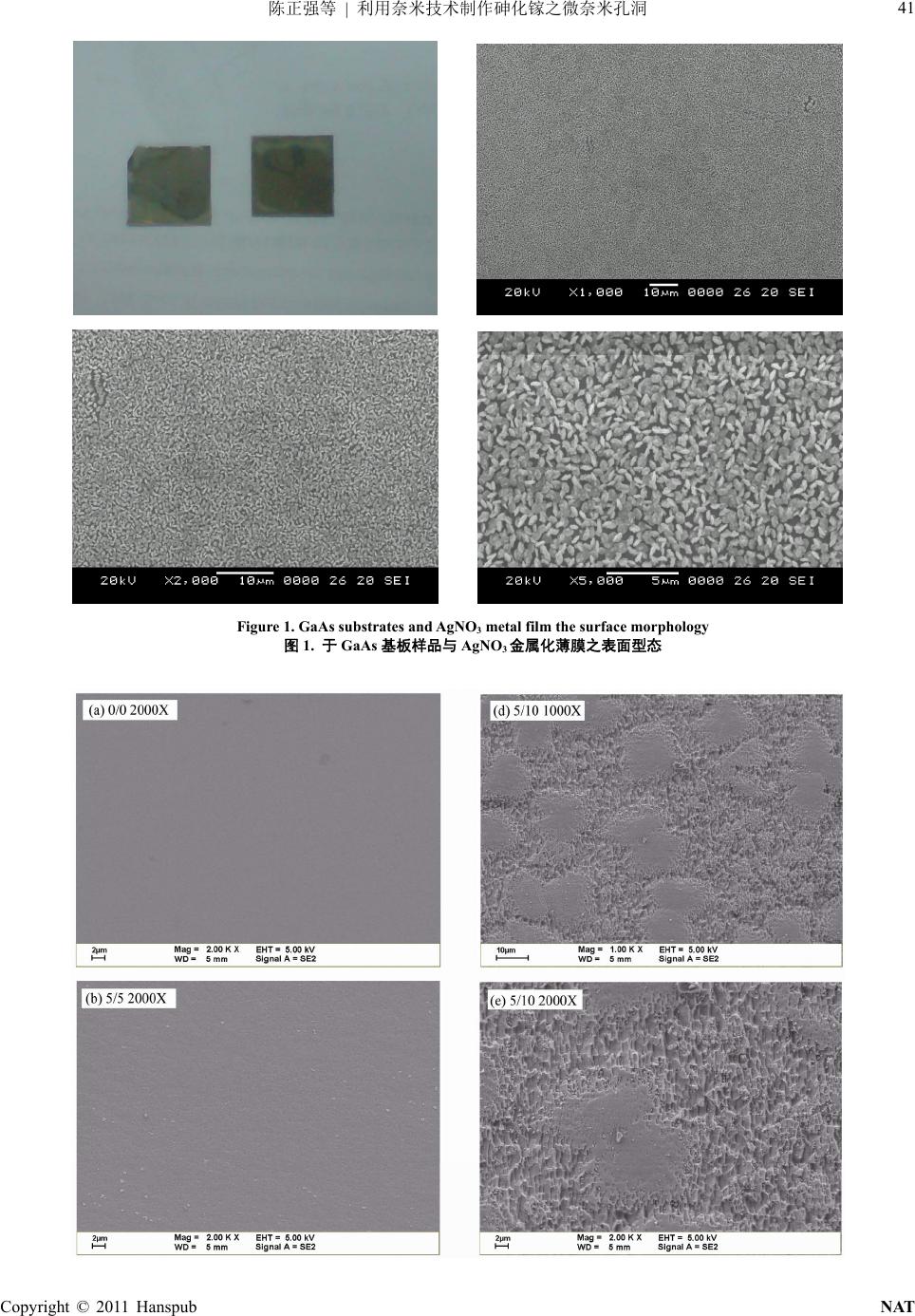 陈正强等 | 利用奈米技术制作砷化镓之微奈米孔洞 Copyright © 2011 Hanspub NAT 41 Figure 1. GaAs substrates and AgNO3 metal film the surface morphology 图1. 于GaAs 基板样品与 AgNO3金属化薄膜之表面型态 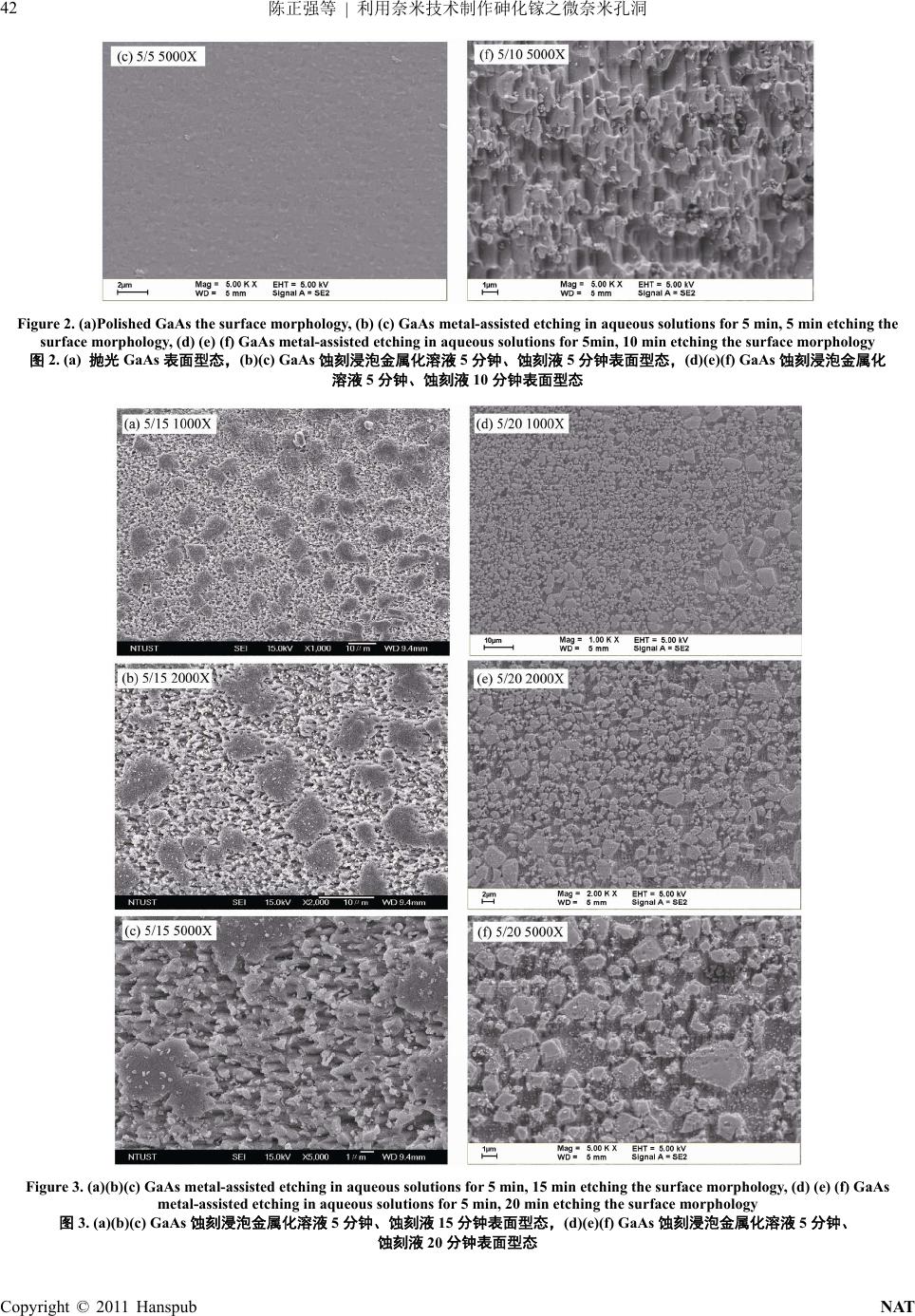 陈正强等 利用奈米技术制作砷化镓之微奈米孔洞 42 | Figure 2. (a)Polished GaAs the surface morphology, (b) (c) GaAs metal-assisted etching in aqueous solutions for 5 min, 5 min etching the surface morpholog y, (d) (e) (f) GaAs metal-assisted etching in aqueous solutions for 5min, 10 min etching the surface morphology 图2. (a) 抛光 GaAs表面型态,(b)(c) Ga As蚀刻浸泡金属化溶液 5分钟、蚀刻液 5分钟表面型态,(d)(e)(f) GaAs蚀刻浸泡金属化 溶液 5分钟、蚀刻液 10 分钟表面型态 Figure 3. (a)(b)(c) GaAs metal-assisted etching in aqueous solutions for 5 min, 15 min etching the surface morphology, (d) (e) (f) GaAs metal-assisted etching in aqueous solutions for 5 min, 20 min etching the surface morphology 图3. (a)(b)(c) GaAs蚀刻浸泡金属化溶液5分钟、蚀刻液 15 分钟表面型态,(d)(e)(f) GaAs蚀刻浸泡金属化溶液 5分钟、 蚀刻液 20 分钟表面型态 Copyright © 2011 Hanspub NAT  陈正强等 | 利用奈米技术制作砷化镓之微奈米孔洞 Copyright © 2011 Hanspub NAT 43 Figure 4 . GaAs metal-assisted etching in aqueous solutions for 5 min, etching(a) 5 min, (b) 10 mi n, (c) 15 min, (d) 20 min the cross-sectional 图4. GaAs蚀刻浸泡金属化溶液 5分钟、浸泡蚀刻液(a) 5分钟,(b) 10分钟,(c) 15分钟,(d) 20分钟之截面 浸泡蚀刻液 5~20 分钟后之截面型态。图 4(a)5分钟蚀 刻时间截面上看不到有孔洞的深度,只有在表面看的 到些微凹洞,图4(b)为10 分钟时刻时间,在2万倍已 可看出蚀刻深度约在 580 nm左右,直径接近 1 μm。 图4(c)为15 分钟时刻时间,深度约为 750 nm左右, 图4(d)为20 分钟时刻时间,深度约为 1 μm。从截面 来看也发现蚀刻的时间拉长孔洞的深度也有随之增加 的趋势。在 40 分钟的蚀刻时间,多了20 分钟的蚀刻 时间但孔洞深度只有约1.133 μm,多20 分钟的时间 孔洞深度只多了约 113 nm,其原因可能为蚀刻溶液中 的浓度已改变,浓度开始饱和,溶液中浓度改变使蚀 刻的速率开始变慢,造成虽然时间加长,但深度却没 有比例增加,图5为GaAs 孔洞蚀刻时间对蚀刻深度 作图比较,可得知在5~20 分钟间之蚀刻深度有接近 线性之变化增加。 3.2. 孔洞砷化镓反射光谱分析 反射光谱量测采用两种方式测量,第一种以 Y型 光纤架设近 0度反射式之量测,第二种则为使用 45 度角架设反射式之量测。 图6为近 0度角入射之反射式光谱,在未蚀刻前 抛光 GaAs 之反射光谱曲线反射率在 50%以下,在 400~800 nm范围内平均的反射率为 33.69%,当浸泡 Figure 5 . Etching depth of GaAs with vari o u s e tching times 图5. GaAs孔洞蚀刻时间对蚀刻深度 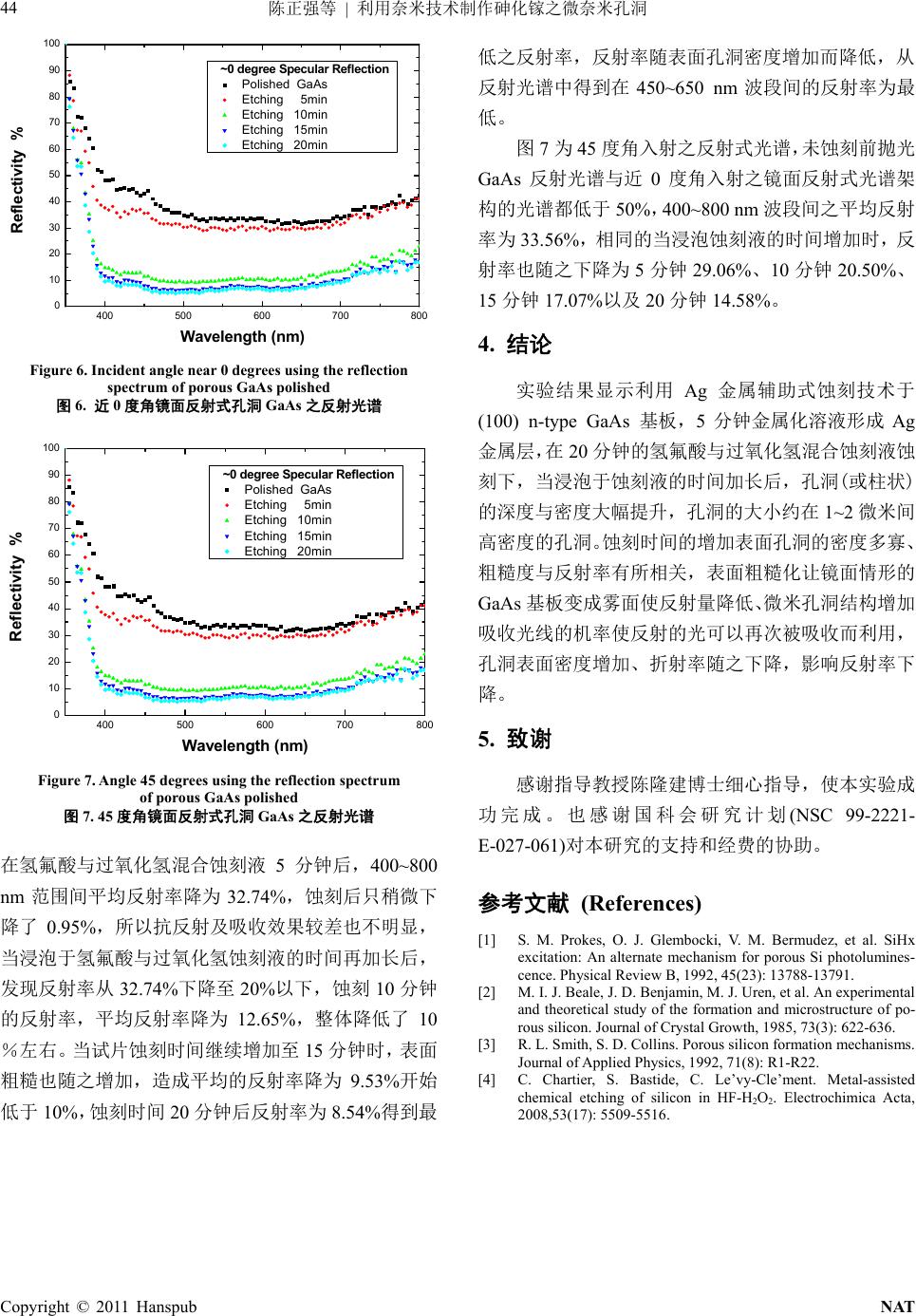 陈正强等 利用奈米技术制作砷化镓之微奈米孔洞 44 | 400 500 600 700 800 0 10 20 30 40 50 60 70 80 90 100 Reflectivity % Wavelength (nm) ~0 degree Specular Reflection Polished GaAs Etching 5min Etching 10min Etching 15min Etching 20min Figure 6 . Incident angle near 0 degrees u s i n g the reflection spectrum of porous GaAs polished 图6. 近0度角镜面反射式孔洞 GaAs 之反射光谱 400 500 600 700 800 0 10 20 30 40 50 60 70 80 90 100 Reflectivity % Wavelength (nm) ~0 degree Specular Reflection Polished GaAs Etching 5min Etching 10min Etching 15min Etching 20min Figure 7 . Angle 45 degrees using the refl e c tion spectrum of porous GaAs polished 图7. 45度角镜面反射式孔洞 GaAs 之反射光谱 在氢氟酸与过氧化氢混合蚀刻液5分钟后,400~800 nm 范围间平均反射率降为 32.74%,蚀刻后只稍微下 降了 0.95%,所以抗反射及吸收效果较差也不明显, 当浸泡于氢氟酸与过氧化氢蚀刻液的时间再加长后, 发现反射率从32.74%下降至 20%以下,蚀刻 10分钟 的反射率,平均反射率降为 12.65%,整体降低了10 %左右。当试片蚀刻时间继续增加至 15 分钟时,表面 粗糙也随之增加,造成平均的反射率降为9.53%开始 低于 10%,蚀刻时间 20 分钟后反射率为 8.54%得到最 低之反射率,反射率随表面孔洞密度增加而降低,从 反射光谱中得到在450~650 nm波段间的反射率为最 低。 图7为45 度角入射之反射式光谱,未蚀刻前抛光 GaAs 反射光谱与近 0度角入射之镜面反射式光谱架 构的光谱都低于50%,400~800 nm 波段间之平均反射 率为 33.56%,相同的当浸泡蚀刻液的时间增加时,反 射率也随之下降为 5分钟 29.06%、10 分钟 20.50%、 15 分钟 17.07%以及 20 分钟 14.58%。 4. 结论 实验结果显示利用 Ag 金属辅助式蚀刻技术于 (100) n-type GaAs 基板 ,5分钟金属化溶液形成Ag 金属层,在 20 分钟的氢氟酸与过氧化氢混合蚀刻液蚀 刻下,当浸泡于蚀刻液的时间加长后,孔洞(或柱状) 的深度与密度大幅提升,孔洞的大小约在 1~2微米间 高密度的孔洞。蚀刻时间的增加表面孔洞的密度多寡、 粗糙度与反射率有所相关,表面粗糙化让镜面情形的 GaAs 基板变成雾面使反射量降低、微米孔洞结构增加 吸收光线的机率使反射的光可以再次被吸收而利用, 孔洞表面密度增加、折射率随之下降,影响反射率下 降。 5. 致谢 感谢指导教授陈隆建博士细心指导,使本实验成 功完成。也感谢国科会研究计划(NSC 99-2221- E-027-061)对本研究的支持和经费的协助。 参考文献 (References) [1] S. M. Prokes, O. J. Glembocki, V. M. Bermudez, et al. SiHx excitation: An alternate mechanism for porous Si photolumines- cence. Physical Review B, 1992, 45(23): 13788-13791. [2] M. I. J. Beale, J. D. Benjamin, M. J. Uren, et al. An experimental and theoretical study of the formation and microstructure of po- rous silicon. Journal of Crystal Growth, 1985, 73(3): 622-636. [3] R. L. Smith, S. D. Collins. Porous silicon formation mechanisms. Journal of Applied Physics, 1992, 71(8): R1-R22. [4] C. Chartier, S. Bastide, C. Le’vy-Cle’ment. Metal-assisted chemical etching of silicon in HF-H2O2. Electrochimica Acta, 2008,53(17): 5509-5516. Copyright © 2011 Hanspub NAT |