 Modern Physics 现代物理, 2011, 1, 59-65 http://dx.doi.org/10.12677/mp.2011.13010 Published Online November 2011 (http://www.hanspub.org/journal/mp/) Copyright © 2011 Hanspub MP Fabrication of Si-Based 1D,2D Ordered Nano Structure by Nanoimprint Lithography* Wei Li College of Electronic Science and Engineering, Nanjing University of Posts and Telecommunications, Nanjing Email: Liw@njupt.edu.cn Received: Aug. 31st, 2011; revised: Oct. 9th, 2011; accepted: Oct. 11th, 2011. Abstract: The dimension of the microelectronic devices is reduced year by year as the development of the modern microelectronic technology. So, the research of the fabrication of nanometer structures becomes one of the most interesting topics. Nanoimprint lithography (NIL) is a more promising technology. In this paper, the process of nanoimprint lith ography was introduced. And, 1-D and 2-D quartz grating molds with the pe- riod 2 µm was transferred to Si substrate by NIL. The resolution is only related to the size and the template pattern without the limitation of optical lithography exposure wavelength. AFM measurement showed the perfect fidelity of the imprint process. Keywords: Nanoimprint Lithography; Ordered Structure; Reaction Ion Etching 纳米压印技术制备硅基有序一维、二维纳米结构* 李 卫 南京邮电大学,电子科学与工程学院微电子系,南京 Email: Liw@njupt.edu.cn 收稿日期:2011 年8月31日;修回日期:2011 年10 月9日;录用日期:2011 年10 月11 日 摘 要:微电子器件的小型化是集成电路图形尺寸即将突破传统光刻极限,发展新的微加工技术更是当 今科研工作在重要目标之一。纳米压印技术是较有应用前景的技术。本文主要介绍了纳米压印的基本过 程,利用一维和二维石英光栅为模版,采用紫外光固化原理,将模版上的有序周期结构转移到光刻胶上。 其分辨率只与模版图案的尺寸有关,而不受光学光刻的最短曝光波长的物理限制。利用反应离子刻蚀技 术将已固化的光刻胶上的图形最终转移到硅衬底上。AFM 观测结 果 表明压印过程 可以将模版上 的结构 完全保真地转移到硅衬底上。 关键词:纳米压印;有序纳米结构;等离子刻蚀技术 1. 引言 由于经济原因促使半导体行业朝着不断缩小特征 尺寸方向发展,随之而来的技术进步导致了设备的成 本以指数增长。由于成本的增长,人们对纳米压印这 一低成本图形转移技术的关注越来越多。通过避免使 用昂贵的光源和投影光学系统,纳米压印光刻比传统 光刻方法大大降低了成本。 纳米压印(NIL)技术[1,2]的研究始于普林斯顿大学 纳米结构实验室 Steph en Y. Chou教授,这种技术将一 具有纳米图案的模版以机械力(高温、高压)在涂有高 分子材料的硅基板上等比例压印复制纳米图案,其加 工分辨率只与模版图案的尺寸有关,而不受光学光刻 的最短曝光波长的物理限制。由于省去了光学光刻掩 模版和使用光学成像设备的成本。因此 NIL 技术具有 低成本、高产出的经济优势。此外,NIL 技术可应用 *江苏省高校自然科学基金(批准号:09KJB510014),南京邮电大学 引进人才科研启动基金(批准号:NY208057),南京邮电大学教学改 革研究项目(批准号:JG03309JX37)资助的课题。  李卫 等纳米压印技术制备硅基有序一维、二维纳米结构 60 | 的范围相当广泛,涵盖纳米电子元件、生物或化学的 硅片实验室、微流道装置(微混合器、微反应器),超 高存储密度磁盘、微光学元件等领域。 近十年间,各种创新的 NIL 工艺的研究陆续开展, 其实验结果越来越令人满意,目前大概可以归纳出三 种代表技术:热压印光刻技术、紫外硬化压印光刻技 术、微接触压印光刻技术。 2. 热压印(HE-NIL) 热压印工艺是在微纳米尺度获得并行复制结构的 一种成本低而速度快的方法,仅需一个模具,完全相 同的结构可以按需复制到大的表面上。热压印的工艺 如图 1所示。首先,压模制备。通常压模选用 Si,SiO2, 氮化硅、金刚石等材料制成。这些材料具有很多优良 的性质:高Knoop 硬度、大压缩强度、大抗拉强度可 以减少压模的变形和磨损;高热导率和低热膨胀系数, 使得在加热过程中压模的热变形很小。然后利用电子 束刻印术或其他先进技术,把选用的材料制作成一片 具有纳米图案的模版,并且准备一片均匀涂布热塑性 高分子光刻胶(通常以 PMMA 为主要材料)的硅基板。 接着将硅基板上的光刻胶加热到玻璃化转换温度 (Glass Transfer Temperature)以上,利用机械力将模版 压入高温软化的光刻胶层内,并且维持高温、高压一 段时间,使热塑性高分子光刻胶填充到模版的纳米结 构内。待光刻胶冷却固化成形之后,释放压力并且将 模版脱离硅基板。最后对硅基板进行反应离子刻蚀 (Reactive Ion Etching)去除残留的光刻胶,即可以复制 出与模版等比例的纳米图案。热压印优势就在于模版 可以多次使用,但是实际使用时需要高温环境却不利 于它的应用。 3. 紫外硬化压印光刻技术(UV-NIL) 使用热压印光刻技术的热塑性高分子光刻胶必须 Figure 1. Heat NIL 图1. 热压印过程 经过高温、高压、冷却的相变化过程,在脱模之后压 印的图案经常会产生变形现象,因此使用热压印技术 不易进行多次或三维结构的压印,为了解决此问题, 有人开始研发一些可以在室温、低压下使用的紫外光 硬化高分子的压印光刻技术,如图 2所示。其前处理 与热压印类似,首先都必须准备一个具有纳米图案的 模版,而 UV-NIL 的模版材料必须使用可以让紫外线 穿透的石英,并且在硅基板涂布一层低黏度、对 UV 感光的液态高分子光刻胶,在模版和基板对准完成后, 将模版压入光刻胶层并且照射紫外光使光刻胶发生聚 合反应硬化成形,然后脱模、进行刻蚀基板上残留的 光刻胶便完成整个UV-NIL。很明显,紫外压印相对 于热压印来说,不需要高温、高压的条件,它可以廉 价的在纳米尺度得到高分辨率的图形,它的工艺可用 于发展纳米器件,其中的步进–闪光压印不但导致工 艺和工具成本的明显下降,而且在其他方面也和光学 光刻一样好或更好,这些其他方面包括工具寿命、模 具寿命(不用掩模版)、模具成本、工艺良率、产量和 尺寸重现精度。但其缺点是需要在洁净间环境下进行 操作。 4. 微接触压印光刻(Microcontact-NIL) 微接触压印光刻技术要先通过光学或电子束光刻 得到模版。模具材料的化学前体在模版中固化,聚合 成型后从模版中脱离,便得到了进行微接触印刷所要 求的模具。常常要得到的模具是二甲基硅氧烷 (PDMS),接着,PDMS 模具浸在含有硫醇的试剂中, 然后将浸过试剂的模具压到镀金衬底上,衬底可以为 玻璃、硅、聚合物等多种形式。另外,在衬底上可以 先镀上一薄层钛层然后再镀金,以增加粘连。硫醇与 金发生反应,形成自组装单分子层 SAM。印刷后有两 Figure 2. UV-NIL 图2. 紫外硬化压印光刻过程 Copyright © 2011 Hanspub MP  李卫 等纳米压印技术制备硅基有序一维、二维纳米结构61 | 种工艺对其处理。一种是采用湿法刻蚀,如在氢化物 溶液中,氢化物的离子促使未被 SAM 层覆盖的金溶 解,而由于 SAM 能有效地阻挡氢化物的离子,被 SAM 覆盖的金被保留,从而将单分子层的图案转移到金上。 还可以进一步以金为掩模,对未被金覆盖的地方进行 刻蚀,再次实现图案转移,另一种是在金膜上通过自 组装单层的硫醇分子来链接某些有机分子,实现自组 装,如可以用此方法加工生物传感器的表面,如图 3 所示。微接触印刷不但具有快速、廉价的优点,而且 它还不需要洁净间的苛刻条件,甚至不需要绝对平整 的表面,微接触印刷还适合多种不同表面,具有作用 方法灵活多变的特点,该方面缺点是在亚微米尺度, 印刷时硫醇分子的扩散将影响对比度,并使印出的图 形变宽。通过优化浸液方式、浸液时间,尤其是控制 好模具上试剂量及分布,可以使扩散效应下降。 这三种压印方法各有优点和缺点,现将它们之间 的比较列表对比,见表 1。从表中我们看出:热压印 比起其它两种压印方法工作时的温度高,微接触压印 方法可以制备的最小尺寸比较大,不利于制备 10 纳米 以下的线宽,并且在多次使用方面也较差,模版的使 用寿命较短。综合看来,紫外压印具有比较好的应用 前景,即可以在常温时工作,制备的最小尺度可达 5 纳米,完全满足器件的需要,而且模版使用寿命长。 5. 实验与讨论 我们利用紫外压印技术制备硅基有序结构,为后 续研制低功耗,快开关速度和高存储密度[3-11]纳电子、 光电子器件提供技术基础。 在实验中,我们采用的是周期为 2微米的一维、 二维石英光栅模版。图 4和图 5是石英光栅模版的 AFM 图像。实验前首先对模版和硅衬底进行表面处 理,具体过程是:将模版放置在培养皿中,滴入 1 mL 三氯硅烷利用其挥发出来的蒸汽对石英进行表面氟化 修饰。被修饰过的模版表面能降低,使之与其他物质 不相互黏附。模版经过这样的处理后,使其不易被抗 蚀胶浸润,即使抗蚀胶固化后也非常容易将两者剥离 开来。这既保证形成的纳米结构不被破坏,又能保持 模版表面清洁,延长模版的使用寿命。然后在氮气保 护下,我们将准备好的硅衬底浸泡在已经过脱水处理 的甲苯中,加入二氯甲硅烷,使衬底表面形成一层高 Figure 3. Microco ntact-NIL 图3. 微接触压印光刻 Table 1. Comparison table 表1. 热压印、紫外压印和微接触法特点比较 工艺 热压印 紫外压印 微接触压印 温度 高温 室温 室温 压力 P/KN 0.002-40 0.001-0.1 0.001-0.04 最小尺寸 5 nm 5 nm 60 nm 深宽比 1-6 1-4 无 多次压印 好 好 差 多层压印 可以 可以 较差 套刻精度 较好 好 差 研究动态 低温低压 步进–闪光压印 一次性压印 分子层,这层高分子可以使光致固化抗蚀胶与衬底充 分浸润,这样利用旋涂涂胶时可以很容易控制抗蚀胶 的厚度。同时,固化以后这层高分子层使衬底和固化 了的抗蚀胶紧密键合起来,防止光刻胶脱落,也帮助 了模版与抗蚀胶分离。 在我们的实验中,使用的光致固化抗蚀胶的主要 成分是氨基甲酸乙酯–丙烯酸酯,光敏剂是二苯甲醛, 配制时质量比为 19:1,然后利用丙稀酸稀释。配制的 抗蚀胶的特点是在普通荧光灯或日光下很稳定,无需 避光操作。 实验过程如图 6所示,首先将抗蚀胶涂在处理过 的硅衬底上,利用匀胶机使其均匀的涂在衬底表面。 匀胶机转速 3000 转/分钟,运行时间为 1分钟。然后 利用机械压力将石英模版压在衬底上,从石英背面用 紫外线曝光。在曝光过程中光敏剂中的苯环吸收能量, 将能量传递给抗蚀胶和黏附层。此能量将抗蚀胶与黏 附层分子之间发生键合,使抗蚀胶与衬底结合在一起。 同时抗蚀胶中分子之间也发生键合。抗蚀胶中有六个 官能团,使之可以在三维、六个方向上彼此之间交联 Copyright © 2011 Hanspub MP 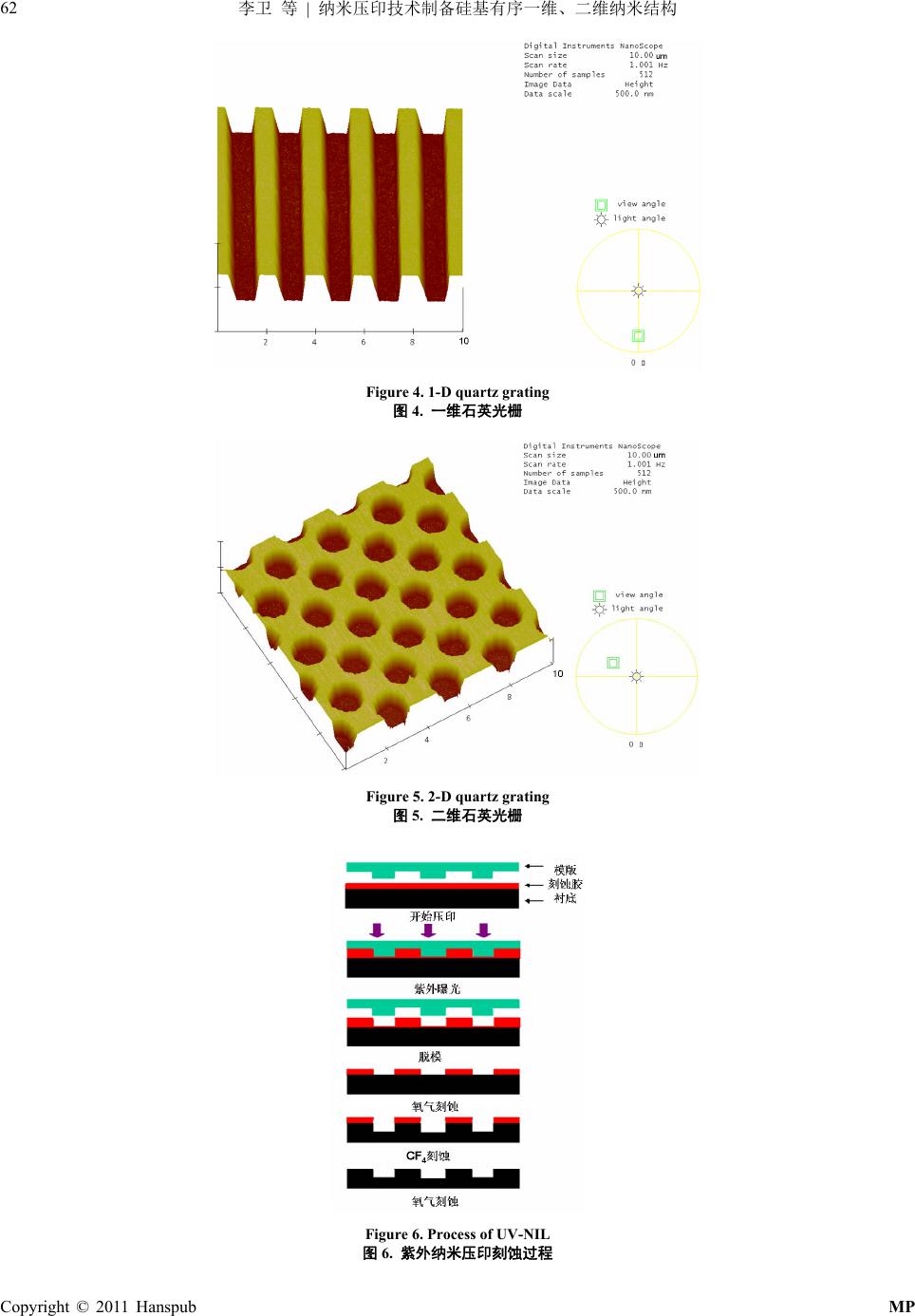 李卫 等 | 纳米压印技术制备硅基有序一维、二维纳米结构 Copyright © 2011 Hanspub MP 62 Figure 4. 1-D quartz grating 图4. 一维石英光栅 Figure 5. 2-D quartz grating 图5. 二维石英光栅 Figure 6. Process of UV-NIL 图6. 紫外纳米压印刻蚀过程  李卫 等纳米压印技术制备硅基有序一维、二维纳米结构63 | 起来,形成稳定的立体交联网络结构从而达 目的。曝光过程结束后,利用机械力把模版和衬底分 离。此时,模版上的图形转移到了硅衬底上的抗蚀胶 上。接着用氧等离子体除掉被压缩区域的抗蚀剂,然 后以 CF4为气源对样品进行刻蚀,将图形转移到硅片 上。最后用氧离子刻蚀清除残留在样品表面的抗蚀胶。 纳米压印过程重要的评价标准是图形复制的保真 度。我们实验中采用的紫外曝光压印技术,可以在抗蚀 胶上得到与模版完全吻合的图形结构,周期为2微米, 图7和图8是经紫外曝光后在抗蚀胶上形成的图形。 英模版上的图形上的图形顺利转移到抗蚀 胶上以后,我们需要进一步地把抗蚀胶上的图形转移 到硅衬底上。在实验时,我们首先采用以氧气为气源 的反应离子刻蚀方法(刻蚀功率为 20 W,流量为40 SCCM,刻蚀时间 10 分钟)去除掉“谷”区域的抗蚀 胶。在这个刻蚀过程中,“峰”区域的抗蚀胶也会被 刻蚀,但没有被完全刻蚀掉。然后我们再利用这些没 有被刻蚀掉的抗蚀胶作为掩膜,利用 CF4对样品进行 刻蚀,最终将图形转移到硅衬底上,图 9和图 10 是刻 蚀过程结束后在硅衬底上形成的一维,二维有序 到固化的 在把石 24 Figure 7. 1D quartz graphics in the resist 图7. 在抗蚀胶上行成的一维光栅图形 Figure 8. 2D quartz graphics in the resist 图8. 在抗蚀胶上行成的二维光栅图形 Copyright © 2011 Hanspub MP  李卫 等纳米压印技术制备硅基有序一维、二维纳米结构 64 | Figure 9. 1D quartz graphics in the Si substrate 图9. 在硅衬底上行成的一维光栅图形 Digital Instruments NanoScope Scan size Scan rate Number of samples Image DataHeight Data scale view angle light angle 10.00 um 1.001 Hz 512 1.000 nm 246810 0 Figure 10. 2D quartz graphics in the Si substrate 图10. 在硅衬底上行成的二维光栅图形 光栅结构的 AFM 图。从图中可以看出,原来在石英 光栅上的图形可以很好的转移到硅衬底上。 我们以周期为 2微米的一维、二维石英光栅为模 版,利用紫外压印技术制备的硅基有序结构与前文说 论述的紫外压印技术最大的不同就是模版的选择。大 部分紫外压印需要使用的模版都是采用电子束或离子 束刻蚀得到的,这样的制备过程复杂,成本高,而我 们所用的是一般的光栅模版,成本低,工艺简单。虽 然利用光栅模版制备的硅基有序结构的 大,但是通过后续的一系列过程(如氧化,刻蚀)也可 以制备出<100 nm的特征尺寸。 6. 结论 在本文中我们具体介绍了纳米压印技术,并用石 英光栅为模版,利用紫外压印技术制备出一维和二维 的硅基有序结构。利用这种技术可以很好的将原来石 英模版上的图形转移到硅基衬底上。纳米压印技术可 加工技术,具有广大的应用前景。 特征尺寸较 以成为新的微 Copyright © 2011 Hanspub MP  李卫 等纳米压印技术制备硅基有序一维、二维纳米结构65 | 参考文献 (References) [1] S. Y. Chou, P. R. Krauss and P. J. Renstrom. Imprint lithography with 25-nanometer resolution. Science, 1996, 272(5258): 85-87. [2] M. D. Austin, H. X. Ge, W. Wu, M. T. Li, Z. N. Yu, D. Wasserman, S. A. Lyon and S. Y. Chou. Fabrication of 5 nm linewidth and 14 nm pitch features by nanoimprint lithography. Applied Physics Letters, 20 04 , 84(26): 5299-5301. [3] M. C. McAlpine, R. S. Friedman and D. M. Lieber. N anoimprint lithography for hybrid plastic electronics. Nano Letters, 2003, 3(4): 443-445. [4] D. Li, L. J. Guo. Micron-scale organic thin film transistors with conducting polymer electrodes patterned by polymer inking and stamping. Applied Physics Letters, 2006, 88(6): Article ID 063513. [5] W. Zhang, S. Y. Chou. Fabrication of 60-nm transistors on 4-in. wafer using nanoimprint at all lithography levels. Applied Phys- ics Letters, 2003, 83(8): 1632-1635. [6] K. Kosuke, M. Akihiro. High-aspect-ratio nanopillar structures fabricated by nanoimp rinting with elongation phenomenon. Jour- nal of Vacuum Science & Technology B, 2008, 26(2): 58 2- 584. [7] Y. Ekinci, H. H. Solak, C. David and H. Sigg. Bilayer Al wire- grids as broadband and high-performance polarizers Optics Ex- press, 2006, 14(6): 2323-2334. [8] Z. J. Hu, G. Baralia, V. Bayot, J. F. Gohy and A. M. Jonas. Nano- scale control of polymer crystallization by nanoimprint lithogra- phy. Nano Letters, 2005, 5(9): 1738-1743. [9] S. W. Ahn, K. D. Lee, J. S. Kim, S. H. Kim, J. D. Park, S. H. Lee and P. W. Yoon. Fabrication of a 50 nm half-pitch wire grid po- larizer using nanoimprint lithography. Nanotechnology, 2005, 16(9): 1874-1878. [10] J. D. Hoff, L. J. Cheng, E. Meyhofer, L. J. Guo and A. J. Hunt. Nanoscale protein patterning by imprint lithography. Nano Let- ters, 2004, 4(5): 853- 857. [11] W. Hu, E. K. F. Yim, R. M. Reano, K. W. Leong and S. W. Pang. Effects of nanoimprinted patterns in tissue-culture polystyrene on cell behavior. Journal of Vacuum Science & Technology B, 2005, 23(6): 2984-2989. Copyright © 2011 Hanspub MP |