Smart Grid
Vol.07 No.02(2017), Article ID:20300,10
pages
10.12677/SG.2017.72009
Research on Driving Characteristics of GaN Power Devices
Wuyang Liu, Shengwei Gao
Tianjin Key Laboratory of Advanced Technology of Electrical Engineering and Energy, Tianjin Polytechnic University, Tianjin

Received: Apr. 11th, 2017; accepted: Apr. 27th, 2017; published: Apr. 30th, 2017

ABSTRACT
The development trend of modern switching power supply is high efficiency and high power density. The power device performance of traditional Si material has become the bottleneck, and GaN power devices of wide bandgap semiconductor devices have a smaller turn-on resistance and can withstand higher switching frequency comparing with the Si MOSFET. Taking GS66052B of GaN System for example, this paper analyzed the dynamic characteristics of monomer enhanced GaN power devices through the double pulse test, and designed the LM5114 driving circuit based on single tube, and absorbed the high voltage spikes through parameter calculation with RC snubber circuit. The experimental results show that the GaN power devices have good performance under the high frequency and load.
Keywords:GaN, Dynamic Characteristics, Independent Pull Irrigation, Peak Voltage
氮化镓功率器件驱动特性的研究
刘武扬,高圣伟
天津工业大学电工电能新技术天津市重点实验室,天津
收稿日期:2017年4月11日;录用日期:2017年4月27日;发布日期:2017年4月30日

摘 要
高效率、高功率密度是现代开关电源的发展趋势,提高开关频率可以有效减小无源器件的尺寸。传统的Si材料的功率器件性能已逐渐到了瓶颈,宽禁带半导体器件中的氮化镓功率器件相对于Si MOSFET,具有更小的导通阻抗,可以承受更高的开关频率条件。本文以GaN System的GS66052B为例,通过双脉冲测试,分析了单体增强型氮化镓功率器件的动态特性,设计了基于LM5114的单管驱动电路,并针对漏源极出现的过高的电压尖峰,通过参数计算,利用RC缓冲回路吸收过冲电压。实验表明氮化镓功率器件在电压尖峰处理后的高频负载下工作性能良好。
关键词 :氮化镓,动态特性,独立拉灌,尖峰电压

Copyright © 2017 by authors and Hans Publishers Inc.
This work is licensed under the Creative Commons Attribution International License (CC BY).
http://creativecommons.org/licenses/by/4.0/


1. 引言
硅功率器件性能的发展已达到了极限,高频化和小型化是开关电源的发展方向。与传统的硅功率器件相比,宽禁带功率半导体的性能要出色得多,碳化硅和氮化镓是其中最具代表性的功率半导体器件。但由于氮化镓功率器件的性能研究还不够完善,器件制造商提供的特性数据有限,所以有必要对氮化镓功率器件的性能进行进一步的研究。
GaN功率器件采用的是高电子迁移率晶体管结构,开关过程很快,可实现非常高的开关频率。相比较于SiC主要用于处理较大电力耐压600 V以上的用途,GaN功率器件则主要用于耐压600 V以下,或要求数百kHz以上的高速开关的用途 [1] 。GaN功率器件禁带宽度大,击穿强度高,相比于传统的硅功率器件,在耐压相同的情况下,裸片体积要小的多,寄生电容小,有助于提高开关速度。由于GaN的导通电阻小,采用MOSFET结构,耐压更高且开关速度更快,所以开关损耗也要小的多,大部分情况下0402和0603的贴片封装都可以用。氮化镓晶体管正向和反向导通都依靠二维电子导电,不存在少子的存储效应,理论上没有反向恢复。
2009年6月EPC首次推出增强型硅基氮化镓场效应晶体管,期望于替代功率MOSFET,2013年Transform公司推出600 V系列Cascode增强型GaN晶体管,2015年GaN System公司推出100 V和650 V两种耐压等级的GaN晶体管。GaN System公司研发出世界上最小的650V/15A的氮化镓晶体管,尺寸仅5.0 mm × 6.5 mm,比同类产品的尺寸缩小50% [2] 。但目前整体上氮化镓功率器件的发展仍处于起步阶段,针对GaN System公司的氮化镓芯片研究较少,所能参考的特性数据也非常有限,本文以GaN System的GS66502B芯片为研究对象,分析其动态特性,设计驱动电路,并针对出现的电压尖峰进行吸收,使其在高频下可靠工作。
2. 基本原理
2.1. 驱动原理
GaN System的GS66502B氮化镓晶体管是650V/7A增强型功率器件,栅源极电压范围为−10 V~+7 V。相对于EPC系列的氮化镓晶体管的−4 V~6 V,具有更宽的输入范围,与Si MOSFET和IGBT以及SiC MOSFET的驱动电压对比如表1所示。GS66502B几乎没有开关损耗和反向续流二极管损耗,虽然体内没有二极管,但有二极管的特性 [3] 。即GaN增强型晶体管反向导通具有等效“二极管”的特性,它与门
极电压有关。不需要外部的反并联二极管,反向恢复性能优良,硬开关效率高。
针对GaN晶体管的栅极电压需要严格控制的要求,TI研制了专用的GaN栅极驱动芯片LM5114,可将驱动电压进行严格控制,输出电压范围可在4 V~12 V之间可调。LM5114可驱动一个单体增强型氮化镓晶体管,具有独立拉灌输出功能 [4] 。独立拉灌输出功能可通过改变各自通道上的驱动电阻,分别控制开通和关断时间,可避免采用同一驱动电阻时对关断通道造成的不良影响。
图1是Si MOSFET器件常用的驱动电路,常用的驱动电路一般只使用一个VO输出引脚。当驱动信号为高电平时,反并联二极管D1截止,驱动器的VCC通过驱动电阻RGON给开关管的结电容进行充电。当驱动信号为低电平时,反并联二极管D1导通,反并联二极管产生的导通压降加在栅源极之间。由于氮化镓功率器件的阈值电压很低,GS66502B的阈值电压只有1.5 V,如果采用拉灌共用输出的驱动电路将会导致栅源极电压超过阈值电压,造成晶体管关断失败。为实现与共用输出引脚电路相同的驱动功能,同时也为了避免二极管的使用,可采用开通和关断独立输出的驱动电路,如图2所示。
2.2. 驱动电路设计
开通电阻控制开通的转换速率,但是太大的开通电阻会降低开关速率增加损耗,太小的开通电阻则开关速度很大,会使开关损耗也增大,这是由于米勒产生可能的门极振荡。关断电阻常用的开通阻值范围为1~2 Ω,可为氮化镓晶体管提供强大快速的门极驱动下拉。而对于反向的dv/dt,逆向的米勒电流,要有一个低阻抗通路用来减少反向的门极尖峰电压和由LC谐振引起的后面的振铃。所以选择合适的门极电阻,氮化镓晶体管的速度就可以被门极电阻很好的控制。关键是选好合适的RG(ON)和RG(OFF)有助于驱动性能的稳定。本文选取LM5114作为GS66502B氮化镓器件的驱动芯片,设计基本的驱动电路,开通电阻5.1 Ω,关断电阻1.8 Ω,如图3。
Table 1. Comparison of driving voltages for GaN transistors and other transistors
表1. GaN晶体管和其他晶体管的驱动电压的比较

Figure 1. Driving circuit for common output of pull irrigation
图1. 拉灌共用输出的驱动电路

Figure 2. Driving circuit for independent pull irrigation output
图2. 独立拉灌输出的驱动电路

Figure 3. Double pulse test circuit using LM5114
图3. 采用LM5114的双脉冲测试电路
2.3. 辅助电源设计
由于氮化镓功率器件的驱动电压不同于普通Si MOSFET,所用的LM5114的供电电压也不一样,所以在变换器应用中需要提供辅助电源实现驱动芯片的供电。对于GS66502B,栅源极电压范围为−10 V~+7 V,开通最佳值为6 V,所以需要额外的6 V供电电压。本文设计了一种基于LNK306PN的220 V转6 V的辅助电源电路,可以给GS66502B提供6 V的辅助电源供电,如图4所示。
3. 动态特性测试
3.1. 双脉冲原理
双脉冲测试的原理是驱动电路发出一宽一窄两个脉冲,氮化镓晶体管开通关断两次。在t1时刻,宽脉冲到来,VGS升高,氮化镓晶体管降至通态电压,主电路直流电源两端电压几乎全部加在电感上面,电感电流线性升高,此时氮化镓晶体管的导通电流ID等于电感电流IL。在t2时刻,宽脉冲结束,VGS降为零,晶体管关断的同时与等效二极管开始换流,电感电流几乎保持不变。在t3时刻,窄脉冲到来,电路中电流已达到一定值,所以可以有效测试氮化镓晶体管带负载开通的能力,并观察其与等效二极管换流的情况。而t3到t4时刻,电流ID和IL继续线性上升,直到第二次关断后电感中储存的能量完全消耗。图5为双脉冲测试电路原理波形。
3.2. 双脉冲仿真与实验
仿真和实验条件为直流电源提供30 V输入电压,电感值120 uH,双脉冲宽度10 us,由I = Ut/L得测试电流为2.5 A。使用LTspice仿真将GS66502B和LM5114模型导入,仿真波形如图6所示,可观测到漏源极两端电压在关断时刻有轻微振荡,而开通时刻漏源极电流有5 A尖峰,是电流正常值的两倍。图8所示为双脉冲实验测试相同条件下的GS66502B的开通关断特性,验证了基于LM5114独立拉灌输出驱动电路设计的正确性。
对比GaN晶体管和Si MOSFET在双脉冲测试下的开关特性,采用与GS66502B性能相近的Si开关管SPW20N60C3,可发现采用共用拉罐输出驱动的SPW20N60C3在双脉冲宽度为10 us的情况下,其驱动波形已发生严重畸变,尤其是关断时间较长已超过0.48us,关断时刻振荡时间达到0.4 us,而漏源极两端的开通和关断使得驱动电压VGS波形也受到严重影响,如图7所示。相比较于SPW20N60C3的情况,

Figure 4. Auxiliary power circuit
图4. 辅助电源电路

Figure 5. Principle of double pulse test circuit
图5. 双脉冲测试电路原理波形
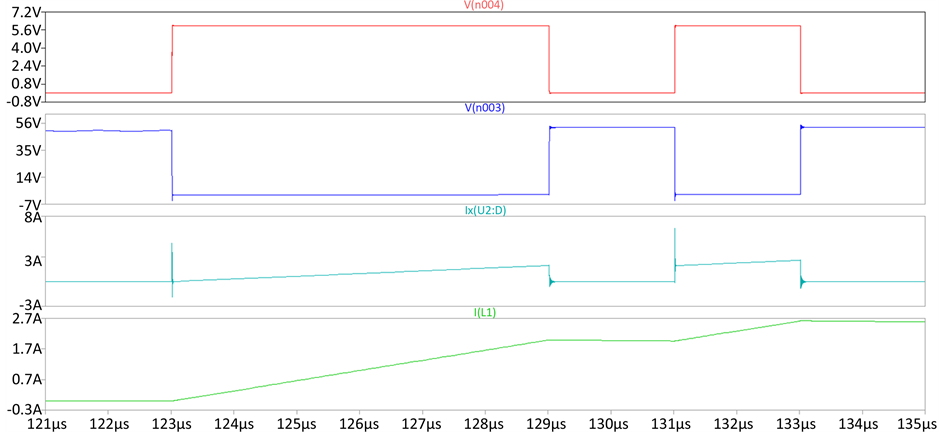
Figure 6. Simulation waveform of double pulse circuit
图6. 双脉冲电路仿真波形
采用独立拉灌输出驱动的GS66502B的开通和关断特性则要更加良好,开通时间20 ns,关断时间150 ns,受电路寄生电感影响关断时刻也伴随有轻微振荡,但开通和关断时刻的波形没有畸变,如图8。
图9和图10为双脉冲测试电路GaN晶体管开通和关断时刻的波形。驱动电压VGS的尖峰主要是由
驱动回路中的杂散电感和晶体管的寄生电容造成的,在开通和关断的过程中,杂散电感和寄生电容进行能量交换,从而形成了电压振荡和电压尖峰 [5] 。氮化镓晶体管开通时的电流ID的尖峰非常严重,尖峰值超过正常值的200%,功率器件的正常使用将受到严重影响。由于氮化镓晶体管为等效二极管,没有反向恢复电流,因此电流ID的尖峰主要是由寄生电容放电引起的。在氮化镓晶体管开通的第三阶段,电压VDS在极短的时间内由母线电压下降至通态电压,电容CDS、CGD上的电压以较高的dv/dt下降,两个电容放电,放电电流IDS和IGD流经氮化镓晶体管的沟道,等效二极管两端的电压也将由通态压降升至母线电压,等效二极管由直流电源充电后的充电电流Idiode也流经氮化镓晶体管的沟道,所以电流尖峰形成的原因主

Figure 7. Experimental waveforms of double pulse circuit of Si MOSFET
图7. Si MOSFET双脉冲电路实验波形

Figure 8. Experimental waveforms of GaN transistor double pulse circuit
图8. GaN晶体管双脉冲电路实验波形

Figure 9. Turn-on time waveform of GaN transistor
图9. GaN晶体管开通时刻波形

Figure 10. Turn-off time waveform of GaN transistor
图10. GaN晶体管关断时刻波形
要由电流IDS、IGD和Idiode三方面所造成的。而电路中开通和关断时刻的振荡则是由寄生电容和杂散电感的充放电所造成的。
4. 高频下负载实验
4.1. 负载下动态特性
在测试驱动特性时考虑出现的电压尖峰,采用占空比为0.5的驱动信号,开关频率为200 kHz,输入电压20 V,20欧姆电阻负载。可以看出驱动波形良好,栅源极电压在GaN晶体管的驱动电压要求范围内,驱动电压受主电路开关动作影响较小。
从图11可以看到,开通时刻栅源极电压只有轻微的一次振荡,而漏源极电压两端正常开通无振荡和尖峰。但关断时刻,栅源极电压有振荡,漏源级电压尖峰可达到137 V并伴随有振荡。如果加大输入电压尖峰值将继续增大,对于开关管在高输入电压下的负载工作极其危险,容易击穿开关管。
4.2. 尖峰吸收实验
RC吸收电路的原理是吸收开关管所产生的过冲电压,本质上是靠吸收电容C来吸收掉杂散电感所产生的能量 [6] 。
计算杂散电感时首先在未加缓冲电路时用示波器观察氮化镓晶体管关断时的一个振荡周期记为T1,然后再给氮化镓晶体管并联一个已知大小的电容C0,再次观察其在关断时的一个振荡周期并记为T2,从而可估算电路中的杂散电感值:
 (1)
(1)
取2.2 nF的电容作为并联在氮化镓晶体管两端的已知电容,代入式(1)可得杂散电感值为92.2 nH。
假设关断前存储在主电路寄生电感和杂散电感中的磁能在氮化镓晶体管关断时完全转化为电容中的电能,则可以得出:
 (2)
(2)
式(2)中:Lp为主电路的寄生电感,Ls为电路中的杂散电感,I为电路的关断电流。ΔU为寄生电感产生的过电压,即 ,Ud为直流电压。
,Ud为直流电压。
从而可求出吸收电容为:
 (3)
(3)
带入(3)求得C为3.6 nF,此处电容取4.7 nF。
氮化镓晶体管开通期间,存储在吸收电容C中的能量必须通过电阻R消耗掉,对于不同的吸收电路,C放电时间也有差异。对于RC吸收电路,只需满足τ = RC小于四分之一的氮化镓晶体管导通时间,就可以保证电容C中绝大部分能量的释放,不会影响下一次的吸收。但因为吸收电路中存在的大电流振荡会使得氮化镓晶体管开通时的漏极电流峰值会相应增加,所以R值也并不是越小越好,还要使R值设得高一些。所以综上,吸收电阻的取值范围为:
 (4)
(4)
式(4)中L为有关的线路电感,τ0是氮化镓晶体管的导通时间。在200 kHz下氮化镓晶体管导通时间为2.5 us,代入式(4)得 欧姆,此处R取22欧姆。
欧姆,此处R取22欧姆。
用4.7 nF的高压瓷片电容和22欧姆的电阻组成RC吸收电路接在漏源极两端,可发现,氮化镓晶体管GS66502B在开通瞬间,波形良好,漏源极电压快速开通。栅源极电压只有轻微的一次振荡即可进入正常开通状态。在关断时刻,漏源极两端电压尖峰被大幅度削减,只有略高于正常电压的20%,远远低于无吸收回路时的电压尖峰,漏源极两端电压在关断瞬间的振荡也明显减弱,如图12所示。实验表明,经RC吸收电路处理后,氮化镓晶体管的关断电压尖峰被大量削减,可在电路中安全工作和运行。

Figure 11. Experimental waveforms of GaN transistor driver circuit under 200 kHz
图11. 200 kHz下GaN晶体管驱动电路实验波形

Figure 12. Experimental waveforms of GaN transistors after peak absorption of 200 kHz
图12. 200 kHz下GaN晶体管尖峰吸收后的实验波形
5. 结论
本文分析了单体增强型GaN功率器件的动态特性,针对其不同于Si MOSFET的特点设计了基于LM5114的独立拉灌的驱动电路。通过GS66502B的双脉冲测试仿真和实验以及与SPW20N60C3动态特性的对比和分析,验证和表明了采用独立拉灌输出驱动的GaN功率器件在高频下的开通和关断特性上比Si MOSFET更加优异。200 kHz开关频率实验表明GaN功率器件在高频下工作也伴随有较大的过冲电压,设计RC吸收回路可有效缓解电压尖峰。实验进一步表明氮化镓功率器件高频驱动特性的优势可在高频电路应用中更好地发挥作用。
基金项目
高性能LED植物生长灯驱动电源关键技术研究(天津市科委项目),项目号:16JCTPJC46600。
文章引用
刘武扬,高圣伟. 氮化镓功率器件驱动特性的研究
Research on Driving Characteristics of GaN Power Devices[J]. 智能电网, 2017, 07(02): 79-88. http://dx.doi.org/10.12677/SG.2017.72009
参考文献 (References)
- 1. 曹峻松, 徐儒, 郭伟玲. 第3代半导体氮化镓功率器件的发展现状和展望[J]. 新材料产业, 2015(10): 31-38.
- 2. 科发. GaN-Systems发布世界上最小的650V氮化镓晶体管[J]. 半导体信息, 2015(3): 6-7.
- 3. 李祥生, 黄立巍, 郭莎莎, 许峰. 600VGaNHEMT开关特性和封装研究[J]. 电力电子技术, 2012(12): 77-80.
- 4. 崔梅婷. GaN器件的特性及应用研究[D]: [硕士学位论文]. 北京: 北京交通大学, 2015.
- 5. 李新秀. SiCMOSFET研究及应用[D]: [硕士学位论文]. 北京: 北京交通大学, 2016.
- 6. 姜栋栋, 王烨, 卢峰. IGBT过电压产生机理分析及RC缓冲电路的设计[J]. 电力科学与工程, 2011(4): 23-29.
